Похожие презентации:
Субмикронная литография
1. Субмикронная литография
Томский государственный университет систем управления и радиоэлектроники(ТУСУР)
Субмикронная литография
1
2. Тенденции развития: уменьшение размера элемента (топологической нормы)
Топологическая норма - полуширина линии и пространства между линиями врегулярных плотно упакованных полосчатых структурах. Разрешение для
изолированных элементов, например затворов транзисторов, может быть в 1,4–1,8 раз
меньше топологической нормы.
bmin - топологическая норма
1
b min (b l )
2
Lg - длина затвора
Xj - толщина легированных областей
Xox - толщина подзатворного диэлектрика
2
3. Тенденции развития: увеличение степени интеграции
Закон Мура:Количество
транзисторов
в
интегральной схеме
за год увеличивается
примерно в два раза.
1 – ранняя стадия выпуска ИС (удвоение количества транзисторов каждые 12 месяцев)
2 – микропроцессоры компании Intel (удвоение каждые 24 месяца) (коррекция закона Мура)
3 – схемы оперативной памяти (удвоение каждые 18 месяцев)
3
4. Проекционная литография
ОсветительПредельное разрешение оптической
литографии:
bmin k1 / NA
Лазер
где k1 – технологический параметр,
λ – длина волны экспонирующего
излучения,
NA – числовая апертура проекционных
линз
Линзы
конденсора
Фотошаблон
Проекционные
линзы
Окружающая среда
(коэффициент преломления n)
Подложка
NA n sin ,
где n – это показатель преломления
среды над фоторезистом,
θ – это полуугол сбора лучей на
подложке
Глубина фокуса
где k2 – коэффициент пропорциональности
4
5. Параметр k1
Параметр k1 был уменьшен с 0.8 в 1980 году до 0.4сегодня. Величина k1 = 0.3 ожидается в ближайшие годы.
Этот прогресс связан с внедрением:
внеосевого освещения (распределения интенсивности
освещения по поверхности не однородно и имеет
специальную форму)
фазо-сдвигающих
фотошаблонов
(осуществляется
управление не только амплитудой проходящего излучения,
но и его фазой, что позволят за счёт интерференции получать
необходимое изображение в резисте)
коррекции эффекта близости.
5
6. Фазосдвигающий шаблон
Толщина плёнки:d1 / 2 n f 1
nf – показатель преломления
материала плёнки
Глубина травления:
d 2 / 2 ng 1
Фазосдвигающие шаблоны, в которых сдвиг
фазы световой волны на 180 градусов:
а - реализуется за счёт осаждения прозрачной плёнки;
б - за счёт травления материала фотошаблона
ng – показатель преломления
материала шаблона
6
7. Принцип действия фазосдвигающего шаблона
Фазосдвигающий шаблонОбычный шаблон
7
8. Коррекция эффекта близости
Рисунок в шаблонеРисунок в
фоторезисте
Шаблон с
коррекцией
Рисунок в
фоторезисте
Для того чтобы в фоторезистивной маске создать необходимый рисунок
приходится усложнять рисунок фотошаблона, вводя туда специальные элементы
коррекции изображения. Резкие углы рисунка шаблона теряются в результате
дифракции.
8
9. Длина волны экспонирующего излучения
Эволюция источников экспонирующего излучения:Ртутные дуговые лампы ( = 436 (g-line), 405 нм (h-line), 365 нм (i-line))
Hg дуговые лампы ( 250 нм, глубокий УФ)
KrF лазер ( = 248 нм, глубокий УФ, bmin= 350 – 130 нм)
ArF лазер ( = 193 нм, глубокий УФ, bmin = 90 – 45 нм, 32 нм)
F2 лазер ( = 157 нм, вакуумный УФ)
Импульсные источники (лазерная плазма) ( = 13 нм, экстремальный УФ)
Рентгеновское синхротронное излучение ( 1 нм)
9
10. Длина волны освещения и топологическая норма
Топологическая норма, мкмменьше топологической нормы
порядка
топологической
нормы
больше
топологической
нормы
По
мере
уменьшения
топологической нормы происходит
и уменьшение длины волны света,
используемого в литографических
установках для экспонирования
фоторезиста через фотошаблон.
После ArF лазера c длиной волны
193 нм, возможно будет лазер на F2
c длиной волны 157 нм, а затем и
новые
импульсные
источники
некогерентного света на длину
волны 13 нм.
Длина волны экспонирующего излучения
Топологическая норма
Нет
источников
света
промежуточные длины волн.
Год
10
на
11. Иммерсионная литография: увеличение числовой апертуры (NA)
NA = n sinθ,где n – коэффициент преломления среды между линзой и фоторезистивной
маской (для воздуха n = 1), θ – наибольший угол сбора лучей с поверхности
резиста и определяется размером линзы.
NA выросла за счёт разработки новых линз от 0.5 (1990 г.) до 0.8 (2004 г.) и
предполагается её рост до 1 и более в будущем. На пути совершенствования
линз есть большие сложности (вес проекционных линз, уменьшающих
рисунок шаблона, составляет более 1000 кг).
Более простой путь – это увеличение n за счёт замены воздуха на жидкую
среду с большим n, например, на DI воду (n = 1.43662 на = 193 нм и 21.5 С,
рост NA на 44%). Это иммерсионная литография, первые установки будут
использованы в промышленности в 2007 году.
11
12. Установка иммерсионной литографии
Проекционные линзыВозврат
воды
Вода
Подача воды
Подложка
Сканирование
ArF лазер
Проекционные линзы
Микроскопические изображения резистивных масок,
полученных с помощью иммерсионной литографии с
полушириной линия-промежуток равной 65 нм (а),
50 (b) и 45 нм (c)
Вода
12
13. Экстремальная ультрафиолетовая литография
Длина волны излучения на уровне 10 нмИК лазер
Пучок Xe
обеспечивает прекрасное разрешение
Оптика - отражательная
Источник света – лазерная плазма
Шаблон
Система
зеркал
уменьшающая
изображение
Xe плазма,
эмитирующая
экстремальный
УФ
Отражательный
конденсор
Подложка с
резистом
13
14. Источник импульсной лазерной плазмы
Собирающее зеркалоКамера с мишенью
Nd:YAG лазер
(пред-импульс)
EUV / 13.5nm
CO2 лазер
(основной импульс)
светоделительная
пластина
Xe мишень из капельной струи
14
15. Импринтинг
Импринтинг – это метод литографии, когдатрёхмерный рисунок в резисте получается
посредством вдавливания в него штампа, на
поверхности которого заранее сформирован
необходимый рельефный рисунок.
Метод не предполагает использования света
для передачи изображения в резист.
Запатентованное название: Step and Flash
Imprint Lithography (S-FIL™)
15
16.
Импринтинг может прийти на замену фотолитографииСтоимость оборудования
Оптическая литография столкнётся с техническими ограничениями, когда топологическая
норма станет меньше 45 нм.
Экстремальная фотолитография (длина волны 13 нм) сложна технически и дорога.
Растущая стоимость фотолитографического оборудования может сделать производство
кристаллов убыточным.
Технологический барьер
Сверхбольшой NA, сверхмалый k1
Иммерсионная литография
Импринтинг
Стоимостной барьер
Низкая стоимость
Высокое качество
Перекрывает
несколько
топологических норм
и работает вплоть до
20 нм
16
17. Импринтинг: S-FIL технология
1718. Импринтинг: технология
Дифракционная микролинза1-D рисунок
2-D рисунок
18
19. Обращенный импринтинг (S-FIL/R process)
S-FIL/R процесс: после формирования отпечатка, поверхность покрываетсяпланаризирующим слоем (6), который травится до вскрытия слоя, по которому делался
импринтинг (7), и затем, используя селективную маску планаризирующего материала,
делается РИТ, формирующее обращённую маску с большим аспектным отношением (8).
19
20. Преимущества импринтинга
Низкая стоимость оборудования и технологии, так как не используетсядорогая оптика, источники излучения и фотошаблоны;
Широкий спектр размеров, которые можно реализовать данным
методом;
Не чувствительность к изменению плотности рисунка;
Нет сложностей характерных для оптической литографии, например, не
нужна коррекция эффекта близости;
Гладкие края формируемых линий, высокий рельеф маски;
Возможность реализации позитивного и негативного процессов.
20


















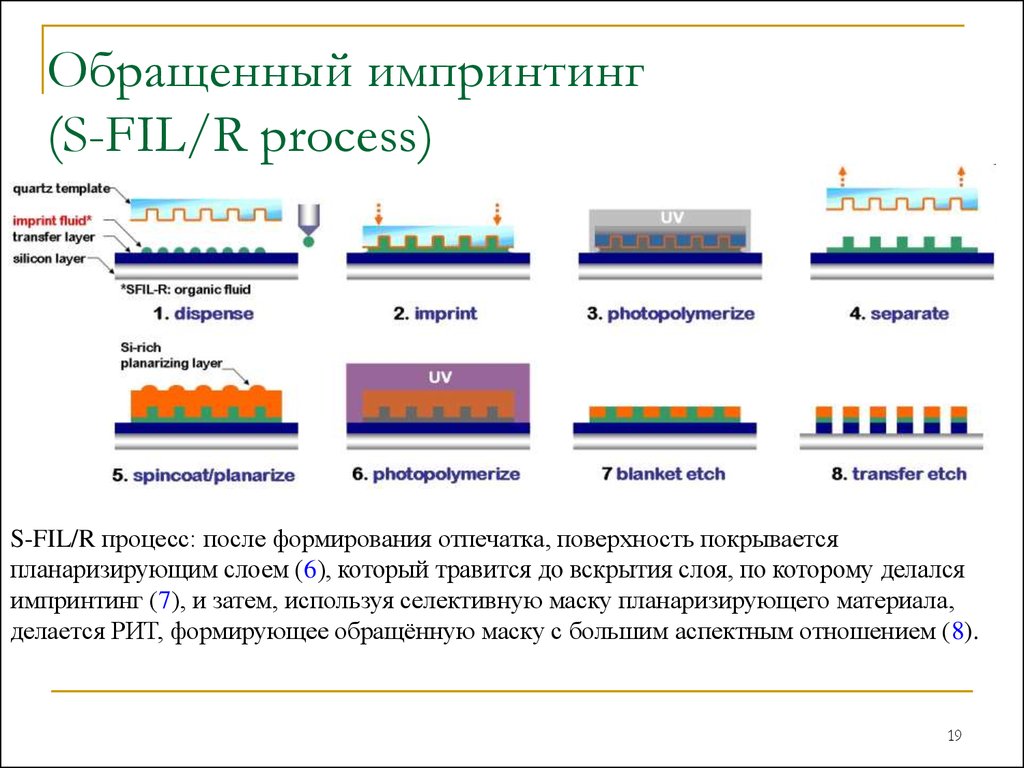



 Физика
Физика








