Похожие презентации:
Полупроводниковые лазеры
1.
ПОЛУПРОВОДНИКОВЫЕ ЛАЗЕРЫПолупроводниковые лазеры (иначе - диодные лазеры) – это
лазеры с усиливающей средой на основе полупроводников, где
генерация происходит, как правило, за счет вынужденного
излучения фотонов при межзонных переходах электронов в
условиях высокой концентрации носителей в зоне проводимости.
Формально,
полупроводниковые
лазеры
также
являются твердотельными лазерами, однако их принято выделять
в отдельную группу, т.к. они имеют иной принцип работы.
Схематически процесс возникновения усиления в полупроводниках (для обычных случаев
межзонных переходов) показан на рисунке.
Conduction band - зона проводимости, valence band - валентная зона, pumping - накачка, light
emission - излучение света.
Без накачки большинство электронов находится в валентной зоне. Пучок накачки с фотонами с
энергией немного больше ширины запрещенной зоны возбуждает электроны и переводит их в
более высокоэнергетическое состояние в зоне проводимости, откуда они быстро релаксируют в
состояние вблизи дна зоны проводимости. В то же время, дырки, генерируемые в валентной зоне,
перемещаются в ее верхнюю часть. Электроны из зоны проводимости рекомбинируют с этими
дырками, испуская фотоны с энергией, приблизительно равной ширине запрещенной зоны. Этот
процесс может также стимулироваться входящими фотонами с подходящей энергией.
Количественное описание основывается на распределении Ферми-Дирака для электронов в обеих
зонах. Большинство полупроводниковых лазеров являются лазерными диодами с накачкой
электрическим током, и с контактом между n-легированными и р-легированными
полупроводниковыми материалами. Есть также полупроводниковые лазеры с оптической накачкой,
где носители генерируются за счет поглощения возбуждающего их света, и квантово каскадные
лазеры, где используются внутризонные переходы.
2.
ОСНОВНЫМИМАТЕРИАЛАМИ для
полупроводниковых
лазеров (и для других
оптоэлектронных устройств)
являются:
GaAs (арсенид галлия)
AlGaAs (арсенид галлия алюминия)
GaP (фосфид галлия)
InGaP (фосфид галлия индия )
GaN (нитрид галлия)
InGaAs (арсенид галлия индия)
GaInNAs (арсенид-нитрид
галлия индия)
InP (фосфид индия)
GaInP (фосфид галлияиндия)
Перечисленные
полупроводники
являются
прямозонными; полупроводники с
непрямой запрещенной зоной, такие
как кремний, не обладают сильным и
эффективным световым излучением.
Так как энергия фотона лазерного
диода близка к энергии запрещенной
зоны,
полупроводниковые
композиции с разными энергиями
запрещенной
зоны
позволяют
получить излучение с различными
длинами
волн.
Для
трехи
четырехкомпонентных проводников
энергия запрещенной зоны может
непрерывно существенно изменяться
в некотором диапазоне. В AlGaAs =
AlxGa1-xAs,
например,
повышение
содержание алюминия (рост х)
приводит к уширению запрещенной
зоны.
3.
РАЗЛИЧНЫЕ ТИПЫ ПОЛУПРОВОДНИКОВЫХ ЛАЗЕРОВ• Небольшие лазерные диоды порядка нескольких милливатт (или до 0,5 Вт) выходной мощности в
пучке, с высоким качеством пучка. Они используются в лазерных указках, проигрывателях компактдисков и для оптической волоконной связи.
• Полупроводниковые лазеры с внешним резонатором (ECDL - External cavity diode lasers) содержат
лазерный диод в качестве активной среды в более длинном лазерном резонаторе. Зачастую они
могут быть перестраиваемыми по длине волны, и обладать узкой линией излучения.
• В монолитных лазерных диодах, а также в лазерах ECDL (с внешним резонатором) малой
мощности также может быть осуществлена синхронизация мод для получения сверхкоротких
импульсов.
• Большое количество лазерных диодов способны генерировать до нескольких ватт выходной
мощности, но качество пучка уже будет значительно хуже.
• Мощные диоды объединяют в массив с большой площадью излучающей области. Они могут
генерировать десятки ватт излучения, но с плохим качеством пучка.
• Диодные линейки, содержащие множество диодов, объединяют один массив и используют их для
получения чрезвычайно высоких степеней мощности порядка сотен или тысяч ватт.
• Поверхностно-излучающие лазеры (VCSELs), излучают в направлении, перпендикулярном
пластине, обеспечивая несколько милливатт мощности с высоким качеством пучка.
• Поверхностно-излучающие лазеры (VCSELs) с оптической накачкой и внешним резонатором
(VECSELs) способны генерировать несколько ватт выходной мощности с отличным качеством пучка,
даже в режиме синхронизации мод.
• Квантово-каскадные лазеры работают на внутризонных переходов (а не межзонных переходах) и,
как правило, излучают в средней инфракрасной области, иногда терагерцового диапазона. Они
используются в спектроскопии для для газового анализа, для подсветки в среднем ИК диапазоне и
т.д.
4.
Для получения лазерного излучения с узкой спектральнойлинией используются лазеры с встроенным брэгговским
отражателем (DBR и DFB лазеры), или с внешним
резонатором.
ЛАЗЕРЫ С РАСПРЕДЕЛЁННОЙ ОБРАТНОЙ СВЯЗЬЮ (DFBЛАЗЕРЫ)
Периодическая
структура
представляет
собой
распределённый отражатель в диапазоне длин волн лазерной
генерации и, обычно, выполняется с равномерным фазовым
сдвигом. Эта структура является по существу прямым
объединением двух брэгговских решёток с оптическим
усилением в них. Устройство имеет несколько осевых мод в
резонаторе, но, как правило, это одна мода, которая имеет
преимущество в условиях потерь. (это качество связано с
вышеупомянутым фазовым сдвигом).
Поэтому, часто легко достигается одночастотный процесс, несмотря на пространственный провал изза стоячей волны в активной среде. Перестройка длины волны без модовых скачков может быть
возможна в диапазоне нескольких нанометров, из-за широкого свободного спектрального диапазона.
Однако, диапазон перестройки не может быть шире, чем в лазерах с распределённым брэгговским
отражателем (РБО-лазеры; англ. distributed Bragg reflector laser сокр., DBR-laser).
Конструкция полупроводникового DFB лазера может содержать интегрированную решётку, например
гофрированный волновод. Решётка может быть выполнена на поверхности активного слоя, однако
при таком методе выращивание слоя отнимает много времени. Альтернативой этой конструкции
является структура с боковым нанесением, где решётки выполнены с обоих сторон активного слоя.
Полупроводниковые DFB-лазеры способны излучать в различных спектральных диапазонах, от 0.8
мкм до 2.8 мкм. Их выходная мощность составляет десятки милливатт. Ширина линии модуляции, как
правило, составляет сотни МГц. Возможна перестройка длины волны на несколько нанометров.
5.
ИНЖЕКЦИОННЫЕ ПОЛУПРОВОДНИКОВЫЕ ЛАЗЕРЫИнжекционными называют такие полупроводниковые лазеры (лазеры на основе
полупроводникового кристалла), которые для накачивания используют инжекцию в
соседние участки неосновных для них избыточных носителей через прямо смещенный pn-переход.
Назначения. Инжекционные полупроводниковые лазеры предназначены для
генерирования когерентного оптического излучения.
Классификация. Инжекционные полупроводниковые лазеры классифицируют за типом
переходов. Различают лазеры, изготовленные на гомо- и гетеропереходах. Как известно,
гомопереходы возникают на границе раздела двух одинаковых полупроводников с
одинаковой шириной запрещенной зоны, но разным типом проводимости, в то время как
гетеропереходы возникают на границе раздела двух различных полупроводников с
различной шириной запрещенной зоны и не обязательно с разным типом проводимости.
Лазеры на гетеропереходах классифицируют еще за количеством гетероструктур.
Выделяют лазеры с одной, двумя, тремя и более гетероструктурами. Инжекционные
полупроводниковые лазеры классифицируют за размерами активного участка — слоя
полупроводника, в котором происходит излучательная рекомбинация. Различают лазеры
со значительным по размерам активным участком (площадь поперечного сечения больше
за 1 мкм2) и малым (нитевидным) активным участком (площадь поперечного сечения < 1
мкм2). Еще применяют классификацию по характеру обратной связи. Выделяют приборы с
сосредоточенной и распределенной обратной связью.
6.
Строение. Инжекционный полупроводниковый лазер на p-n-переходепредставляет собой полупроводниковый диод, изготовленный из
прямозонных полупроводников, две плоскопараллельные грани которого
перпендикулярны плоскости p-n-перехода и служат зеркалами
оптического резонатора
Как известно, прямозонными называют
полупроводники, в которых максимум валентной зоны расположен
напротив минимума зоны проводимости. К ним относятся большинство
соединений.
Активный участок простирается вдоль оси кристалла от одного зеркала к
другому. Вместе с зеркалами она образует оптический резонатор. Диоды,
которые
имеют
оптический
резонатор,
образуют
лазерный
прибор, который генерирует когерентный свет, а диоды, которые не
имеют оптического резонатора (в которых отсутствуют зеркальные
плоскопараллельные
грани),
фактически
представляют
собой
инжекционные диоды, излучающие некогерентный свет.
Когерентным, как известно, называют такой свет, у которого
колебания всех излучающих атомов согласованные во времени с
частотой, фазой и направлением поляризации. На практике
распространены полупроводниковые гетеролазеры, потому они
концентрируют световой поток в меньшей по размерам активным
участке. Прямозонные полупроводники, из которых изготавливают
гетеропереходы, при различном химическом составе должны
иметь одинаковый период кристаллической решетки. Используют
Строение инжекционного
многокомпонентные твердые растворы. Например, в гетеролазеры
полупроводникового
на основе твердого раствора лазерную гетерострукгуру составляют
лазера с двойной
слои.
гетероструктурой
7.
Для того, чтобы произошло генерирования когерентного световогоизлучения, необходимы три функциональные узлы: активная среда,
которое генерирует и усиливает свет, устройство для его
возбуждения (накачки) оптический резонатор, который создает
положительную обратную связь.
При подаче прямого смещения на р-n-переход энергия носителей
растет, а потенциальные барьеры для них снижаются. В результате
возникает инжекция избыточных носителей в соседний участок.
Рабочее напряжение выбирают из условия
В гетеролазерах выполнению этого условия способствует разная ширина запрещенной зоны
элементов гетероструктуры. Вследствие инжекции происходит инверсное заселение энергетических
уровней, во время которого избыточные электроны занимают верхние уровни над дном зоны
проводимости, а избыточные дырки — нижние уровни под вершиной валентной зоны.
Энергетические диаграммы гетероструктур характеризуются различными величинами потенциальных
барьеров для встречных потоков дырок и электронов, приводит к односторонней инжекции
носителей с широкозонного эмиттера в узкозонную базу. Более того, наблюдается «суперинжекция»,
которая заключается в том, что концентрация инжектированных в базу носителей может на несколько
порядков превышать свое равновесное значение в эмиттерной области. В следующий момент
избыточные высокоэнергетические (возбужденые) электроны возвращаются из зоны проводимости в
валентную зону, где они рекомбинируют сдырками, излучая кванты световой энергии. В
гетероструктуре оптические свойства эмиттера и базы разные. Широкозонный эмиттер слабо
поглощает свет, который генерируется узкозонной базой, вместе с большей его оптической
плотностью ведет к концентрации в нем световой энергии. В гетероструктуре оптические свойства
эмиттера и базы разные. Широкозонный эмиттер слабо поглощает свет, который генерируется
узкозонной базой, вместе с большей его оптической плотностью ведет к концентрации в нем световой
энергии.
8.
ЭПИТАКСИЯ — это закономерное нарастание одного кристаллического материала на другом приболее низких температурах, то есть ориентированный рост одного кристалла на поверхности другого
(подложки). Строго говоря, рост всех кристаллов можно назвать эпитаксиальным: каждый
последующий слой имеет ту же ориентировку, что и предыдущий. Различают гетероэпитаксию, когда
вещества подложки и нарастающего кристалла различны (процесс возможен только для химически не
взаимодействующих веществ, например, так изготавливают интегральные преобразователи со
структурой кремний на сапфире), и гомоэпитаксию, когда они одинаковы. Ориентированный рост
кристалла внутри объёма другого называется эндотаксией. Эпитаксия особенно легко осуществляется,
если различие постоянных решёток не превышает 10 %. При больших расхождениях сопрягаются
наиболее плотноупакованные плоскости и направления. При этом часть плоскостей одной из решёток
не имеет продолжения в другой; края таких оборванных плоскостей образуют дислокации
несоответствия. Эпитаксия происходит таким образом, чтобы суммарная энергия границы, состоящей
из участков подложка-кристалл, кристалл-среда и подложка-среда, была минимальной. Эпитаксия
является одним из базовых процессов
технологии изготовления полупроводниковых
приборов и интегральных схем.
ЖИДКОФАЗНАЯ ЭПИТАКСИЯ в основном применяется для получения многослойных
полупроводниковых соединений, таких как GaAs, CdSnP2; также является основным способом
получения монокристаллического кремния (Метод Чохральского).
Готовится шихта из вещества наращиваемого слоя, легирующей примеси (может быть подана и в виде
газа) и металла-растворителя, имеющего низкую температуру плавления и хорошо растворяющий
материал подложки (Ga, Sn, Pb). Процесс проводят в атмосфере азота и водорода (для восстановления
оксидных плёнок на поверхности подложек и расплава) или в вакууме (предварительно восстановив
оксидные плёнки). Расплав наносится на поверхность подложки, частично растворяя её и удаляя
загрязнения и дефекты. После выдержки при максимальной температуре ≈1000С начинается
медленное охлаждение. Расплав из насыщенного состояния переходит в пересыщенное и избытки
полупроводника осаждаются на подложку, играющую роль затравки. Существуют три типа
контейнеров для проведения эпитаксии из жидкой фазы: вращающийся (качающийся), пенального
типа, шиберного типа.
9.
В современной полупроводниковой промышленности данный метод уже давно не используется,ввиду сложности контроля параметров получаемых плёнок (толщина, однородность толщины,
значение стехиометрического коэффициента), их относительно низкого качества, малой
производительности метода. Вместо него используется ГАЗОФАЗНАЯ ЭПИТАКСИЯ, нашедшая первое
промышленное применение для роста простых плёнок полупроводников IV группы таблицы
Менделеева (Ge, Si), а позже, с развитием технологии, вытеснившая жидкофазную эпитаксию из роста
плёнок полупроводников типа AIIIBV и AIIBVI. Также заменой является молекулярно-лучевая эпитаксия,
позволяющая проводить осаждение практически любых материалов. Метод жидкофазной эпитаксии
вытесняет конкурирующие технологии в изготовлении высокотемпературных фотоэлементов, к
примеру он оказался единственно возможным для фотоэлементов АМС MESSENGER.
МОЛЕКУЛЯРНО-ПУЧКОВАЯ ЭПИТАКСИЯ (МПЭ) или МОЛЕКУЛЯРНОЛУЧЕВАЯ ЭПИТАКСИЯ (МЛЭ) — эпитаксиальный рост в условиях
сверхвысокого вакуума. Позволяет выращивать гетеростуктуры
заданной толщины с моноатомно гладкими гетерограницами и с
заданным профилем легирования. В установках МПЭ имеется
возможность исследовать качество плёнок «in situ» (то есть прямо в
ростовой камере во время роста). Для процесса эпитаксии
Система молекулярно-пучковой
необходимы специальные хорошо очищенные подложки с
эпитаксии
атомарногладкой поверхностью.
В основе метода лежит осаждение испарённого в молекулярном источнике вещества
на кристаллическую подложку. Несмотря на достаточно простую идею, реализация данной
технологии требует чрезвычайно сложных технических решений. Основные требования к установке
эпитаксии следующие:
В рабочей камере установки необходимо поддерживать сверхвысокий вакуум (около 10−8 Па).
Чистота испаряемых материалов должна достигать 99,999999 %.
Необходим молекулярный источник, способный испарять тугоплавкие вещества (такие как металлы) с
возможностью регулировки плотности потока вещества.
Особенностью эпитаксии является невысокая скорость роста плёнки (обычно менее 1000 нм в час).
10.
ОСАЖДЕНИЕ МЕТАЛЛОРГАНИЧЕСКИХ СОЕДИНЕНИЙ ИЗ ГАЗОВОЙ ФАЗЫ ( Metalorganic chemical vapourdeposition) — метод химического осаждения из газовой фазы путём термического разложения
(пиролиза)
металлоорганических
соединений
для
получения
материалов
(металлов и полупроводников), в том числе путём эпитаксиального выращивания. Например, арсенид
галлия выращивают при использовании триметилгаллия ((CH3)3Ga) и трифенилмышьяка (C6H5)3As).
Сам термин предложен основоположником метода Гарольдом Манасевитом в 1968 году. В отличие
от молекулярно-лучевой эпитаксии рост осуществляется не в высоком вакууме, а из парогазовой
смеси пониженного или атмосферного давления (2 - 101 кПа).
КОМПОНЕНТЫ УСТАНОВКИ МОС-ГИДРИДНОЙ ЭПИТАКСИИ
Реактор - камера, в которой непосредственно происходит эпитаксиальный рост. Она сделана из
материалов, химически инертных по отношению к используемым химическим соединениям при
высоких
температурах
(400-1300°С).
Основными
конструкционными
материалами
являются нержавеющая сталь, кварц и графит. Подложки расположены на нагреваемом
подложкодержателе с контролем температуры. Он также сделан из материалов, стойких к
химическим веществам используемым в процессе (часто используют графит, иногда со специальными
покрытиями, также некоторые детали подложкодержателя делают из кварца). Для нагрева
подложкодержателя и камеры реактора до температуры эпитаксиального роста используют
резистивные или ламповые нагреватели, а также ВЧ-индукторы.
Газовая схема. Исходные вещества, находящиеся при нормальных условиях в газообразном состоянии
подаются в реактор из баллонов через регуляторы расхода газа. В случае, если исходные вещества при
нормальных условиях представляют собой жидкости или твердые вещества (в основном это все
применяемые металлоорганические соединения), используются так называемые испарителибарботеры (анг. 'bubbler'). В испарителе-барботере газ-носитель (обычно азот или водород)
продувается через слой исходного химического соединения, и уносит часть металлорганических
паров, транспортируя их в реактор. Концентрация исходного химического вещества в потоке газаносителя на выходе из испарителя зависит от потока газа-носителя, проходящего через испарительбарботер, давления газа-носителя в испарителе и температуры испарителя-барботера.
11.
Список химических соединений, используемых в качествеисточников для роста полупроводников методом MOCVD:
Алюминий
Триметилалюминий CAS 75-24-1 Al(CH3)3
Триэтилалюминий CAS 97-93-8 Al(C2H5)3
Галлий
Триметилгаллий Ga(CH3)3
Триэтилгаллий Ga(C2H5)3
Три(изо-пропил)галлий Ga(C3H7)3
Теллур
Диметилтеллур Диэтилтеллур
Ди(изо-пропил)теллур
Азот
Индий
Фенилгидразин
Триметилиндий In(CH3)3
Диметилгидразин
Триэтилиндий In(C2H5)3
Аммиак NH3
Сурьма
Фосфор
Триметилсурьма
Фосфин PH3
Триэтилсурьма Стибин SbH3 Мышьяк
Кремний
Арсин AsH3
Моносилан SiH4
Фениларсин
Дисилан Si2H6
Кадмий
Цинк
Диметилкадмий
Диэтилцинк Zn(C2H5)2
Полупроводники,
выращиваемые с помощью
MOCVD
III—V ПОЛУПРОВОДНИКИ
Арсенид галлия (GaAs)
Фосфид индия (InP)
InGaAs
InAlAs
InGaAlAs
InGaAsP
InGaAsN
AlGaAs
InGaAs
AlGaP
InGaP
InAlP
InAlP
Нитрид галлия (GaN)
InGaN
InGaAlN
Антимонид индия (InSb)
II—VI ПОЛУПРОВОДНИКИ
Селенид цинка (ZnSe)
КРТ (HgCdTe)










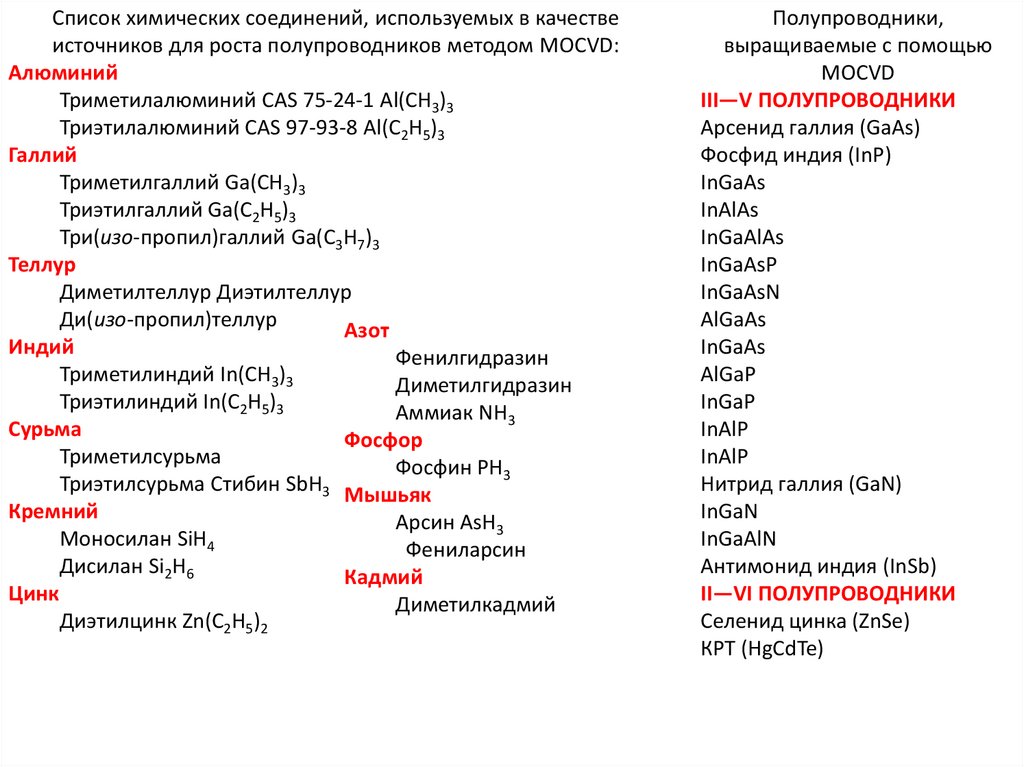
 Физика
Физика








