Похожие презентации:
Использование high-k диэлектриков при формировании МОПТ. (Лекция 7)
1. Лекция 7 Использование high-k диэлектриков при формировании МОПТ
приИспользование high-k диэлектриков при
формировании МОПТ
Лекция 7
2. Изменение толщины подзатворного окисла с уменьшением размеров элементов
(1)3. ВАХ подзатворного диэлектрика
(1)4. Токи через диэлектрик
Плотностьтока
Туннельный
ток
Токи
утечки
(2)
Напряжение на затворе, В
5. Граница применимости окисла кремния в качестве подзатворного диэлектрика
АЛТЕРНАТИВНЫЙДИЭЛЕКТРИК
(1)
6. Эквивалентная толщина диэлектрика
Тэ = Tд х кок/кдТэ - эквивалентная толщина диэлектрика (по оксиду
кремния)
Тд - толщина high-k диэлектрика
кд и кок - коэффициенты диэлектрической
проницаемости альтернативного диэлектрика и оксида
кремния
7. Влияние диэлектрической проницаемости на физическую толщину диэлектрика
(3)8. Влияние проницаемости high-k диэлектриков на эквивалентную и физическую толщины
Толщинапромежуточного
окисла 1 моносой
(3)
9. High – k диэлектрики
(4)10. Уменьшение подвижности носителей в канале в МОПТ с high-k диэлектриками
(4)11. Зависимость подвижности электронов от толщины промежуточного окисла
Подвижность(4)
Толщина промежуточного окисла, нм
12. Влияние промежуточного слоя окисла на необходимые параметры high-k диэлектрика
Эквивалентная толщина 1 нм(3)
13. Зависимость подвижности в канале МОПТ от эквивалентной толщины подзатворных диэлектриков с промежуточным окислом
(5)14. Проницаемость диэлектриков в зависимости от ширины запрещенной зоны
(5)Диэлектрическая проницаемость
15. Влияние ширины запрещенной зоны и проницаемости на токи утечки для различных эквивалентных толщин
(5)ЕОТ ( ангстремы )
16. Влияние краевых эффектов на максимальную толщину high-k диэлектриков
(6)17. Влияние проницаемости диэлектрика на пороговое напряжение и DIBL- эффект
Пороговое напряжение, В(6)
Диэлектрическая проницаемость
18. Влияние диэлектрической проницаемости на поле стока в канале МОПТ
(3)19. Изменение порогового напряжения при использовании диэлектриков с различной проницаемостью
Ток, стока мА(3)
Напряжение на затворе, В
20. Диапазон оптимальной проницаемости диэлектрика в зависимости от толщины промежуточного оксида
Ограниченияпо толщине
Хд = 1,2 нм
Диэлектрическая
проницаемость
Краевые
эффекты
Минимальная
толщина
Оптимальная
область
(5)
Толщина промежуточного окисла, ангстремы
21. Значения работы выхода для металлов
(3)22. Проблемы формирования МОПТ с high-k диэлектриком и металлическим затвором
Уменьшение концентрациикислорода
для снижения
эквивалентной толщины
Планарность границы
раздела
Предотвращение
диффузии металла
Ограничение высокотемпературных
процессов
Уменьшение
токов утечки
Ограничение диффузии
кислорода для уменьшения
эквивалентной толщины
Регулирование работы выхода
Предотвращение
кислородных вакансий
Предотвращение диполей
Уменьшение поверхностных
состояний
Удаление примесей
Предотвращение реакции
кремний - high-k- диэлектрик
Утонение слоя окисла
(3)
23. Микрофотография структуры с high – k диэлектриком
(4)24. Литература
1. MOS Scaling: Transistor Challenges for the21st Century. Intel Technology
Journal 03\98
2. SILICON PROCESSING FOR THE VLSI ERAVol. 4 – Deep-Submicron
Process Technology© 2002 LATTICE PRESS
3. EE 311 Note/Prof.Saraswai print 2003
4. Красников Г.Я. Конструктивно-технологические особенности
субмикронных МОП-транзисторов Москва: Техносила. 2011.
5. B.H.Lee at all. Metal Electrode/High-k Dielectric Gate-Stack Technology
for Power Manageme. IEEE Transactions on Electron Devices vol 55 No 1
2008
6. N.R.Mohapatra at all. The Effect High-K Dielectrics on Deep
Submicrometr CMOS Device and Circuit Performance


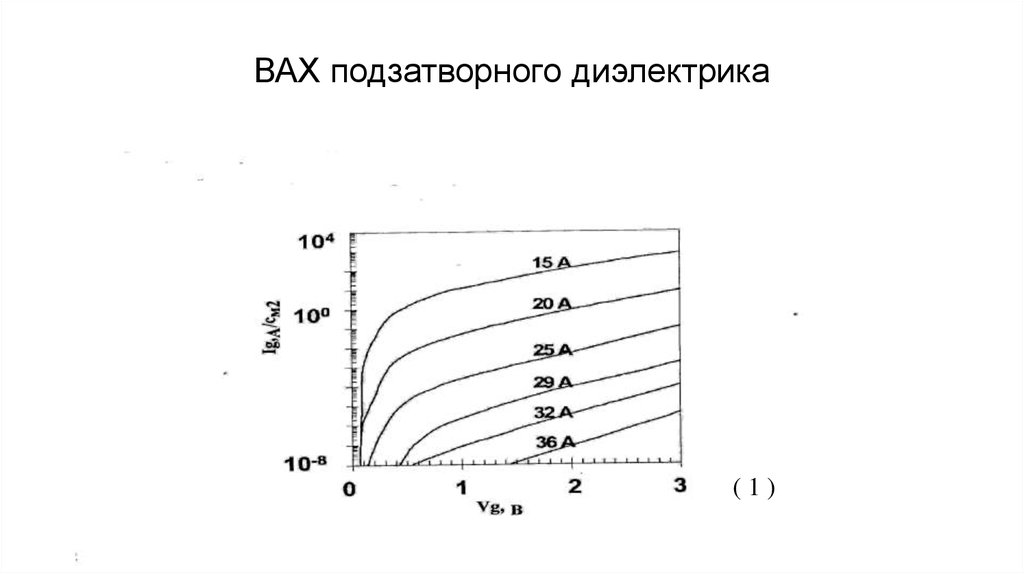








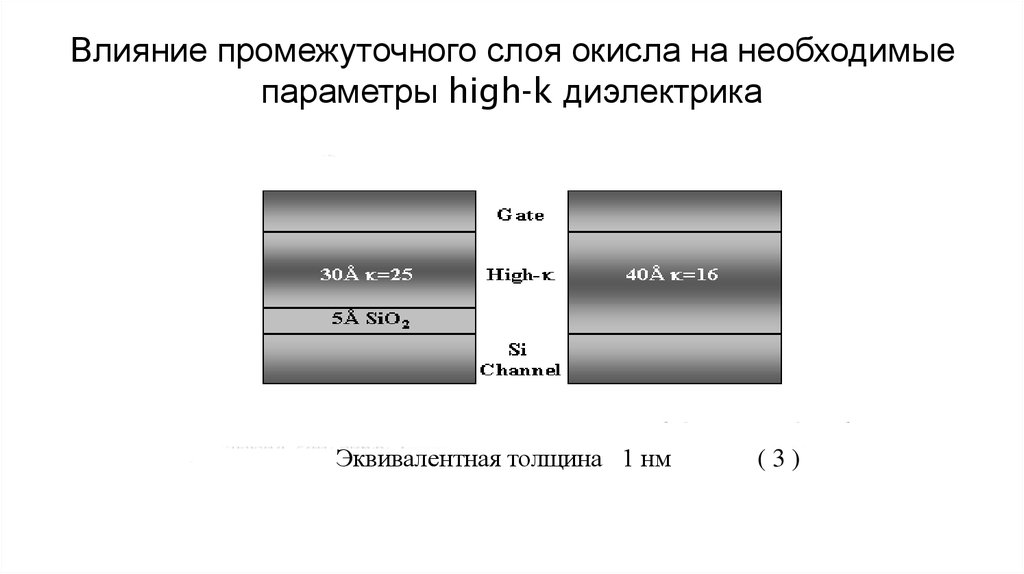

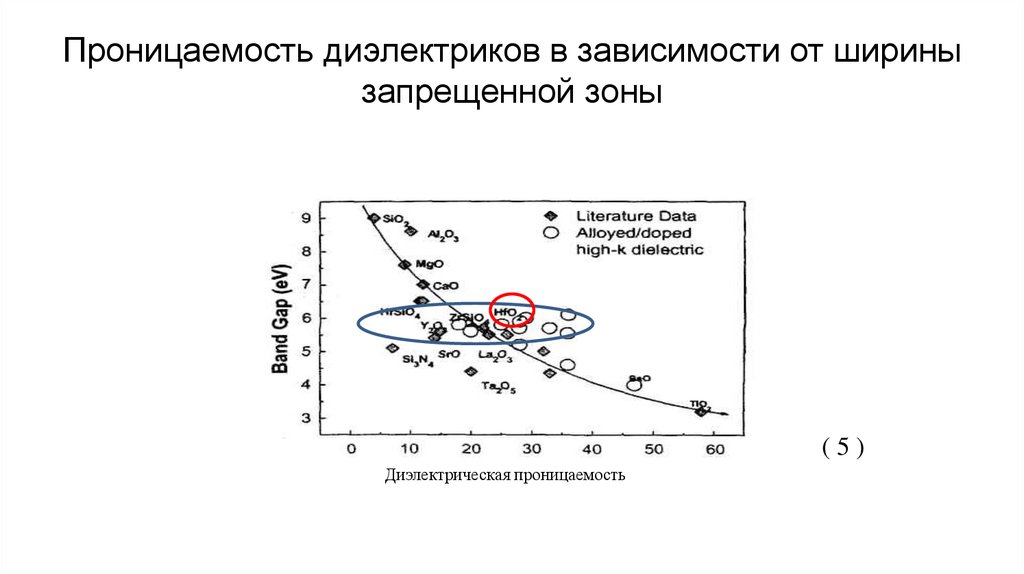
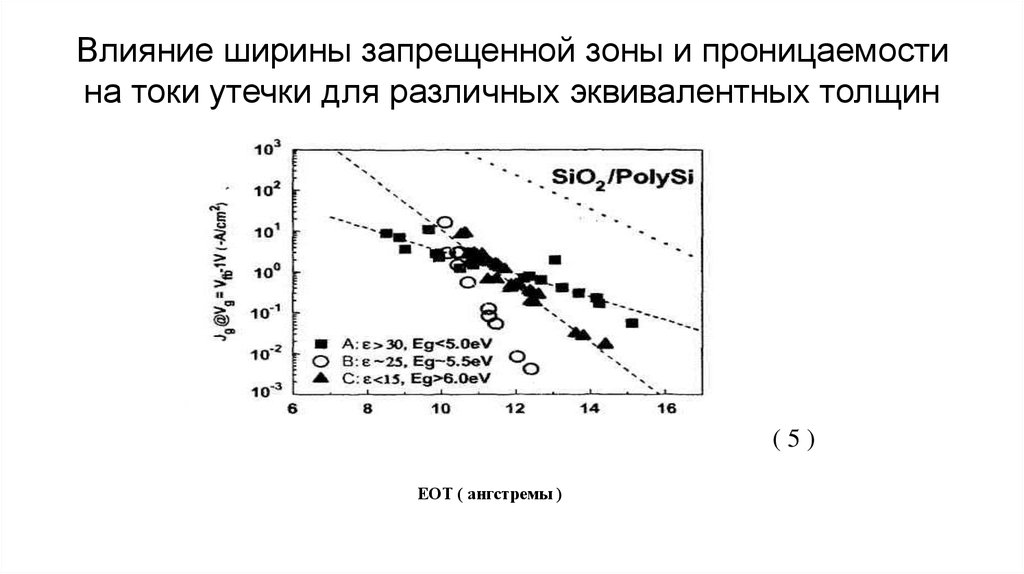
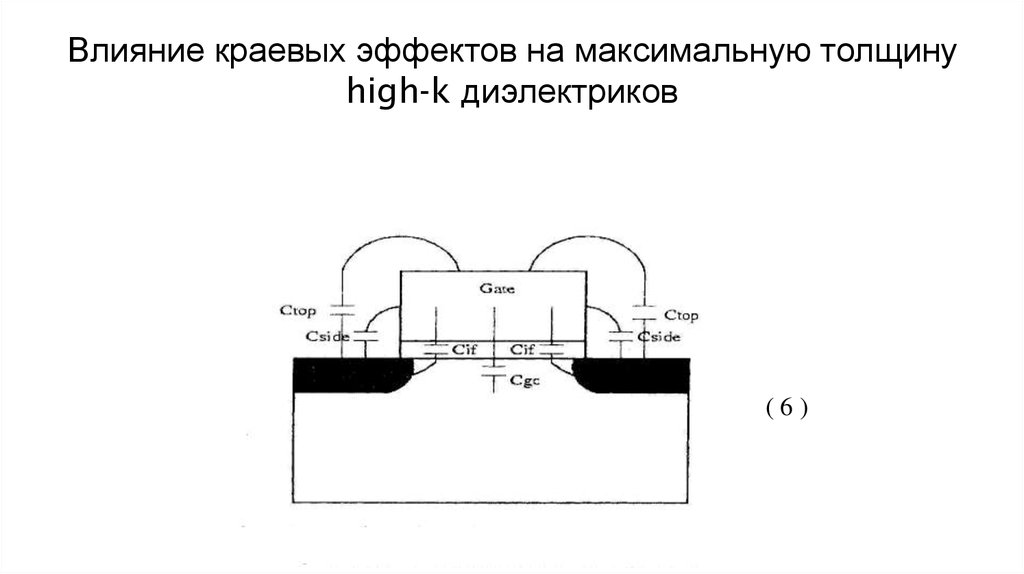

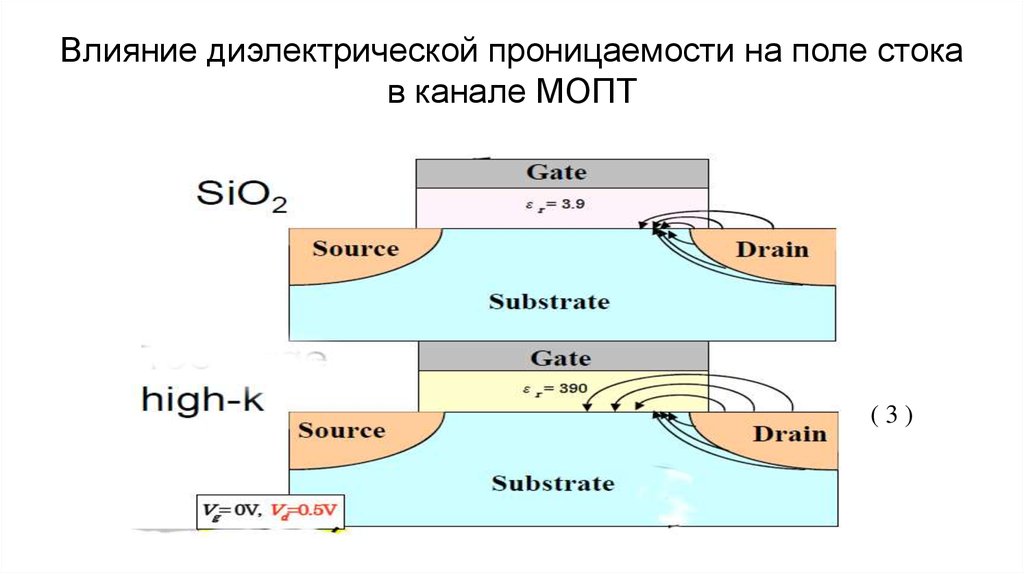

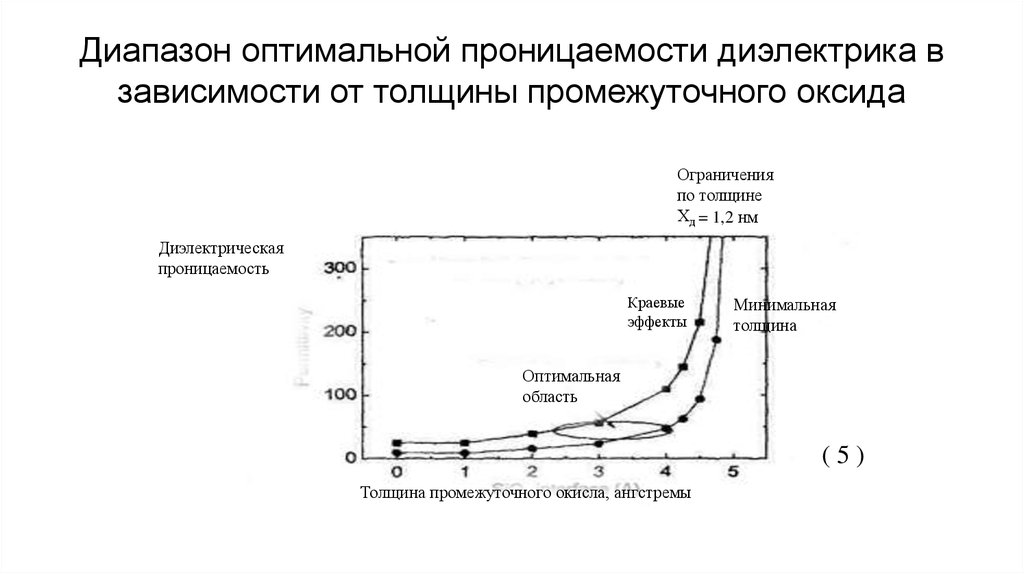

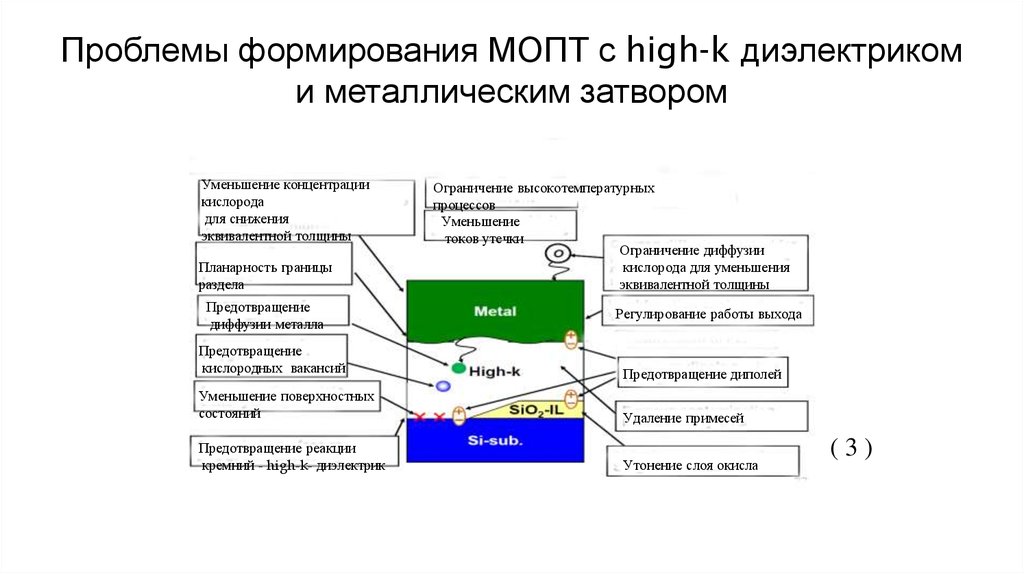
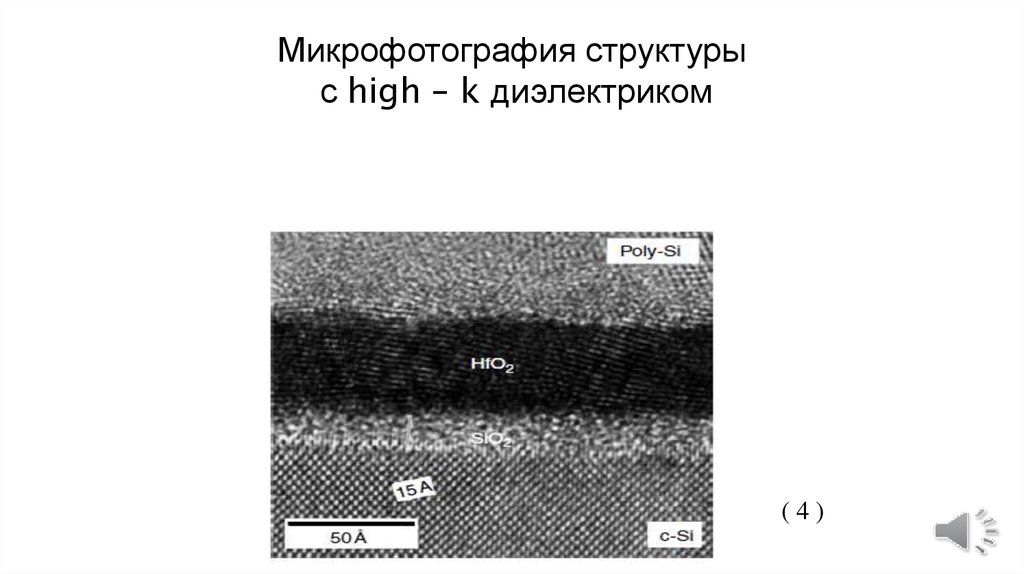

 Электроника
Электроника








