Похожие презентации:
Дифракция медленных электронов. Экспериментальная техника ДМЭ
1.
Дифракция медленных электронов. Экспериментальная техника ДМЭДифракция медленных электронов (ДМЭ) - это старейший из современных
методов исследования поверхности. Начало этому методу положили
классические опыты К. Дэвиссона и Л. Джермера, проведенные в 1927 году,
послужившие первым доказательством волновой природы электрона. Однако,
широкое применение ДМЭ, как и остальных методов исследования
поверхности, началось с 60-х годов в связи с развитием современной техники
сверхвысокого вакуума.
Медленными называются электроны с энергией 10 ... 100 эВ. Эта
энергия сравнима по абсолютной величине с энергией внешних оболочек
атомов. По этой причине медленные электроны сильно взаимодействуют с
веществом, хорошо рассеиваются, в результате чего средняя длина
свободного пробега составляет всего 5 ... 10 А. Этим обусловлена
поверхностная чувствительность метода.
Дифракционные картины при рассеянии медленных электронов
интерпретируют обычно в кинематическом приближении, в котором
пренебрегают потерями энергии первичных электронов. Другими словами,
вклад в дифракционную картину в этом приближении учитывается только от
упруго отраженных электронов. Поскольку при малых энергиях разница в
энергиях упруго отраженных и истинно вторичных электронов мала,
необходимо в экспериментальной установке принимать меры для отделения
упруго отраженных электронов от неупруго рассеянных. Для наблюдения
дифракции медленных электронов применяют сеточный сферический
анализатор с задерживающим полем, используемый для анализа вторичных
электронов в электронной спектроскопии
2.
Коллектор токаСхема АЗП, используемого в ДМЭ.
При использовании модулированного задерживающего потенциала,
как
показано
на
рисунке,
модулированная компонента детектируемого сигнала усиливается и
регистрируется синхронным детектором: 1 – образец; 2 – к синхронному детектору.
3.
4.
Дифракция отраженных быстрых электроновСхема эксперимента для ДОБЭ:
1 - электронная пушка; 2 - образец;
3 - экран.
Поверхностная чувствительность метода ДМЭ определяется выбором низкого
значения энергии электронов. При нормальном падении электронов с энергией 10 ...
100 кэВ поверхностная чувствительность теряется. Однако, если быстрые электроны
направить таким образом, чтобы первичный луч скользил по поверхности кристалла,
то несмотря на относительно большую среднюю длину свободного пробега
электронов, рассеяние отраженных электронов будет происходить в поверхностной
области. Поверхностная чувствительность метода отраженных быстрых электронов
(ДОБЭ) обусловлена, таким образом геометрией эксперимента. Геометрия метода
ДОБЭ обеспечивает хороший доступ к поверхности, чем обусловлена его
популярность для контроля роста эпитаксиальных структур непосредственно в
процессе их получения методом молекулярно-лучевой эпитаксии.
5.
Сравнение построений Эвальдадля быстрых и медленных
электронов.
kб, k 'б - волновые векторы
соответственно падающих и
рассеянных быстрых электронов:
kм, k 'м - волновые векторы
медленных электронов.
Особенности дифракционной картины, наблюдаемой на люминесцирующем
экране 3, в сравнении с ДМЭ обусловлены существенным различием в энергии
электронов. Длина волны электрона lэл с энергией 150 эВ составляет
приблизительно 1 А.Для быстрых же электронов с энергией ~ 15 000 эВ lэл ~ 0,1
А. Поэтому сфера Эвальда для быстрых электронов очень велика по отношению
к расстоянию между стержнями обратной решетки. Сфера Эвальда в этом
случае пересекает стержни обратной решетки не в отдельных точках, как это
имеет место при дифракции медленных электронов, а в виде полосы. По этой
причине картины ДОБЭ представляются не отдельными дифракционными
пятнами, а виде дифракционных полос. Следует отметить, что эти полосы
соответствуют стержням обратной решетки, лежащим вне плоскости схемы,
представленной на рис.
6.
Дифракция рентгеновских лучей при скользящем падении2d sinθ = nλ
условие Вульфа-Брегга
Симметричная и асимметричная
геометрии дифракции
излучение
m, cm–1
толщина слоя, на которой лучи ослабляются в e раз в зависимости от угла падения
луча α, мкм
a=2
a=5
a=10
a=15
CuKα
2242
0.15
0.34
0.59
0.76
CoKα
950
0.35
0.82
1.45
1.90
7.
CuKCoK
CuK
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
'
40
60
'
2 , degree
80
'
100
40
'
'
'
60
80
100
2 , degree
120
Рентгенограммы исходной стали AISI
321, полученные с использованием
CuKα и CoKα при различных углах
падения луча α
'
40
'
'
60
'
'
80
100
'
'
'
'
'
, degree
'
'
'
'
'
'
'
'
'
'
'
'
CoK
'
'
'
40
60
80
'
100
, degree
'
120
Рентгенограммы стали AISI 321,
имплантированной Al+, полученные с
использованием CuKα и CoKα при
различных углах падения луча α.
8.
Зависимости объемной доли фазового состава отглубины проникновения рентгеновского Сu- и
Со излучений для облученной (а) и
необлученной (б) поверхностей.
9.
Растровая электронная микроскопия1948 г. Англия. Чарльз Отли, Деннис МакМиллан.
В основе принципа работы растрового электронного микроскопа (РЭМ) лежит
сканирование поверхности электронным лучом. Электронный луч в виде
тонкого пучка электронов (зонд, диаметр луча <10 нм) обегает (сканирует)
образец по строчкам точку за точкой и синхронно передает сигнал на
кинескоп. При попадании электронного луча, в какую либо точку образца
происходит выбивание из его материала вторичных электронов и
отраженных электронов. Вторичные электроны играют первостепенную роль
в получении изображения поверхности образца (топографии). Они обладают
очень малой энергией на уровне 50 эВ и поэтому выходят из участков
образца, очень близких к поверхности (~ 5 нм). Яркость изображения точки на
экране кинескопа зависит от количества “выхода” электронов. Высокий выход
электронов из образца дает, светлую точку изображения на экране, малый
“выход” соответствует темной точке. В интервале между этими значениями
“выходов” электронов наблюдаются серые точки разных оттенков.
10.
Первичный электронный луч (зонд)образуется в вакуумной колонне
(электронная пушка) РЭМ. Электроны
вылетают из накаливаемого катода и
ускоряются электрическим полем
напряжением 1 50 кВ; луч фокусируется
тремя электромагнитными конденсорными
линзами и с помощью отклоняющих
катушек сканируется по образцу.
Устройство растрового
электронного
микроскопа
Электронный зонд представляет собой
тонкий пучок электронов приблизительно
цилиндрической формы, при воздействии
его на образец возбуждаются одинаково
малые пятна электронного возбуждения.
Это объясняет хорошую глубину резкости
изображения при растровой микроскопии.
11.
ElementApp
Weight%
Intensity
Atomic%
Conc.
Sigma
Corrn.
Cr K
1.34
0.59
1.1214
2.85
2.66
Fe K
43.11
0.59
0.9842
97.15
97.34
Totals
Weight%
100.00
12.
Сканирующий атомно-силовой микроскоп1982 г. Швейцария. Герд Беннинг, Кельвин Куэйт, Кристофер Гербер.
Схема работы атомно-силового
микроскопа
График зависимости силы Ван-дерВаальса от расстояния между
кантилевером и поверхностью образца
Принцип работы атомно-силового микроскопа основан на регистрации силового взаимодействия
между поверхностью исследуемого образца и зондом. В качестве зонда используется
наноразмерное остриё, располагающееся на конце упругой консоли, называемой кантилевером.
Сила, действующая на зонд со стороны поверхности, приводит к изгибу консоли. Появление
возвышенностей или впадин под остриём приводит к изменению силы, действующей на зонд, а
значит, и изменению величины изгиба кантилевера. Таким образом, регистрируя величину изгиба,
можно сделать вывод о рельефе поверхности.
Под силами, действующими между зондом и образцом, в первую очередь подразумевают
дальнодействующие силы Ван-дер-Ваальса, которые сначала являются силами притяжения, а
при дальнейшем сближении переходят в силы отталкивания.
13.
Контактный режим работы атомно-силового микроскопаПри работе в контактном режиме атомно-силовой микроскоп является аналогом профилометра.
Остриё кантилевера находится в непосредственном контакте между образцом и поверхностью.
Сканирование осуществляется, как правило, в режиме постоянной силы, когда система обратной
связи поддерживает постоянной величину изгиба кантилевера. При исследовании образцов
перепадами высот порядка единиц ангстрем возможно применять режим сканирования при
постоянном среднем расстоянии между зондом и поверхностью образца. В этом случае
кантилевер движется на некоторой средней высоте над образцом. Изгиб консоли
ΔZ,пропорциональный силе, действующей на зонд со стороны поверхности записывается для
каждой точки. Изображение в таком режиме представляет собой пространственное
распределение силы взаимодействия зонда с поверхностью.
Достоинства метода:
Наибольшая, по сравнению с другими методами, помехоустойчивость
Наибольшая достижимая скорость сканирования
Является единственным методом АСМ, позволяющим достичь атомарного разрешения
Обеспечивает наилучшее качество сканирования поверхностей с резкими перепадами рельефа
Недостатки метода:
Наличие артефактов, связанных с наличием латеральных сил, воздействующих на зонд со
стороны поверхности
При сканировании в открытой атмосфере (на воздухе) на зонд действуют капиллярные силы,
внося погрешность в определение высоты поверхности
Практически непригоден для изучения объектов с малой механической жёсткостью (органические
материалы, биологические объекты).
14.
Бесконтактный режим работы атомно-силового микроскопаПри работе в бесконтактном режиме пьезовибратором возбуждаются колебания зонда на некоторой
частоте (чаще всего, резонансной). Сила, действующая со стороны поверхности, приводит сдвигу
амплитудно-частотной и фазово-частотной характеристик зонда, и амплитуда и фаза изменяют
значения.
Система обратной связи, как правило, поддерживает постоянной амплитуду колебаний зонда, а
изменение частоты и фазы в каждой точке записывается. Однако возможно установление обратной
связи путём поддержания постоянной величины частоты или фазы колебаний.
Достоинства метода:
Отсутствует воздействие зонда на исследуемую поверхность
Недостатки метода:
Крайне чувствителен ко всем внешним шумам
Наименьшее латеральное разрешение
Наименьшая скорость сканирования
Функционирует лишь в условиях вакуума, когда отсутствует адсорбированный на поверхности слой
воды
Попадание на кантилевер во время сканирования частички с поверхности образца меняет его
частотные свойства и настройки сканирования "уходят"
В связи с множеством сложностей и недостатков метода, его приложения в АСМ крайне ограничены.
Полуконтактный режим работы атомно-силового микроскопа
При работе в полуконтактном режиме также возбуждаются колебания кантилевера. В нижнем
полупериоде колебаний кантилевер касается поверхности образца. Такой метод является
промежуточным между полным контактом и полным бесконтактом.
Достоинства метода:
Наиболее универсальный из методов АСМ, позволяющий на большинстве исследуемых образцов
получать разрешение 1-5 нм
Латеральные силы, действующие на зонд со стороны поверхности, устранены - упрощает
интерпретацию получаемых изображений
Недостатки метода:
Максимальная скорость сканирования меньше, чем в контактном режиме
15.
Морфология поверхности образцов углеродистой стали Ст3: а) висходном состоянии; б), в), г) после облучения ионами марганца с j=10,
30 и 50 мкА/см2 соответственно.
16.
Морфология поверхности образцовтитанового сплава ОТ-4: а –
исходное состояние; б, в – после
облучения дозой 1016 ион/см2,
ионами кремния и аргона,
соответственно.
Микротрещина на поверхности
образца облученного Si+ (5·1016
ион/см2), участок около излома







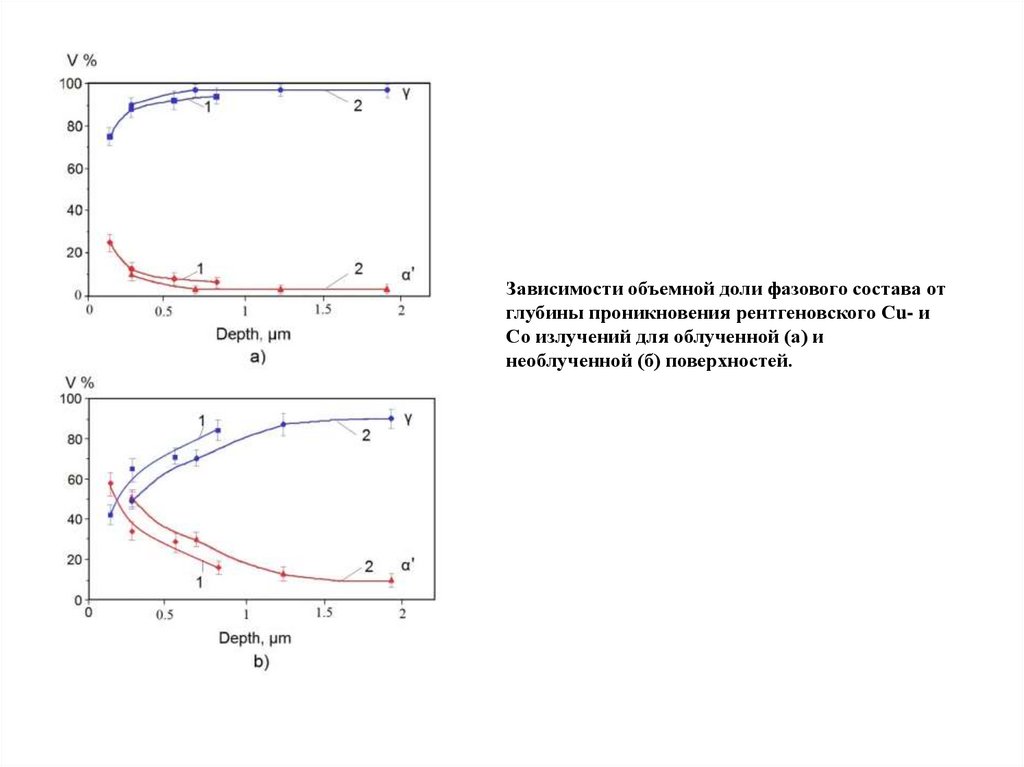






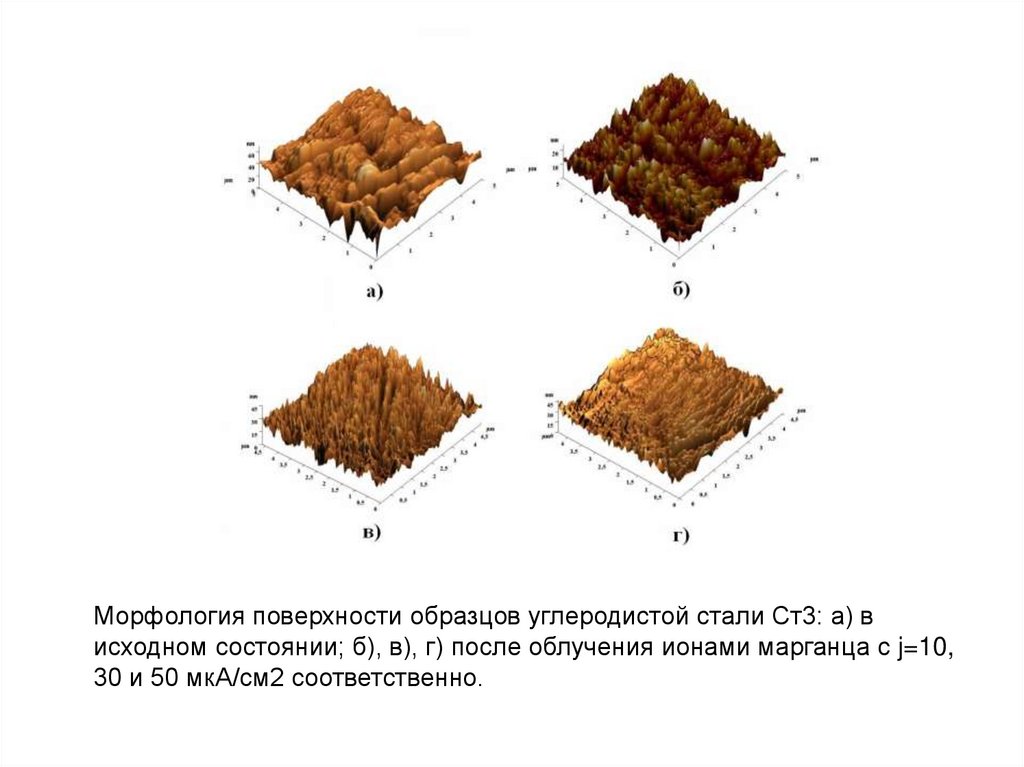

 Физика
Физика








