Похожие презентации:
Полупроводник. Состояние уровней энергий от расстояния между атомами
1.
Полупроводники2
2.
23.
Рис. 3. Состояние уровней энергий от расстояниямежду атомами.
Изолированные атомы (находящиеся на большом расстоянии друг от
друга), имеют отдельные энергетические уровни (рис. 3). В кристалле,
состоящем из N атомов, атомы находятся на очень близком расстоянии
друг от друга и поэтому взаимодействуют друг с другом. Согласно
принципу Паули, ни одна пара электронов в системе не может
находиться в одном энергетическом состоянии. Поэтому при
образовании кристалла каждый энергетический уровень изолированного
3
4.
атома расщепляется на N очень близко расположенных уровней и образуетсяэнергетическая зона. На рис. 3 показано расщепление энергетических
уровней в зависимости от расстояния r между атомами. Из него видно, что
заметно расщепляются и расширяются лишь уровни внешних, валентных
электронов, наиболее слабо связанных с ядром. Уровни же внутренних
электронов либо совсем не расщепляются, либо расщепляются слабо.
Расстояние между соседними энергетическими уровнями в зоне очень малое,
порядка 10-22 эВ. Совокупность уровней, на каждом из которых могут
находиться электроны, называют разрешенной зоной.
Разрешенная зона, в которой при температуре абсолютного нуля все
энергетические зоны заняты электронами, называется валентной (EV).
Разрешенная зона, в которой при температуре абсолютного нуля электроны
отсутствуют, называется зоной проводимости (EC). Между валентной зоной
и зоной проводимости расположена запрещенная зона (Eg). Ширина
запрещенной зоны является основным параметром, характеризующим
свойства твердого тела (рис. 4). Вещества, у которых ширина запрещенной
энергетической зоны 0,01 < ΔEg < 3 эВ, относятся к полупроводникам,
4
5.
а при ΔE > 3 эВ – к диэлектрикам. В полупроводниковой электроникеширокое применение получили германий Ge ( ΔE = 0,67 эВ) и кремний Si
( ΔE = 1,12 эВ) – элементы 4-й группы периодической системы элементов
Менделеева, а также арсенид галлия GaAs ( ΔE = 1,43 эВ).
Рис. 4. Структура энергетических зон полупроводника. а) Т=0 К, б) Т> 0 К.
5
6.
Собственная электропроводность полупроводниковТ= 0 К. Все электроны связаны и постоянный ток не может
протекать.
6
7.
Чтобы разорвать электронные связи между атомами и создать в такомкристалле свободные электроны, способные переносить электрический ток,
необходимо затратить энергию, равную Eg. – энергию ионизации. Валентный
электрон может получить эту энергию за счет тепловых колебаний атомов
кремния или падающего на кристалл света и перейдет из валентной зоны в
зону проводимости. При комнатной температуре 300 К энергия теплового
движения равна kT ≈ 0.026 эВ (1эВ =11600 К), т.е. kT << Eg . Максвелловское
распределение электронов по энергиям. После ухода электрона в валентных
связях образуется вакансия, которая называется дыркой. Атом со свободной
валентной связью оказывается заряженным положительно и будет притягивает к
себе соседние электроны, находящиеся на валентных связях. К новому
освободившемуся месту опять будут стремиться соседние электроны и т. д.
Если к кристаллу приложить внешнее напряжение, то свободные электроны
будут дрейфовать против поля (от минуса к плюсу), а разорванная связь
(дырка) – от плюса к минусу вдоль поля, создавая электрический ток. Еще раз
подчеркнем: реально перемещаются электроны. Дырка есть просто отсутствие
электрона. Но создавая теорию движения зарядов в полупроводниках, удобно
7
8.
следить за перемещением пустой связи – фиктивной частицы дырки. Концентрация свободных электронов в собственномполупроводнике обозначается ni, а концентрация дырок pi.
Процесс образования пары «электрон – дырка» называют генерацией
свободных носителей заряда. Взаимное уничтожение электрона и дырки при
столкновении называется рекомбинацией.
Т>0К
8
9.
Распределение электронов по энергетическим уровнямВероятность заполнения электроном энергетического уровня W при температуре T
определяется функцией распределения Ферми:
где T – температура в градусах Кельвина; k – постоянная Больцмана
1,38.1023 Дж/К);
EF – энергия уровня Ферми (средний энергетический уровень,
вероятность заполнения которого равна 0,5 при T = 0 К ).
При низких температурах справедлива грубая интерпретация
величины EF как энергетического уровня, который разделяет
заполненные и пустые состояния. При низких температурах
справедлива
грубая
интерпретация
величины
EF
как
энергетического уровня, который разделяет заполненные и пустые
состояния.
9
10.
В собственном полупроводнике уровень Ферми находится примерно всередине запрещенной зоны Eg (см. рис. 1.2 а), поэтому выполняются
неравенства
Действительно, при = 300 К величина kT равна 0,026 эВ, а ширина
запрещенной зоны для большинства полупроводников порядка 1 эВ. В случае
выполнения неравенств (2) распределение Ферми (1) можно заменить
распределением Больцмана:
10
11.
Здесь NC — эффективная плотность состояний в зоне проводимости. Она тембольше, чем плотнее расположены уровни в зоне. Концентрация дырок p
определяется суммированием пустых состояний в валентной зоне и выражается
аналогичной формулой:
Соответственно NV — эффективная плотность состояний в
валентной зоне. Величина эффективных плотностей состояний NC
и NV для кремния — порядка 1019 см−3. Энергии электронов и
дырок принято отсчитывать от дна зоны проводимости EC, причем
энергия электронов отсчитывается вверх, а энергия дырок — вниз.
Положив в формулах (4)–(5) EC = 0, получим для концентраций
электронов и дырок:
11
12.
Здесь EF — отрицательная величина, т. к. уровень Ферми лежитниже нулевого уровня EC, а Eg – ширина запрещенной зоны.
Рис.7. Зонная диаграмма собственных полупроводников.
12
13.
В собственном полупроводнике образование электронов и дырок (генерация)происходит одновременно, поэтому ni = pi. Положив в (6) и (7) n = p = ni,
получим:
Как следует из формулы (8), собственная концентрация носителей тока в
полупроводнике тем больше, чем меньше ширина запрещенной зоны и чем
выше температура.
Примесная электропроводность полупроводников
Электропроводность полупроводника может обуславливаться не только генерацией пар
носителей «электрон – дырка» вследствие какого-либо энергетического воздействия, но
и введением в структуру полупроводника определенных примесей. Полупроводник,
состоящий из кристалла германия или кремния, с примесью элементов третьей или
пятой группы таблицы Менделеева, называется примесным. Различают донорную и
акцепторную примесь. Если в кремний внести мышьяк или фосфор, у которых пять
валентных электронов, то такой атом называют донором, а полупроводник n – типа.
Донорные примеси (5-ти валентные атомы): мышьяк As, фосфор P , сурьма Sn.
13
14.
Донор отдает четыре своих электрона на образование валентныхсвязей с четырьмя ближайшими атомами основного 4 –х валентного
полупроводника, а один электрон оказывается «лишним». Этот
пятый электрон относительно слабо связан с атомом примеси, и при
его отрыве атом примеси становится положительным ионом.
14
15.
Энергия ионизации донорного уровня обозначается ED и оназначительно меньше энергии ионизации атома кремния Eg. На зонной
диаграмме (рис. 9, а) донорные уровни изображаются линией, лежащей
в запрещенной зоне на расстоянии ED от дна зоны проводимости EC.
Мелкие доноры (т. е. доноры, для которых ED ≪ Eg) при комнатной
температуре полностью ионизованы.
Рис.9. Зонная диаграмма примесных полупроводников. а) n- типа, б) p – типа.
15
16.
Атом примеси, потеряв один электрон, становится положительнозаряженным ионом с единичным положительным зарядом, но он остается в
узле кристаллической решетки, и в отличие от «дырки тоже имеющей
единичный положительный заряд, он не может перемещаться внутри
кристалла, так как связан с соседними атомами полупроводника
межатомными связями, и может лишь совершать колебательные движения
около положения равновесия в узле кристаллической решетки. При этом
электрическая нейтральность кристалла полупроводника не нарушается, так
как заряд каждого электрона, перешедшего в зону проводимости,
уравновешивается положительно заряженным ионом примеси. Этот вид
электропроводности называется электронной и обозначается буквой n
(негативная, отрицательная проводимость), а полупроводники с таким типом
проводимости называются полупроводниками n-типа. Концентрация
электронов в зоне проводимости при kT ≪ ED может быть определена по
формуле :
(9)
Здесь через ND обозначена концентрация донорной примеси.
16
17.
Одновременно с ионизацией доноров происходит генерация электронов идырок, связанная с переходами электронов из валентной зоны в зону
проводимости (этот процесс иллюстрирует длинная стрелка на рис. 9 a.
Вероятность этих переходов крайне мала, т. к. kT ≪ Eg. Поэтому
концентрация электронов в зоне проводимости при комнатной температуре
практически равна ND, а концентрация дырок в валентной зоне ничтожно
мала.
Формулы (6) и (7) справедливы не только для собственного, но и для
примесного полупроводника, если концентрация примесных атомов не
слишком велика: ND ≪ NC . Перемножив формулы (6) и (7), получим:
(10) или, с учетом (8)
(11)
Оценим концентрации электронов и дырок при комнатной температуре в
кремнии, легированном донорами с концентрацией ND = 1016 см−3.
Собственная концентрация носителей в кремнии при комнатной
температуре составляет ni = 1,4 ×·1010 см−3. При комнатной температуре все
доноры ионизованы и концентрация электронов равна концентрации
доноров: n = ND = 1016 см−3. Для определения концентрации дырок
воспользуемся формулой (11).
17
18.
Получим:Из этого примера видим, что концентрация дырок в полупроводнике n-типа
оказывается на много порядков ниже, чем концентрация электронов. Более того,
концентрация дырок в донорном полупроводнике становится меньше
собственной концентрации носителей ni. Это связано с тем, что при большой
концентрации электронов интенсивнее идут процессы рекомбинации. И без
того небольшое число собственных дырок уничтожается при столкновении с
большим числом электронов. В результате число дырок оказывается даже
меньше, чем в собственном полупроводнике. Электроны в полупроводнике nтипа называются основными носителями тока, а дырки - неосновными.
18
19.
Акцепторные примесиЕсли валентность атома примеси меньше, чем валентность атомов основного
вещества, то примесь называют акцепторной. Для кремния и германия
такими элементами являются 3-х валентные бор B, алюминий Al, индий In,
галлий Ga. У трехвалентного элемента не хватает одного электрона для
образования полноценной валентной связи с атомом основного вещества.
19
20.
Образуется вакансия, место которой может занять электрон, перешедший с соседнегоатома основного вещества. Ионизованный атом примеси окажется отрицательно
заряженным ионом, а атом основного вещества, с которого перешел электрон,
зарядится положительно и будет стремиться захватить соседние электроны. Вакансия
начнет перемещаться по кристаллу, в валентной зоне появится дырка. Такой тип
проводимости называется дырочным и обозначается буквой p (позитивный,
положительный тип проводимости), а полупроводник называется полупроводником р –
типа.
Для полупроводника р-типа диаграмма распределения электронов по электрическим
уровням будет иметь вид, представленный на рис. 9 б. Вероятность захвата электрона
и перехода его в валентную зону возрастает в полупроводниках p-типа, поэтому
уровень Ферми EF здесь смещается вниз, к границе валентной зоны (рис. 9 б). Зонная
диаграмма полупроводника p-типа изображена на рис.9 б. При комнатной температуре
мелкие акцепторы, у которых EA<<Eg, оказываются полностью ионизованными.
Концентрация дырок при T = 300 К практически равна концентрации примеси NА, а
концентрация электронов в зоне проводимости ничтожно мала. В полупроводнике pтипа дырки называются основными носителями тока, а электроны - неосновными
носителями, т. к. их мало. Концентрация дырок при kT ≪ E может быть определена по
формуле, аналогичной (9):
(12)
20
21.
На рис. 11 приведен график зависимости концентрации электронов влогарифмическом масштабе ln(n) от обратной температуры 1/T в
полупроводнике n-типа. При низких температурах концентрация электронов
совпадает с концентрацией ионизованных доноров и определяется формулой
Область собственной
проводимости
Область примесного
истощения
Рис. 11. Температурная зависимость концентрации электронов в
полупроводнике n-типа.
21
22.
(9). При температуре T1 концентрация электронов перестает зависеть оттемпературы, т. к. все доноры уже ионизованы, а собственная
концентрация, связанная с переходами из валентной зоны в зону
проводимости, еще мала. Температуру T1 можно определить из (9),
положив n = ND : Собственная концентрация становится заметной
только при достаточно высокой температуре T2. Область температур T1
< T < T2 называется областью примесного истощения. При T > T2
собственная концентрация становится больше примесной. Эта область
называется областью собственной проводимости, в которой
концентрация электронов определяется собственной концентрацией
(1.8). При температуре T2 концентрация ni становится равной
концентрации доноров.
22
23.
В большинстве полупроводников, используемых при изготовленииполупроводниковых приборов, при комнатной температуре атомы
примеси уже полностью ионизованы, а генерация «собственных» пар
электрон–дырка еще не началась. Так, для кремния температура T1
составляет около 120 К, а температура T2 — порядка 400 К [2], и
комнатные температуры попадают в область примесного истощения.
Поэтому в дальнейшем мы будем полагать, что концентрация основных
носителей тока равна концентрации атомов соответствующей примеси,
а концентрацию неосновных носителей будем вычислять по формулам
(10) и (11).
23
24.
Токи в полупроводникахТоки в полупроводниках возникают при перемещении носителей заряда
1. под действием электрического поля
2. из-за диффузии заряженных частиц (градиента концентрации носителей заряда).
Полный ток складывается из двух составляющих: дрейфовой и диффузионной.
Дрейф носителей заряда
Дрейфом называют направленное движение носителей заряда под действием
электрического поля. Электроны, получая ускорение в электрическом поле,
приобретают на средней длине свободного пробега добавочную составляющую
скорости, которая называется дрейфовой скоростью Vn.др , к своей средней скорости
движения. Дрейфовая скорость электронов мала по сравнению со средней скоростью
их теплового движения в обычных условиях. (Vn.др. =1 мм/с, Vтепл.=100 км/с).
Плотность дрейфового тока, связанную с движением электронов, можно выразить
через дрейфовую скорость Vn. др:
где n – концентрация электронов в 1 см3; e – заряд электрона.
24
25.
Знак «минус» в формуле (17) связан с тем, что электроны переносят ток внаправлении, противоположном направлению движения. Дрейфовая скорость
Vn почти всегда пропорциональна электрическому полю E:
(18)
Подвижность электронов μn определяется как средняя скорость, приобретаемая
электроном в поле с единичной напряженностью. Знак «минус» в формуле (18) означает,
что электроны движутся в сторону, противоположную направлению электрического
поля. Из (17) и (18), получим для электронной составляющей дрейфового тока
выражение:
Для плотности дырочного тока Jp и дрейфовой скорости дырок Vp . можно
написать формулы, аналогичные (17)–(19):
25
26.
где p - концентрация дырок в 1 см3, μp - подвижность дырок. Плотностьсуммарного дрейфового тока в полупроводнике Jдр связана с
напряженностью электрического поля E уравнением:
где σ - проводимость полупроводника. Из (19) и (20), получим для
проводимости:
Диффузионный ток.
Диффузионный ток связан с неоднородностью распределения носителей тока
в пространстве. Из-за хаотичности движения частиц - электронов и дырок возникает диффузионный поток частиц, направленный из области с большей
концентрацией в область с меньшей концентрацией. Поскольку эти
частицы заряжены, диффузионный поток частиц переносит электрический
ток.
26
27.
Диффузионный ток прекращается, когда концентрации носителей в разныхточках пространства выравниваются. Количественно плотность диффузионного
потока (поток через единицу площади за 1 с) подчиняются закону Фика:
27
28.
Знак «минус» в формуле (24) отражает тот факт, что дыркидвижутся в направлении уменьшения их концентрации. В
формуле (25) два минуса (отрицательный заряд электронов и
отрицательный градиент концентрации) компенсируют друг
друга. Суммарный диффузионный ток в полупроводнике
обусловлен движением и дырок, и электронов:
28
29.
Коэффициенты диффузии и подвижности связаны друг сдругом соотношениями Эйнштейна:
29
30.
Одновременно с процессом диффузии носителей зарядапроисходит процесс их рекомбинации. Поэтому избыточная
концентрация уменьшается в направлении от места источника
этой избыточной концентрации. Расстояние, на котором при
одномерной диффузии в полупроводнике без электрического
поля в нем избыточная концентрация носителей заряда
уменьшается в результате рекомбинации в e раз, называется
диффузионной длиной L . Иначе, это расстояние, на которое
диффундирует носитель за время жизни. Диффузионная длина L
связана со временем жизни носителей соотношениями:
где τn и τp – время жизни электронов и дырок, соответственно.
30
31.
Электронно-дырочный переход.Работа целого ряда полупроводниковых приборов (диодов, транзисторов,
тиристоров и др.) основана на явлениях, возникающих в контакте между
полупроводниками с разными типами проводимости. Граница между двумя
областями монокристалла полупроводника, одна из которых имеет
электропроводность типа p, а другая – типа n называется электроннодырочным переходом. Концентрации основных носителей заряда в областях
p и n могут быть равными или существенно отличаться.
P–n-переход, у которого концентрации дырок и электронов практически
равны Np ≈ Nn , называют симметричным. Если концентрации основных
носителей заряда различны (Np >> Nn или Np >>Nn) и отличаются в
100…1000 раз, то такие переходы называют несимметричными.
Несимметричные p–n-переходы используются шире, чем симметричные,
поэтому в дальнейшем будем рассматривать только их.
31
32.
Рис.12. Начальный момент образования p–n-переходаРассмотрим монокристалл полупроводника (рис. 12), в котором, с
одной стороны, введена акцепторная примесь, обусловившая
возникновение здесь электропроводности типа p, а с другой стороны,
введена донорная примесь, благодаря которой там возникла
электропроводность типа n.
32
33.
Каждому подвижному положительному носителю заряда в областиp (дырке) соответствует отрицательно заряженный ион
акцепторной примеси, но неподвижный, находящийся в узле
кристаллической решетки, а в области n каждому свободному
электрону соответствует положительно заряженный ион донорной
примеси, в результате чего весь монокристалл остается
электрически нейтральным.
Свободные носители электрических зарядов под действием
градиента концентрации начинают перемещаться из мест с
большой концентрацией в места с меньшей концентрацией. Так,
дырки будут диффундировать из области p в область n, а
электроны, наоборот, из области n в область p. Это направленное
навстречу друг другу перемещение электрических зарядов
образует диффузионный ток p–n-перехода.
33
34.
3435.
Вблизи границы образуется двойной заряженный слой примесныхатомов: доноры со стороны полупроводника n-типа заряжены
положительно, т. к. от них ушли электроны, акцепторы со стороны
полупроводника p-типа заряжены отрицательно, т. к. место
вакансий заняли отрицательно заряженные электроны (Рис.13). При
этом концентрация свободных носителей вблизи металлургической
границы резко уменьшается, т. е. образуется область, обедненная
носителями тока. Между этими зарядами возникает электрическое
поле с напряжённостью E, которое называют полем потенциального
барьера, а разность потенциалов на границе раздела двух зон,
обуславливающих это поле, называют контактной разностью
потенциалов Δφк. Возникающее электрическое поле препятствует
дальнейшей диффузии основных носителей тока, но способствует
переходу через границу неосновных носителей — дырок из nобласти и электронов из p-области.
35
36.
Таким образом, в узкой области δ, где действует полепотенциального барьера, образуется слой, где практически
отсутствуют свободные носители электрических зарядов и
вследствие этого обладающий высоким сопротивлением. Это так
называемый запирающий слой. При отсутствии внешнего
электрического поля устанавливается динамическое равновесие
между потоками основных и неосновных носителей электрических
зарядов, то есть между диффузионной и дрейфовой
составляющими тока p–n-перехода, поскольку эти составляющие
направлены навстречу друг другу.
В стационарном состоянии диффузионный поток электронов из
n- области в p- область в точности скомпенсирован потоком
электронов в электрическом поле Е слева направо.
36
37.
После образования p–n-перехода p- и n-области объединены в единуюквантово-механическую систему с единым уровнем Ферми. Выравнивание
уровня Ферми в n- и p-областях приводит к искривлению энергетических зон
вблизи p–n-перехода (рис.). Вдали от p–n-перехода зонная картина остается
прежней.
Рис. 13а. Искривление энергетических зон вблизи p–n-перехода
37
38.
3839.
Отсюда, используя формулу (8)получим выражение для высоты потенциального барьера:
e K kT ln
nn p p
2
i
n
32
Принимая во внимание, что
где nn, -концентрации основных носителей (электронов) и pn - концентрации
неосновных носителей (дырок) в n области, ni – концентрация собственных
носителей, получим для равновесных концентраций и дырок по обе стороны
перехода:
e K
e K
n p nn exp(
); pn p p exp(
)
kT
kT
33
39
40.
Образовавшийся потенциальный барьер представляет собой препятствие длядвижения основных носителей тока (nn и pp) через p–n-переход, т. е. для
движения дырок из p- в n-область и для движения электронов из n- в p-область.
Тем не менее часть наиболее энергичных основных носителей оказывается
способной преодолеть этот потенциальный барьер и перейти в соседнюю
область. Так возникает диффузионный ток, направленный из p-области в nобласть, т. е. против контактного поля EK. Диффузионный ток небольшой, т. к.
лишь малая часть всех основных носителей имеет достаточную энергию для
преодоления потенциального барьера. Неосновные носители (pn и np), наоборот,
легко преодолевают образовавшийся потенциальный барьер. Поле перехода EK
переносит дырки pn из n-области в p-область, а электроны np из p-области в nобласть. Это движение неосновных носителей создает дрейфовый ток,
направленный противоположно току основных носителей. Этот ток также
небольшой, потому что самих неосновных носителей в полупроводнике очень
мало. В состоянии равновесия, т. е. когда к – n-переходу не приложено внешнее
поле, диффузионный и дрейфовый токи одинаковы по величине. Суммарный
ток через p–n-переход равен нулю.
40
41.
Рис. 15. Распределение потенциала ϕ и концентрации электронов n идырок p вдоль оси x, перпендикулярной металлургической границе
41
42.
На рис. 15 приведены графики распределения потенциала φ и концентрацийэлектронов и дырок по оси x, перпендикулярной к границе p–n-перехода.
Координата x = 0 соответствует металлургической границе. Здесь принято,
что концентрация акцепторов в p-области (NA) выше, чем концентрация
доноров в n-области (ND). Концентрация неосновных носителей меньше
там, где выше концентрация примесей, т. е. np < pn. Это связано с тем, что
чем больше основных носителей в полупроводнике, тем интенсивнее идет
рекомбинация. Большое количество дырок в p-области рекомбинирует с
электронами, и число электронов уменьшается. Ширина слоя отрицательно
заряженных акцепторов обозначена на рис. 15 через dp; ширина слоя
положительно заряженных доноров - через dn. Ширина p–n-перехода
больше со стороны слабо легированной области. Действительно, учитывая
равенство электрического заряда положительно заряженных доноров и
отрицательно заряженных акцепторов в области p–n-перехода QD+ = QA−,
получим:
42
43.
Формула (34) показывает, что ширина p–n-перехода обратно пропорциональнаконцентрации соответствующей примеси.
Интегрируя (36), получим для n
области:
для p области
n
e
exp( K ) 6.5 10 10
ND
2kT
43
44.
Решая дифференциальное уравнение (37) с учетом (38-39) и с граничнымиусловиями: φ = 0, если x = −dp; φ = φк, если x = dn и приравнивая полученные
потенциалы в точке x = 0, получим уравнение:
2 0
K N Ad p2 N D d n2
e
(40)
Используя (39) и (40), получим для ширины p-n- перехода:
d dn d p
2 0
1
1
K (
)
e
N A ND
(41)
Область p–n-перехода (−dp < x < dn) называют также обедненным слоем из-за
очень малой концентрации свободных носителей. Для кремния φк = 1.1 В. Для
Т=300 К и средины слоя имеем:
n
e K
exp(
) 6.5 10 10
ND
2kT
45.
Прямое смещение идеального p–n-переходаПрямым смещением называется такое включение p–n-перехода, при котором
положительный потенциал подается на p-область, а отрицательный — на n-область.
Разность этих потенциалов будем обозначать через U. Тогда напряженность электрического поля внешнего источника Eвн будет направлена навстречу напряженности
поля потенциального барьера E и, следовательно, приведет к снижению
результирующей напряженности Eрез :
(42)
Это приведет, в свою очередь, к снижению высоты потенциального барьера
и увеличению количества основных носителей, диффундирующих через границу
раздела в соседнюю область, которые образуют так называемый прямой ток p–nперехода. При этом вследствие уменьшения тормозящего, отталкивающего действия
поля потенциального барьера на основные носители, ширина запирающего слоя
уменьшается и, соответственно, уменьшается его сопротивление. Ширина p–nперехода при прямом смещении определяется по формуле:
(43)
45
46.
По мере увеличения внешнего напряжения прямой ток p–n-перехода возрастает.Основные носители после перехода границы раздела становятся неосновными в
противоположной области полупроводника и, углубившись в нее, рекомбинируют с
основными носителями этой области, но, пока подключен внешний источник, ток
через переход поддерживается непрерывным поступлением электронов из внешней
цепи в n-область и уходом их из p-области во внешнюю цепь, благодаря чему восстанавливается концентрация дырок в p-области.
Введение носителей заряда через p–n-переход при понижении высоты
потенциального барьера в область полупроводника, где эти носители являются
неосновными, называют инжекцией носителей заряда. При протекании прямого тока
из дырочной области р в электронную область n инжектируются дырки, а из
электронной области в дырочную – электроны.
Инжектирующий слой с относительно малым удельным сопротивлением называют
эмиттером; слой, в который происходит инжекция неосновных для него носителей
заряда, – базой.
При изменении приложенного напряжения U вместе с шириной p–n-перехода
изменяется заряд двойного слоя акцепторов и доноров. Это означает, что p–n-переход
характеризуется емкостью; эта емкость называется барьерной емкостью. Величина
барьерной емкости определяется по формуле, аналогичной формуле плоского
конденсатора : C = εε0/d, или
46
47.
(44)где
На рис. 1.16 изображена зонная энергетическая диаграмма, соответствующая
прямому смещению p–n-перехода.
47
48.
Обратное смещение идеального p–n-переходаЕсли к р-n-переходу подключить внешний источник с противоположной полярностью «–»
к области p-типа, «+» к области n-типа (рис. 1.17), то такое подключение называют
обратным включением p–n-перехода (или обратным смещением p–n-перехода).
48
49.
В данном случае напряженность электрического поля этого источника Eвн будетнаправлена в ту же сторону, что и напряженность электрического поля E потенциального
барьера; высота потенциального барьера возрастает, а ток диффузии основных носителей практически становится равным нулю. Ширина p–n-перехода при обратном
смещении равна:
(45)
Барьерная емкость p–n-перехода при обратном включении уменьшается. Эту емкость
можно определить по формуле, аналогичной (44):
(46)
Из-за усиления тормозящего, отталкивающего действия суммарного электрического поля
на основные носители заряда ширина запирающего слоя δ увеличивается (δ”> δ ), а его
сопротивление резко возрастает. Теперь через р–n-переход будет протекать очень
маленький ток, обусловленный перебросом суммарным электрическим полем на границе
раздела, неосновных носителей. Этот ток чрезвычайно мал
т. к. концентрация
неосновных носителей крайне мала. Так, в кремнии плотность обратного тока порядка
10−10 А/см2.Процесс переброса неосновных носителей заряда называется экстракцией.
Этот ток имеет дрейфовую природу и называется обратным током р–n-перехода.
49
50.
На рис. 1.18 изображена зонная энергетическая диаграмма, соответствующая обратномусмещению p–n-перехода.
50
51.
Выводы:1. P–n-переход образуется на границе p- и n-областей, созданных в монокристалле
полупроводника.
2. В результате диффузии в p–n-переходе возникает электрическое поле потенциальный
барьер, препятствующий выравниванию концентраций основных носителей заряда в
соседних областях.
3. При отсутствии внешнего напряжения Uвн в p–n-переходе устанавливается
динамическое равновесие: диффузионный ток становится равным по величине
дрейфовому току, образованному неосновными носителями заряда, в результате чего ток
через p–n-переход становится равным нулю.
4. При прямом смещении p–n-перехода потенциальный барьер понижается и через
переход протекает относительно большой диффузионный ток.
5. При обратном смещении p–n-перехода потенциальный барьер повышается,
диффузионный ток уменьшается до нуля и через переход протекает малый по величине
дрейфовый ток. Это говорит о том, что p–n-переход обладает односторонней
проводимостью. Данное свойство широко используется для выпрямления переменных
токов.
6. Ширина p–n-перехода зависит: от концентраций примеси в p- и n-областях, от знака и
величины приложенного внешнего напряжения Uвн . При увеличении концентрации
примесей ширина p–n-перехода уменьшается и наоборот. С увеличением прямого
напряжения ширина p–n-перехода уменьшается. При увеличении обратного напряжения
ширина p–n-перехода увеличивается.
51
52.
Вольт-амперная характеристика р–n-переходаВольт-амперная характеристика p–n-перехода – это зависимость тока через p–n-переход
от величины приложенного к нему напряжения. Ее рассчитывают исходя из предположения, что электрическое поле вне обедненного слоя отсутствует, т.е. все напряжение
приложено к p–n-переходу. Общий ток через p–n-переход определяется суммой четырех
слагаемых:
(47)
где
-электронный ток дрейфа;
-дырочный ток дрейфа;
-электронный ток диффузии
- дырочный ток диффузии
– концентрация электронов, инжектированных в p-область;
– концентрация дырок, инжектированных в n-область
52
53.
При этом концентрации неосновных носителей np0 и pn0 зависят от концентрациипримесей Np и Nn следующим образом:
где ni , pi – собственные концентрации носителей зарядов (без примеси) электронов и
дырок соответственно.
Скорость диффузии носителей заряда Vn, p диф можно допустить близкой к их скорости
дрейфа Vn, p др в слабом электрическом поле при небольших отклонениях от условий
равновесия. В этом случае для условий равновесия выполняются следующие равенства:
Тогда выражение (47) можно записать в виде:
53
54.
(48)Обратный ток Io можно выразить следующим образом:
(49)
где Dn, p – коэффициент диффузии дырок или электронов; Ln, p – диффузионная длина
дырок или электронов. Так как параметры Dn, p , pn0 , np0 ,
очень
сильно зависят от температуры, обратный ток I0 иначе
называют тепловым током.
54
55.
Припрямом
напряжении
внешнего источника (Uвн > 0 )
экспоненциальный член
в выражении (48) приводит к
быстрому росту прямого тока,
который, как уже было отмечено,
в
основном
определяется
диффузионной составляющей.
При обратном напряжении
внешнего источника (Uвн < 0 )
экспоненциальный член много
меньше единицы и ток р–nперехода практически равен обратному току Io , определяемому, в основном,
дрейфовой составляющей. Вид этой зависимости представлен на рис. 1.19. Первый
квадрант соответствует участку прямой ветви вольт-амперной характеристики, а третий
квадрант – обратной ветви. При увеличении прямого напряжения ток р–n-перехода в
прямом направлении вначале возрастает относительно медленно, а затем начинается
55
56.
участок быстрого нарастания прямого тока, что приводит к дополнительному нагреваниюполупроводниковой структуры. Если количество выделяемого при этом тепла будет
превышать количество тепла, отводимого от полупроводникового кристалла либо
естественным путем, либо с помощью специальных устройств охлаждения, то могут
произойти в полупроводниковой структуре необратимые изменения вплоть до
разрушения кристаллической решетки. Поэтому прямой ток р–n-перехода необходимо
ограничивать на безопасном уровне, исключающем перегрев полупроводниковой
структуры. Для этого необходимо использовать ограничительное сопротивление
последовательно подключенное с p–n-переходом.
При увеличении обратного напряжения, приложенного к р–n-переходу, обратный ток
изменяется незначительно, так как дрейфовая составляющая тока, являющаяся
превалирующей при обратном включении, зависит в основном от температуры
кристалла, а увеличение обратного напряжения приводит лишь к увеличению скорости
дрейфа неосновных носителей без изменения их количества. Такое положение будет
сохраняться до величины обратного напряжения, при котором начинается интенсивный
рост обратного тока – так называемый пробой р–n-перехода.
Виды пробоев p–n-перехода
Возможны обратимые и необратимые пробои. Обратимый пробой – это пробой, после
которого p–n-переход сохраняет работоспособность. Необратимый пробой ведет к
разрушению структуры полупроводника.
56
57.
Существуют четыре типа пробоя: лавинный, туннельный, тепловой и поверхностный.Лавинный и туннельный пробои объединятся под названием – электрический пробой,
который является обратимым. К необратимым относят тепловой и поверхностный.
Лавинный пробой свойственен полупроводникам, со значительной толщиной р–nперехода, образованных слаболегированными полупроводниками. При этом ширина
обедненного слоя гораздо больше диффузионной длины носителей. Пробой происходит
под действием сильного электрического поля с напряженностью
В/см
В лавинном пробое основная роль принадлежит
неосновным носителям, образующимся под
действием тепла в р–n-переходе. Эти носители
испытывают со стороны электрического поля р–
n-перехода ускоряющее действие и начинают
ускоренно двигаться вдоль cиловых линий этого
поля. При определенной величине Напряженности неосновные носители заряда на длине
свободного пробега L (рис. 1.20) могут
разогнаться до такой скорости, что их
кинетической
энергии
может
оказаться
достаточно, чтобы при очередном соударении с
атомом полупроводника ионизировать его, т.е.
«выбить» один из его валентных электронов и
перебросить его в зону проводимости, образовав
57
58.
при этом пару «электрон – дырка». Образовавшиеся носители тоже начнут разгоняться вэлектрическом поле, сталкиваться с другими нейтральными атомами, и процесс, таким
образом, будет лавинообразно нарастать. При этом происходит резкий рост обратного
тока при практически неизменном обратном напряжении. Параметром, характеризующим
лавинный пробой, является коэффициент лавинного умножения M , определяемый как
количество актов лавинного умножения в области сильного электрического поля.
Величина обратного тока после лавинного умножения будет равна:
(50)
где I0 – начальный ток; U – приложенное напряжение; Uп – напряжение лавинного пробоя; n –
коэффициент, равный 3 для Ge , 5 для Si .
Туннельный пробой происходит в очень тонких р–
n-переходах, что возможно при очень высокой
концентрации примесей N = 1019 см-3 , когда ширина перехода становится малой (порядка 0,01 мкм) и
при небольших значениях обратного напряжения
(несколько вольт), когда возникает большой градиент электрического поля. Высокое значение напряженности электрического поля, воздействуя на
58
59.
атомы кристаллической решетки, повышает энергию валентных электронов и приводит ких туннельному «просачиванию» сквозь «тонкий» энергетический барьер (рис. 1.21) из
валентной зоны p-области в зону проводимости n-области. Причем «просачивание»
происходит без изменения энергии носителей заряда. Для туннельного пробоя также
характерен резкий рост обратного тока при практически неизменном обратном
напряжении. Если обратный ток при обоих видах электрического пробоя не превысит
максимально допустимого значения, при котором произойдет перегрев и разрушение
кристаллической структуры полупроводника, то они являются обратимыми и могут быть
воспроизведены многократно.
Тепловым называется пробой р–n-перехода, обусловленный ростом количества
носителей заряда при повышении температуры кристалла. С увеличением обратного
напряжения и тока возрастает тепловая мощность, выделяющаяся в р–n-переходе, и,
соответственно, температура кристаллической структуры. Под действием тепла
усиливаются колебания атомов кристалла и ослабевает связь валентных электронов с
ними, возрастает вероятность перехода их в зону проводимости и образования дополнительных пар носителей «электрон – дырка». Если электрическая мощность в р–n-переходе
превысит максимально допустимое значение, то процесс термогенерации лавинообразно
нарастает, в кристалле происходит необратимая перестройка структуры и р-n-переход
разрушается. Для предотвращения теплового пробоя необходимо выполнение условия
где P расс max – максимально допустимая мощность рассеяния p–n-перехода.
59
60.
Поверхностный пробой. Распределение напряженности электрического поля в р–nпереходе может существенно изменить заряды, имеющиеся на поверхности полупроводника. Поверхностный заряд может привести к увеличению или уменьшениютолщины перехода, в результате чего на поверхности перехода может наступить пробой
при напряженности поля, меньшей той, которая необходима для возникновения пробоя
в толще полупроводника. Это явление называют поверхностным пробоем. Большую роль
при возникновении поверхностного пробоя играют диэлектрические свойства среды,
граничащей с поверхностью полупроводника. Для снижения вероятности
поверхностного пробоя применяют специальные защитные покрытия с высокой
диэлектрической постоянной.
Ёмкость р–n-перехода
Изменение внешнего напряжения на p–n-переходе приводит к изменению ширины
обедненного слоя и, соответственно, накопленного в нем электрического заряда (это
также обусловлено изменением концентрации инжектированных носителей заряда
вблизи перехода). Исходя их этого p–n-переход ведет себя подобно конденсатору,
ёмкость которого определяется как отношение изменения накопленного в p–n-переходе
заряда к обусловившему это изменение приложенному внешнему напряжению.
Различают барьерную (или зарядную) и диффузионную ёмкость р-n-перехода.
Барьерная ёмкость соответствует обратновключенному p–n-переходу, который
рассматривается как обычный конденсатор, где пластинами являются границы
обедненного слоя, а сам обедненный слой служит несовершенным диэлектриком с
увеличенными диэлектрическими потерями:
60
61.
(51)δ – ширина обеднённого слоя.
Барьерная ёмкость возрастает при увеличении площади p–n-перехода и диэлектрической
проницаемости полупроводника и уменьшении ширины обедённого слоя. В зависимости
от площади перехода Сбар может быть от единиц до сотен пикофарад. Особенностью
барьерной ёмкости является то, что она является нелинейной ёмкостью. При возрастании
обратного напряжения ширина перехода увеличивается и ёмкость Сбар уменьшается.
Диффузионная ёмкость характеризует накопление подвижных носителей заряда
в n- и p-областях при прямом напряжении на переходе. Она практически существует только
при прямом напряжении, когда носители заряда диффундируют (инжектируют) в большом
количестве через пониженный потенциальный барьер и, не успев рекомбинировать,
накапливаются в n- и p-областях. Каждому значению прямого напряжения соответствуют
определенные значения двух разноименных зарядов Qдиф и Qдиф , накопленных в n- и
p-областях за счет диффузии носителей через переход. Ёмкость Сдиф представляет собой
отношение зарядов к разности потенциалов:
(52)
С увеличением Uпр прямой ток растет быстрее, чем напряжение, т.к. вольт-амперная
характеристика для прямого тока имеет нелинейный вид, поэтому Qдиф растет быстрее,
чем Uпр и Сдиф увеличивается.
61
62.
Диффузионная ёмкость значительно больше барьерной, но использовать ее не удается,т.к. она оказывается шунтированной малым прямым сопротивлением p–n-перехода.
Численные оценки величины диффузионной ёмкости показывают, что ее значение
доходит до нескольких единиц микрофарад. Таким образом, р–n-переход можно
использовать в качестве конденсатора переменной ёмкости, управляемого величиной и
знаком приложенного напряжения.
Контакт «металл – полупроводник»
В современных полупроводниковых приборах помимо контактов с p–n-переходом
применяются контакты «металл – полупроводник». Контакт «металл – полупроводник»
возникает в месте соприкосновения полупроводникового кристалла n- или р-типа
проводимости с металлами. Происходящие при этом процессы определяются
соотношением работ выхода электрона из металла Aм и из полупроводника Aп . Под
работой выхода электрона понимают энергию, необходимую для переноса электрона с
уровня Ферми на энергетический уровень свободного электрона. Чем меньше работа
выхода, тем больше электронов может выйти из данного тела. В результате диффузии
электронов и перераспределения зарядов нарушается электрическая нейтральность
прилегающих к границе раздела областей, возникает контактное электрическое поле и
контактная разность потенциалов
(53)
Переходный слой, в котором существует контактное электрическое поле при контакте
«металл – полупроводник», называется переходом Шоттки, по имени немецкого ученого
62
63.
В. Шоттки, который первый получил основные математические соотношения для электрических характеристик таких переходов. Контактное электрическое поле на переходе Шотткисосредоточено практически в полупроводнике, так как концентрация носителей заряда в
металле значительно больше концентрации носителей заряда в полупроводнике.
Перераспределение электронов в металле происходит в очень тонком слое, сравнимом с
межатомным расстоянием. В зависимости от типа электропроводности полупроводника и
соотношения работ выхода в кристалле может возникать обеднённый, инверсный или
обогащённый слой носителями электрических зарядов.
1. Aм < Ап , полупроводник n-типа (рис. 1.23, а). В
данном случае будет преобладать выход электронов
из металла ( M ) в полупроводник, поэтому в слое
полупроводника
около
границы
раздела
накапливаются основные носители (электроны), и
этот слой становится обогащенным, т.е. имеющим
повышенную концентрацию электронов.
Сопротивление этого слоя будет малым при любой полярности приложенного
напряжения, и, следовательно, такой переход не обладает выпрямляющим свойством.
Его иначе называют невыпрямляющим переходом.
63
64.
2. Aп < Ам , полупроводник p-типа (рис. 1.23, б). В этомслучае будет преобладать выход электронов из
полупроводника в металл, при этом в приграничном
слое также образуется область, обогащенная
основными носителями заряда (дырками), имеющая
малое сопротивление. Такой переход также не
обладает выпрямляющим свойством.
3. Aм>Ап , полупроводник n-типа (рис. 1.24,а). При таких условиях электроны будут переходить главным образом из полупроводника в металл и в приграничном слое полупроводника образуется область, обедненная основными носителями заряда и имеющая
большое сопротивление. полупроводника образуется область, обедненная основными
носителями заряда и имеющая большое сопротивление.
64
65.
Здесь создается сравнительно высокий потенциальный барьер, высота которого будетсущественно зависеть от полярности приложенного напряжения. Если Aп >> Ам , то
возможно образование инверсного слоя (p-типа). Такой контакт обладает
выпрямляющим свойством.
4. Aп > Ам , полупроводник p-типа (рис. 1.24, б). Контакт, образованный при таких
условиях обладает выпрямляющим свойством, как и предыдущий.
Отличительной особенностью контакта «металл – полупроводник» является то, что в
отличие от обычного p–n-перехода здесь высота потенциального барьера для
электронов и дырок разная. В результате такие контакты могут быть при определенных
условиях неинжектирующими, т.е. при протекании прямого тока через контакт в
полупроводниковую область не будут инжектироваться неосновные носители, что
очень важно для высокочастотных и импульсных полупроводниковых приборов.
Гетеропереходы
Гетеропереходом называют переходный слой с существующим там диффузионным
электрическим полем между двумя различными по химическому составу
полупроводниками, обладающие различной шириной запрещенной зоны. Для
получения гетеропереходов хорошего качества необходимо, чтобы у материалов,
образующих переход с высокой точностью, совпадали два параметра: температурный
коэффициент расширения и постоянная кристаллической решетки, что ограничивает
выбор материалов для гетеропереходов.
65
66.
В настоящее время наиболее исследованными являются пары: германий – арсенидгаллия ( Ge - GaAs ), арсенид галлия – фосфид индия ( GaAs - InP), арсенид галлия –
арсенид индия ( GaAs - InAs ), германий – кремний ( Ge - Si ). Каждый из полупроводников, образующих гетеропереход, может иметь различный тип электропроводности.
Поэтому для каждой пары полупроводников, в принципе, возможно осуществить
четыре типа гетероструктур: p1 - n2 ; n1-n ; n1 - p2 и p1 - p2 . При образовании гетеро2
перехода из-за разных работ выхода
электронов из разных полупроводников происходит перераспределение носителей заряда в
приконтактной области и выравнивание
уровней
Ферми
в
результате установления термодинамического равновесия (рис. 1.26).
Остальные энергетические уровни и
зоны
должны
соответственно
изогнуться, т.е. в гетеропереходе
возникают диффузионное поле и
контактная разность потенциалов.
При этом энергетический потолок
верхней свободной зоны должен
66
67.
быть непрерывным. Энергетический уровень потолка верхней свободной зоны являетсяэнергетическим уровнем потолка зоны проводимости, т.к. свободные энергетические
зоны перекрывают друг друга. Ширина энергетических зон различных полупроводников
различна. Поэтому на границе раздела двух полупроводников получается обычно разрыв
дна проводимости. Разрыв дна зоны проводимости определяется различием энергий
сродства к электрону двух контактирующих полупроводников (энергия сродства к
электрону – разница энергий потолка верхней свободной зоны и дна проводимости).
В результате разрывов дна зоны проводимости и потолка валентной зоны высота
потенциальных барьеров для электронов и дырок в гетеропереходе оказывается различной. Это является особенностью гетеропереходов, обусловливающей специфические
свойства гетеропереходов в отличие p–n-переходов, которые формируются в монокристалле одного полупроводника.
Если вблизи границы раздела двух полупроводников, образующих гетеропереход,
возникают обедненные основными носителями слои, то основная часть внешнего
напряжения, приложенного к структуре с гетеропереходом, будет падать на обедненных
слоях. Высота потенциального барьера для основных носителей заряда будет изменяться:
уменьшается при полярности внешнего напряжения, противоположной полярности
контактной разности потенциалов, и увеличивается при совпадении полярностей
внешнего напряжения и контактной разности потенциалов. Таким образом, гетеропереходы могут обладать выпрямляющим свойством.
67
68.
Из-за различия по высоте потенциальных барьеров для электронов (ПБЭ) и дырок (ПБД)прямой ток через гетеропереход связан в основном с движением носителей заряда
только одного знака. Поэтому гетеропереходы могут быть как инжектирующими
неосновные носители заряда (рис. 1.26, а), так и неинжектирущими (рис. 1.26, б).
Инжекция неосновных носителей заряда происходит всегда из широкозонного в узкозонный полупроводник. В гетеропереходах, образованных полупроводниками одного
типа электропроводности, выпрямление происходит без инжекции неосновных
носителей заряда.
68
69.
ПОЛУПРОВОДНИКОВЫЕ ДИОДЫПолупроводниковый диод – это полупроводниковый прибор с одним выпрямляющим
электрическим переходом и двумя выводами, в котором используется то или иное
свойство выпрямляющего электрического перехода.
В полупроводниковых диодах выпрямляющим электрическим переходом может быть
электронно-дырочный (p–n) переход, либо контакт «металл – полупроводник»,
обладающий вентильным свойством, либо гетеропереход.
В большинстве случаев полупроводниковые диоды с р-n-переходами делают
несимметричными, т.е. концентрация примесей в одной из областей значительно
больше, чем в другой. Поэтому количество неосновных носителей, инжектируемых из
сильно легированной (низкоомной) области, называемой эмиттером диода, в слабо
легированную (высокоомную) область, называемую базой диода, значительно больше,
чем в противоположном направлении. Классификация диодов производится по
различным признакам: по типу полупроводникового материала – кремниевые,
германиевые, из арсенида галлия; по назначению – выпрямительные, импульсные,
стабилитроны, варикапы и др.; по технологии изготовления электронно-дырочного
перехода – сплавные, диффузионные и др.; по типу электронно-дырочного перехода –
точечные и плоскостные. Основными классификационными признаками являются тип
электрического перехода и назначение диода.
69
70.
Выпрямительный диод – это полупроводниковый диод, предназначенный для преобразования переменного тока в постоянный. Выпрямительные диоды, помимо примененияв источниках питания для выпрямления переменного тока в постоянный, также используются в цепях управления и коммутации, в ограничительных и развязывающих цепях, в
схемах умножения напряжения и преобразователях постоянного напряжения, где не
предъявляются высокие требования к частотным и временным параметрам сигналов.
Выпрямительные диоды должны иметь как можно меньшую величину обратного тока,
что определяется концентрацией неосновных носителей заряда или, в конечном счете,
степенью очистки исходного полупроводникового материала.
70
71.
По вольт-амперной характеристикевыпрямительного диода можно определить
следующие основные параметры, влияю
щие на его работу:
1. Номинальный средний прямой ток
Iпр ср ном – среднее значение тока, проходящего через открытый диод и обеспечивающего допустимый его нагрев при номинальных условиях охлаждения.
2. Номинальное среднее прямое
напряжение U пр ср ном – среднее значение
прямого напряжения на диоде при протекании номинального среднего прямого тока
Этот параметр является очень важным для обеспечения параллельной работы нескольких диодов в одной электрической цепи.
3. Напряжение отсечки Uо , определяемое точкой пересечения линейного участка
прямой ветви вольт-амперной характеристики с осью напряжений.
4. Пробивное напряжение Uпроб – обратное напряжение на диоде, соответствующее
началу участка пробоя на вольт-амперной характеристике, когда она претерпевает
излом в сторону резкого увеличения обратного тока.
71
72.
5. Номинальное обратное напряжение Uобр ном – рабочее обратное напряжение надиоде; его значение для отечественных приборов составляет 0,5 Uпроб . Этот параметр
используется для обеспечения последовательного включения нескольких диодов в одну
электрическую цепь.
6. Номинальное значение обратного тока Iобр ном – величина обратного тока диода при
приложении к нему номинального обратного напряжения.
7. Статическое сопротивление диода:
(54)
где Iпр – величина прямого тока диода; Uпр – падение напряжения на диоде при
протекании тока Iпр . Статическое сопротивление диода представляет собой его
сопротивление постоянному току.
8. Динамическое (дифференциальное) сопротивление Rдин :
(55)
Где ΔIпр – приращение прямого тока диода; ΔUпр – приращение падения напряжения на
диоде при изменении его прямого тока на ΔIпр .
9. Скорость нарастания прямого тока dI/dt
72
73.
Диоды ШотткиПотенциальный барьер, полученный на основе контакта «металл – полупроводник»,
часто называют барьером Шоттки, а диоды, использующие такой потенциальный барьер,
– диодами Шоттки. Как уже было рассмотрено выше, в контакте «металл –
полупроводник» не происходит накопления неосновных носителей в базе из-за
отсутствия инжекции неосновных носителей, вследствие чего значительно уменьшается
время восстановления обратного сопротивления, что в сочетании с малой величиной
барьерной ёмкости создает идеальные условия для использования таких диодов в
импульсных и высокочастотных устройствах.
Диоды Шоттки изготавливаются обычно на основе кремния Si или арсенида галлия GaAs ,
реже на основе германия Ge . Выбор металла для контакта с полупроводником
определяет многие параметры диода. В первую очередь важна величина контактной
разности потенциалов, образующейся на границе контакта. Чаще всего используются
металлы Ag , Au , Pt , Pd , W , которые наносятся на полупроводник и дают величину
потенциального барьера 0,2 - 0,9 эВ. Диоды Шоттки на электрических принципиальных
схемах изображают условным обозначением (рис. 2.16),
которое используется только тогда, когда необходимо
сделать акцент на том, что в схеме используется именно
диод Шоттки.
73
74.
СтабилитроныСтабилитронами называют полупроводниковые диоды, использующие особенность
обратной ветви вольт-амперной характеристики на участке пробоя изменяться в
широком диапазоне изменения токов при сравнительно небольшом отклонении
напряжения. Это свойство широко используется при создании специальных устройств –
стабилизаторов напряжения. Напряжение пробоя стабилитрона зависит от ширины р–пперехода, которая определяется удельным сопротивлением материала полупроводника.
Поэтому существует определенная зависимость пробивного напряжения (т.е.
напряжения стабилизации) от концентрации примесей.
Низковольтные стабилитроны выполняют на основе сильно легированного кремния.
Ширина р–п-перехода в этом случае получается очень маленькой, а напряженность
электрического поля потенциального барьера – очень большой, что создает условия для
возникновения туннельного пробоя. При большой ширине р–п-перехода пробой носит
лавинный характер. При напряжении стабилизации Uст от 3 до 6 В в p–n-переходах
наблюдается практически туннельный пробой. В диапазоне от 6 до 8 В имеют место
процессы как туннельного, так и лавинного пробоя, а в пределах 8-200 В – только
лавинного. Вольт-амперная характеристика стабилитрона представлена на рис. 2.18, б.
Рабочий ток стабилитрона (его обратный ток) не должен превышать максимально
допустимое значение I ст max во избежание перегрева полупроводниковой структуры и
выхода его из строя.
74
75.
7576.
Фотодиоды.На рис. 2.12 приведено схематичное изображение фотодиода и его обозначение. Свет
падает через полупрозрачный контакт на p-область полупроводника. При освещении
полупроводника происходит генерация электронов и дырок за счет энергии световых
квантов. Образовавшиеся электроны и дырки диффундируют к p–n-переходу.
Ширина области диода, на которую
падает свет на рис. 2.12 — это pобласть), должна быть меньше диффузионной длины, чтобы электроны
и дырки могли дойти до p–n-перехода, не успев прорекомбинировать.
76
77.
Применение полупроводниковых диодов для выпрямления токаОднофазная однополупериодная схема выпрямления
Простейшей схемой выпрямителя является однофазная однополупериодная схема
(рис. 2.23, а). Трансформатор Т играет двойную роль: он служит для подачи на вход
выпрямителя ЭДС
, соответствующей заданной величине
выпрямленного напряжения Ed , и обеспечивает гальваническую развязку цепи
нагрузки и питающей сети. Параметры, относящиеся к цепи постоянного тока, то есть
к выходной цепи выпрямителя, принято обозначать с индексом d (от английского
слова direct – прямой): Rd –
сопротивление нагрузки; ud –
мгновенное значение выпрямленного напряжения; id –
мгновенное значение выпрямленного тока. Постоянная
составляющая выпрямленного
напряжения:
(56)
77
78.
Двухполупериодная схема выпрямления со средней точкойЭта схема представляет собой два однополупериодных выпрямителя, работающих
на общую нагрузку Rd и питающихся от находящихся в противофазе ЭДС (рис. 2.24,
а) e2a и e2b . Для создания этих ЭДС в схеме является обязательным наличие
трансформатора T с двумя полуобмотками на вторичной стороне, имеющими
среднюю точку. На рис. 2.24, б, в, г, д представлены временные диаграммы для
двухполупериодной схемы выпрямителя со средней точкой.
78
79.
Однофазная мостовая схемаСхема представляет собой мост из вентилей VD1 VD4 (рис. 2. 25, а), в одну диагональ
которого включена нагрузка, а в другую – переменное напряжение e2 . В
положительном полупериоде открыты вентили VD1 VD3 , в отрицательном – VD2 - VD4 .
Ток в нагрузке протекает в одном и том же направлении в течение обоих полупериодов,
поэтому эта схема, так же как и предыдущая, относится к двухполупериодным схемам
выпрямления.
Схема представляет собой
мост из вентилей VD1-VD4
(рис. 2. 25, а), в одну диагональ которого включена
нагрузка, а в другую – переменное напряжение e2 . В
положительном полупериоде открыты вентили VD1VD3 , в отрицательном – VD2
VD4 . Ток в нагрузке
протекает в одном и том же
направлении в течение
обоих полупериодов,
поэтому эта схема, так же
как и предыдущая, относится к двухполупериодным схемам выпрямления.
79
80.
как и предыдущая, относится к двухполупериодным схемам выпрямления.80
























































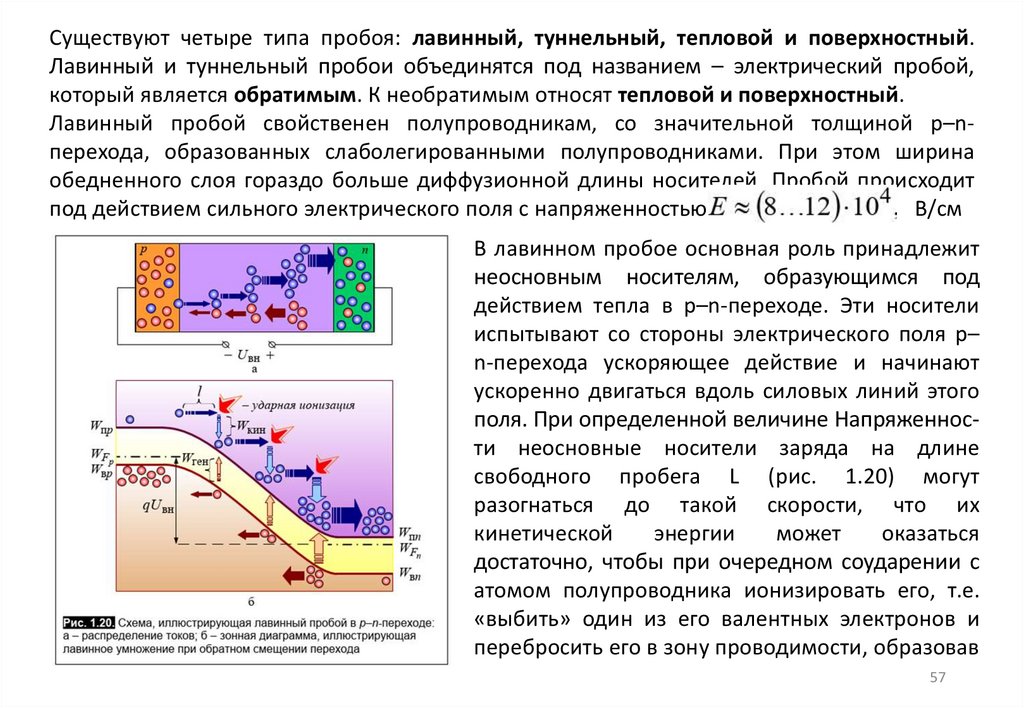








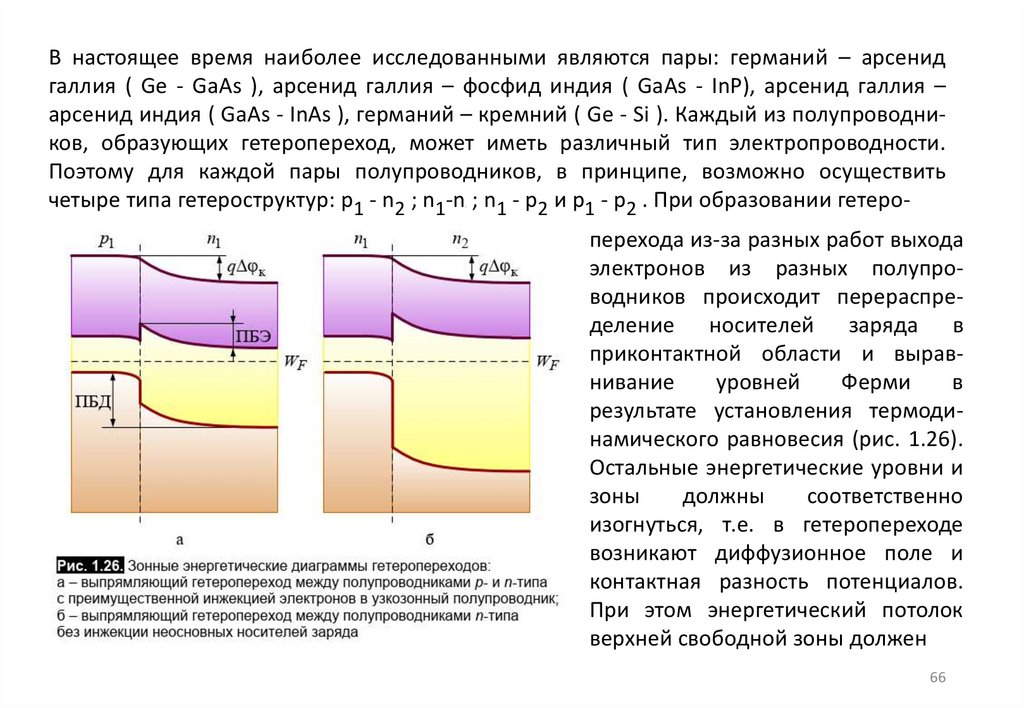














 Электроника
Электроника








