Похожие презентации:
Способы и оборудование для формирования изображений в микро- и нанолитографии
1.
Лекция 4Способы и оборудование для
формирования изображений
в микро- и нанолитографии
Преподаватель: д.т.н. ,
профессор, Сырчин В.К.
2.
СОДЕРЖАНИЕ.
.
1.
Оборудование нанесения и термообработки резистивных пленок
.
.
2.
Оборудование для совмещения и
экспонирования
.
.
3.
Оборудование для проявления
резистивной маски
.
.
2
3.
Общие сведенияВ масочной технологии используются два
типа масок:
Свободная
маска - тонкий, изготовляемый и
существующий отдельно от подложки экран с
отверстиями,
конфигурация
и
расположение
которых соответствуют заданной конфигурации и
расположению элементов микросхем
Контактная маска - рельефное покрытие из пленки
резистивного материала, воспроизводящее заданные
элементы рисунка и обеспечивающее защиту
заданных участков подложки от последующего
воздействия
3
4.
Требования к резистивной пленкеК операции нанесения и к самой пленке
предъявляются следующие требования:
возможность нанесения пленки контролируемой
толщины
широкой диапазон толщин наносимых пленок
равномерность толщины пленки по площади
подложки;
отсутствие проколов и трещин в пленке
хорошая адгезия пленки резиста к подложке
воспроизводимость результатов
4
5.
Методы нанесения пленок резистовокунание
распыление
центрифугирование
нанесение роликом
сеточно-графический способ
(трафаретная печать)
5
6.
Метод окунанияПрименяется для толстых покрытий ( > 2 мкм) в
производствах, где допускается разнотолщинность
пленки, обусловленная стеканием раствора резиста во
время извлечения из него покрываемой подложки.
экономичность вследствие малых
потерь резиста
относительная простота
оборудования
возможность полной механизации
и автоматизации
6
7.
Метод распыленияДостоинства:
широкий диапазон толщины
покрытия (от 0,5 до 20 мкм) ;
высокая производительность и
возможность автоматизации;
нанесение на подложки на
большие площади различной
формы и веса;
Недостатки:
сложное оборудование;
большие энергетиче-
ские затраты;
экологическая
опасность;
нетехнологичность
хорошая адгезия к подложке
7
8.
Метод центрифугированияНаиболее широко применяется в фотолитографии при
массовом производстве полупроводниковых приборов
и интегральных схем
hпл=к ν/ω
к – коэффициент, учитывающий
концентрацию резиста











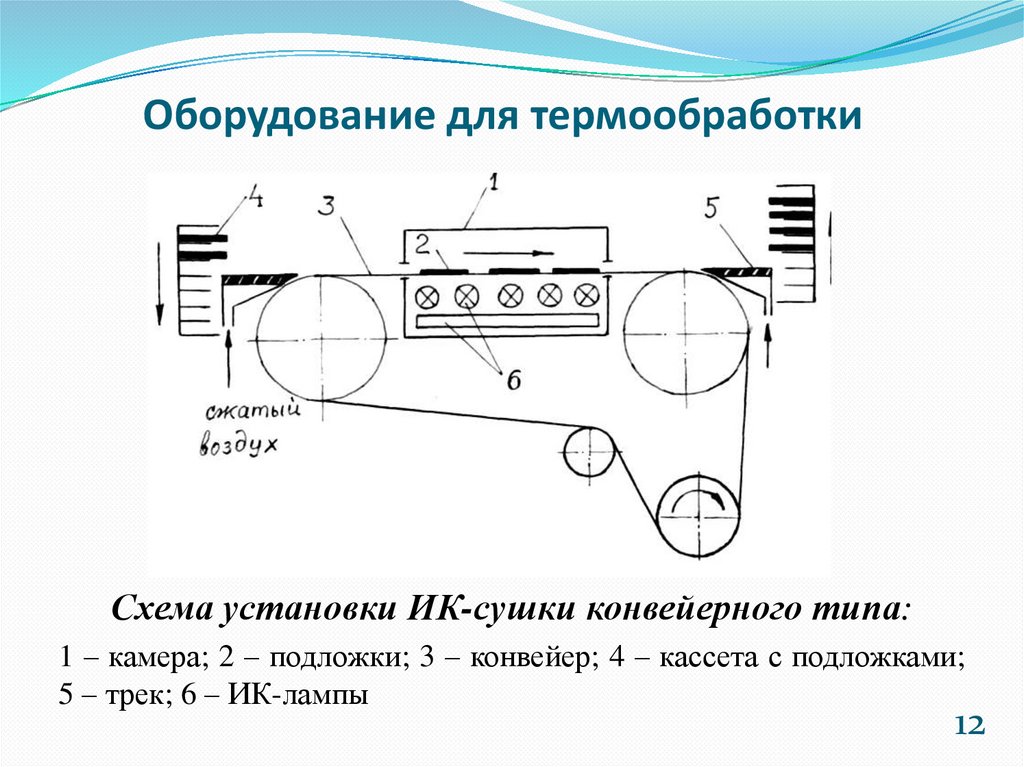











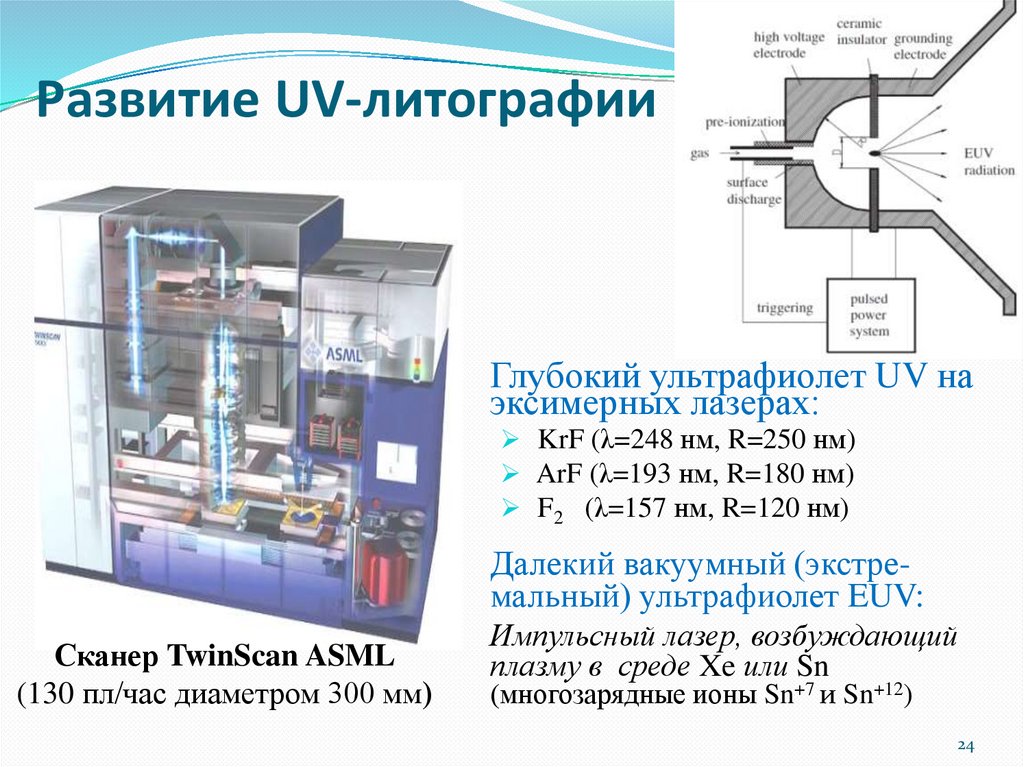





 Физика
Физика








