Похожие презентации:
Быстродействующие pin-фотодиоды на основе гетероструктур InGaAsP/InP для регистрации излучения в спектральном диапазоне
1.
Федеральное государственное бюджетное образовательноеучреждение высшего образования
Национальный исследовательский университет
«МЭИ»
14.04.01 «Ядерная энергетика и теплофизика»
Кафедра низких температур
ВЫПУСКНАЯ КВАЛИФИКАЦИОННАЯ РАБОТА
(магистерская диссертация)
«Быстродействующие pin-фотодиоды на основе гетероструктур InGaAsP/InP для
регистрации излучения в спектральном диапазоне 1,0–1,6 мкм»
Группа: ТФ-14м-19
Студент: Колкий А.Н
Научный руководитель: к.т.н. Михайлова И.А
Москва, 2021
2.
ЦЕЛЬ И ЗАДАЧИ ИССЛЕДОВАНИЯЦель магистерской квалификационной работы – разработка промышленных образцов
pin-ФД на основе гетероструктур InGaAsP/InP, работающих в спектральном диапазоне
1,0–1,6 мкм, и исследование фотоэлектрических характеристик таких ФД, включая их
стабильность при воздействии внешних факторов.
Для исполнения основной цели поставлены следующие задачи:
1. Проектирование оптимальной структуры и топологии фоточувствительных элементов
двух типов pin-ФД (низкочастотные,высокочастотные) на спектральный диапазон 1,0–1,6
мкм.
2. Определение параметров гетероструктур InGaAsP/InP на всех этапах производства pin-
ФД.
3. Разработка планарной технологии изготовления pin-ФД на основе гетероструктур
InGaAsP/InP и создание образцов pin-ФД.
4. Проведение исследований разработанных pin-ФД в диапазоне температур от мунус 60 до
плюс 60оС и при воздействии внешних дестабилизирующих факторов
2
3.
ФИЗИЧЕСКИЕ СВОЙСТВА И ТЕХНОЛОГИИ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP
Требования к pin-фотодиодам и пути их реализации
Параметры шумов
• тепловой шум нагрузочного
сопротивления
• дробовой шум
• тепловой шум
Вклад составляющих шумового тока в общий ток ФПУ при
различных скоростях передачи ( ir2 – тепловой шум нагрузочного
сопротивления, iдр2 – дробовый шум, iпт 2 – тепловой шум)
Упрощенная электрическая и параллельная эквивалентная схемы
входной цепи высокоомного усилителя и фотодиода
3
4.
ФИЗИЧЕСКИЕ СВОЙСТВА И ТЕХНОЛОГИИ PIN-ФОТОДИОДОВ НАОСНОВЕ ГЕТЕРОСТРУКТУР InGaAsP/InP
Требования к pin-фотодиодам и пути их реализации
Параметры шумов
Для низкочастотных схем
Зависимость темнового тока фотодиода от скорости передачи
(● – усилитель с полевым транзистором на входе,
▲– усилитель с биполярным транзистором на входе)
Для высокочастотных схем
Зависимость ёмкости фотодиода от скорости передачи
4
5.
ФИЗИЧЕСКИЕ СВОЙСТВА И ТЕХНОЛОГИИ PIN-ФОТОДИОДОВ НАОСНОВЕ ГЕТЕРОСТРУКТУР InGaAsP/InP
Требования к pin-фотодиодам и пути их реализации
Быстродействие pin-фотодиодов
Для обеспечения высокой скорости передачи информации pin-ФД должен обладать широкой
полосой пропускания
Ограничение скорости фотоответа pin-ФД:
постоянной времени RC-цепи;
переходным временем, которое определяется дрейфом фотоносителей, генерированных в ОПЗ
структуры;
задержкой, связанной с диффузией фотоносителей, генерированных в квазинейтральных p- и nобластях pin-структуры
5
6.
ФИЗИЧЕСКИЕ СВОЙСТВА И ТЕХНОЛОГИИ PIN-ФОТОДИОДОВ НАОСНОВЕ ГЕТЕРОСТРУКТУР InGaAsP/InP
Требования к pin-фотодиодам и пути их реализации
Квантовая эффективность фотопреобразования
Для реализации высокоэффективного быстродействующего малошумящего pin-ФД, работающего в
спектральном диапазоне 1,0–1,6 мкм, необходимо:
использовать гетероструктуры на основе полупроводников с прямыми оптическими переходами в
поглощающем (активном) слое;
минимизировать уровень фоновых примесей в i-слое гетероструктуры;
повышать степень легирования широкозонных p- и n-слоев гетероструктуры;
оптимизировать ширину ОПЗ (а, следовательно, и ширину i-слоя структуры);
минимизировать размер фоточувствительной площадки (площадь p-n-перехода);
использовать эффективные пассивирующие и просветляющие покрытия
6
7.
ФИЗИЧЕСКИЕ СВОЙСТВА И ТЕХНОЛОГИИ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP
Выбор системы прямозонных соединений для pin-ФД
Основным материалом для pin-ФД, работающих в спектральном диапазоне 1,0–1,6 мкм, является
тройное соединение In0,53Ga0,47As (Eg=0,73 эВ) с длинноволновой границей поглощения гр=1,65 мкм.
Для более узкого диапазона 1,2–1,4 мкм может быть использовано четверное соединение
In0,7Ga0,3As0,6P0,4 (Eg=0,9 эВ, гр=1,4 мкм).
Параметр
In0,53Ga0,47As
In0,7Ga0,3As0,6P0,4
Ширина запрещенной зоны при Т=20оС, Eg
[эВ]
0,73
0,9
Собственная концентрация носителей при
Т=20оС, ni [см–3]
5,4·1011
2,2·1010
Подвижность электронов, n[см2/В·с]
1·104
4,7·103
Коэффициент диффузии электронов, Dn
[см2/с]
259
122
Коэффициент диффузии дырок, Dp [см2/с]
13
6,1
Время жизни неосновных носителей, d [пс]
200
200
Параметры материалов гетероструктур
7
8.
ФИЗИЧЕСКИЕ СВОЙСТВА И ТЕХНОЛОГИИ PIN-ФОТОДИОДОВ НАОСНОВЕ ГЕТЕРОСТРУКТУР InGaAsP/InP
Характеристики pin-ФД на основе гетероструктур InXGaXAs1-YPY/InP
Для изготовления рin-ФД используют два варианта исходных гетероструктур
Лучшие образцы pin-ФД на основе гетероструктур
In1-XGaXAs1-YPY/InP характеризуются следующими
параметрами:
токовая чувствительность ~ 0,7–0,9 А/Вт;
плотность темнового тока ~ (2–3)·10–7 А/см2;
удельная ёмкость ~ 1·109 Ф/см2;
быстродействие ~ 0,1–0,3 нс
Основные варианты исходных гетероструктур InGaAsP/InP,
используемых для изготовления pin-ФД:
(а)- структура типа 1; (б)- структура типа 2
8
9.
ОПТИМИЗАЦИЯ СТРУКТУРЫ PIN-ФОТОДИОДА. РАСЧЁТНАЯ ЧАСТЬОптимальная структура pin-фотодиода
pin-ФД, предназначенный для работы при Uр<10В, должен характеризоваться следующими параметрами:
темновой ток (для низкочастотных систем) – не более 10нА,
ёмкость (для высокочастотных систем) – не более 0,2 пФ,
инерционность фотоответа – не более 0,1–1 нс,
квантовая эффективность фотопреобразования близка к 100%
• Основной полупроводниковый материал для pin-ФД в спектральном диапазоне 1,0–1,6 мкм –
прямозонное соединение In0,53Ga0,47As (Eg=0,73 эВ, гр=1,65 мкм). Для низкочастотных приборов в
диапазоне 1,2–1,4 мкм целесообразно применять более широкозонное соединение In0,7Ga0,3As0,6P0,4
(Eg=0,9 эВ, гр=1,4 мкм).
• Для реализации теоретических значений объемного темнового тока и квантовой эффективности
фотопреобразования необходимо использовать пассивирующие и просветляющие покрытия.
• pin-ФД должен характеризоваться долговечностью и стабильностью основных параметров
9
10.
ОПТИМИЗАЦИЯ СТРУКТУРЫ PIN-ФОТОДИОДА. РАСЧЁТНАЯ ЧАСТЬРасчет оптимальной структуры pin-ФД
Низкочастотный pin-ФД:
Высокочастотный pin-ФД
• рабочее напряжение не более 10 В;
• рабочее напряжение не более 10 В;
• токовая чувствительность, не менее 0,5 А/Вт;
• токовая чувствительность, не менее 0,6 А/Вт;
• темновой ток, не более 20 нА;
• темновой ток, не более 10 нА;
• ёмкость, не более 5 пФ;
• время нарастания (спада) импульса фототока
(по уровню 0,1–0,9) не более 2 нс.
• ёмкость не более 0,2 пФ,;
• время нарастания (спада) импульса фототока (по
уровню 0,1–0,9) не более 0,1нс.
• диапазон рабочих температур разрабатываемого
ФД: от минус 60 до 60оС.
• диапазон рабочих температур разрабатываемого
ФД: от минус 60 до 60оС.
Расчёты представлены в Магистерской ВКР в главе 2 стр.31–43
10
11.
ОПТИМИЗАЦИЯ СТРУКТУРЫ PIN-ФОТОДИОДА. РАСЧЁТНАЯ ЧАСТЬРасчет оптимальной структуры pin-ФД
Параметр
Значение
Параметр
Толщина активного слоя, hn1[мкм]
3–4
Толщина p-области активного
слоя, hp1[мкм]
0,5–1
Ширина ОПЗ, Wопз [мкм]
2,5–3
Концентрация фоновых примесей
в активном слое, Nn1 [см-3]
1·1015
Толщина слоя «окна», hn2 [мкм]
2–2,5
Площадь p-n-перехода, Ap-n
[см 2]
Ёмкость p-n-перехода, Сp-n
[пФ]
Диффузионный ток
насыщения для мезаструктуры, Iдиф.нас.меза [пА]
Диффузионный ток
насыщения для планарной
структуры, Iдиф.нас.план. [пА]
Ток насыщения генерациирекомбинации, Iг-р.нас. [нА]
Концентрация фоновых примесей
в слое «окна», Nn2 [см-3]
Токовая чувствительность на
длине волны 1 = 1,3 мкм, S =1,3
[А/Вт]
Токовая чувствительность на
длине волны 2 = 1,55 мкм, S =1,55
[А/Вт]
1·1015
1,04
Значение
56·10-6
Быстродействие, [пс]
0,3
30
10
0,4
Оптимально спроектированная
структура типа 2
50
1,12
Расчётные параметры оптимальной структуры
Расчёты представлены в Магистерской ВКР в главе 2 стр.31–43
11
12.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Разработка технологии формирования диффузионного p-n-перехода
Исходный материал образцов – пластины InP и
гетероструктуры In0,53Ga0,47As/InP, In0,9Ga0,1As0,2P0,8/InP,
In0,7Ga0,3As0,6P0,4/InP.
Материал диффузанта – монокристалы CdP2, CdP4, Cd3P2
Начальная технологическая операция – химическая обработка
исходной поверхности пластин гетероструктур включает:
• обезжиривание в смеси изопропилового спирта с
четырёххлористым углеродом в УЗ;
• тонкую полировку (поверхностный съем не более 80 нм) ;
• финишную отмывку от растворителей деионизованной
водой.
Зависимость глубины залегания p-n-перехода от
времени при различной температуре диффузии
12
13.
Разработка технологии формирования диффузионного p-n-переходаОбъем ампулы
[cм3]
Cостав
диффузанта
Количество
диффузанта
[мг]
Температура
диффузии [оС]
Время
[ мин.]
Глубина p-n
перехода
[ мкм ]
10
Cd3P2
20
680
45
16
Коэффициент
диффузии
х10 –11
[ см 2/с ]
9,5
10
Cd3P2
20
680
30
13
9,5
10
Cd3P2
20
620
30
3,5
6,7
10
Cd3P2
20
620
20
2,8
6,5
10
Cd3P2 +P4
20 + 5
680
30
10
5,6
10
Cd3P2+ P4
20 + 5
620
30
2,4
3,2
10
CdP2
20
620
30
3,5
6,7
10
CdP2
20
620
20
2,5
5,2
10
CdP4
27
680
20
3,0
7,5
65
Cd3P2
130
520
150
3,2
1,0
65
Cd3P2
130
520
75
3,8
2,0
Примечание
p-n-переход
планарный
p-n-переход
планарный
p-n-переход
планарный
p-n-переход
планарный
p-n-переход не
планарный
p-n-переход не
планарный
p-n-переход не
планарный
p-n-переход не
планарный
p-n-переход не
планарный
p-n-переход не
планарный
p-n-переход не
планарный
Результаты экспериментов с использованием в качестве диффузанта монокристаллов фосфида кадмия различного состава
13
14.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Разработка технологии формирования диффузионного p-n-перехода
Результаты диффузии кадмия в соединениях InGaAsP
14
15.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Отработка технологических режимов пассивации поверхности
(а)
(б)
Схемы реакторов для плазмохимической обработки: (а)- цилиндрический реактор,
(б)- планарный реактор
15
16.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Отработка технологических режимов пассивации поверхности
Зависимость темновых токов p-n-переходов от режимов ПХО в атмосфере CF4
16
17.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Отработка технологических режимов пассивации поверхности
Гистограммы темновых токов p-n-переходов на одной пластине:
(а)- планарный реактор, (б)- цилиндрический реактор
17
18.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Разработка технологии защиты поверхности
Диэлектрическая пленка, применяемая при изготовлении pin-ФД, должна обеспечивать полную изоляцию
поверхности p-n-перехода от внешней среды, а также просветление в рабочем диапазоне длин волн.
• толщина пленки должна составлять 0,17‒0,2 мкм, а коэффициент преломления – 2 0,1;
• плотность микропор пленки не должна превышать 100 см-2;
• электрическая прочность пленки должна быть не менее 106 В/см.
В качестве исходных реагентов для синтеза пленки Si3N4 использовали смесь моносилана с аргоном
(4% SiH4 + 96%Ar) и азот.
Реакция взаимодействия газов активвировалась разрядом частотой 5,28 МГц и мощностью более
200 Вт. Температура процесса менее 200оС; давление в камере 0,45 Торр
18
19.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Разработка технологии защиты поверхности
Зависимость параметров плёнки Si3N4 и темновых токов p-n-переходов от режимов предобработки поверхности
19
20.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Разработка технологии защиты поверхности
(а)
Зависимость коэффициента преломления плёнки SixNy
от отношения Si/N
(б)
(в)
Плёнка Si3N4 в качестве защитного покрытия:
(а)- Si3N4 на поверхности гетероструктур,
(б)-ФЛГ по Si3N4 ,
(в)- вскрытые окна под диффузию Cd (ФР не снят)
20
21.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Отработка технологии изготовления омических контактов и контактных систем
Основные требования к металлургическим свойствам контакта, от которых зависит надежность ФД:
малая глубина проникновения металла в полупроводник;
хорошая адгезия к поверхности полупроводника;
совместимость с полупроводником и материалом внешних токоотводов;
пригодность к стандартным фотолитографическим обработкам.
Для соединений AIIIBV лучшие результаты достигнуты при использовании омических контактов на основе
двухслойных систем Cr-Au и Ti-Au, где Cr (Ti) – контактный слой, Au – проводящий слой.
Толщина пленки Ti, во избежание разрывов, должна составлять не менее 50‒60 нм.
Толщина пленки Au ограничивалась возможностями фотолитографии и составляла 200‒250 нм
21
22.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НАОСНОВЕ ГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Отработка технологии изготовления омических контактов и контактных систем
Влияние термообработки на вид вольт-амперных
характеристик контактов Cr-Au и Ti-Au:
1 – ВАХ Ti-Au; 2 – ВАХ Cr-Au
Зависимость удельного сопротивления контакта от
режима отжига
22
23.
РАЗРАБОТКА ТЕХНОЛОГИИ ИЗГОТОВЛЕНИЯ PIN-ФОТОДИОДОВ НА ОСНОВЕГЕТЕРОСТРУКТУР InGaAsP/InP. ЭКСПЕРИМЕНТАЛЬНАЯ ЧАСТЬ
Технологический цикл изготовления pin-ФД на основе гетероструктур InGaAsP/InP в планарном варианте
Схема процесса изготовления pin-ФД на основе InGaAsP/InP по планарной технологии и пример готового изделия
23
24.
ЗАКЛЮЧИТЕЛЬНАЯ ЧАСТЬДостигнута цель квалификационной работы по созданию промышленных образцов pin-ФД на
основе гетероструктур InGaAs/InP работающих в спектральном диапазоне 1,0–1,6 мкм.
Выполнены следующие задачи:
1. Проведён расчёт оптимальной структуры и топологии фоточувствительных элементов двух типов pin-ФД.
2. Разработан способ получения диффузионного p-n-перехода в гетероструктурах InGaAsP/InP с
использованием в качестве диффузанта монокристаллов Cd3P2.
3. Получен способ выращивания на поверхности соединений InGaAsP/InP пленки Si3N4, наносимой
низкотемпературным (Т<200оС) плазмохимическим методом. Указанные параметры достигнуты в результате
обработки поверхности соединений непосредственно перед осаждением пленки в плазме азота.
4. Отработан способ изготовления контактной системы на основе Ti-Au-Au с удельным сопротивлением
к~5·10–6 Ом·см, обеспечивающий надежное присоединение внешних выводов при размерах контактной
площадки 20 х 30 мкм.
5. На базе отработанных процессов создана промышленная технология изготовления pin-ФД на основе
гетероструктур InGaAsP/InP в планарном варианте
24
25.
КРАТКИЙ БИБЛИОГРАФИЧЕСКИЙ СПИСОК1. Тришенков М.А. Фотоприемные устройства и ПЗС. Обнаружение слабых оптических сигналов. – М.: Радио и связь, 1992. –
400с.
2. Игумнов В.Н. Физические основы микроэлектроники: учебное пособие / В.Н Игумнов. – М.-Берлин: Директ-Медиа,2014. –
358стр.
3. Дмитриев А.С. Физико-химия наноструктур / А. С. Дмитриев, И. А. Михайлова. — М.: Издательство МЭИ, 2013. — 240 с.
4. Люев В.К., Кармоков А.М. Коэффициент диффузии и энергии активации диффузии легирующих элементов в поверхности
монокристалла кремния // Современные наукоемкие технологии. – 2016. – № 5-2. – С. 262-265.
5. Основы конструирования и технологии производства радиоэлектронных средств. Ионно-плазменные технологии: учебник /
В.И. Иванов [и др.]; под ред. А.С.Сигова. – М.: Издательство Юрайт, 2019. – 270с.
6. Brauer, G. Magnetron sputtering – Milestones of 30 years / G. Brauer, B. Szyszka, M. Vergohl, R. Bandorf // Vacuum. – 2010. – Vol.
84. – P. 1354–1359.
7. Колкий А.Н., Ким А.С.Многоплощадочный кремниевый p-i-n-фоточувствительный элемент с двухслойной диэлектрической
пленой.// Тезисы докладов X Научно-практическая конференция молодых учёных и специалистов «Фотосенсорика: новые
материалы, технологии, приборы, производство».‒М.:НПО «Орион». 17 марта 2021.
8. А.Н.Колкий, И.А.Михайлова. Контролируемое травление плёнок SiO2 в плазме фреона. РАДИОЭЛЕКТРОНИКА,
ЭЛЕКТРОТЕХНИКА И ЭНЕРГЕТИКА: Двадцать седьмая Междунар. науч.-техн. конф. студентов и аспирантов (11–12 марта
2021 г., Москва): Тез. докл. — М.: ООО «Центр полиграфических услуг „Радуга“», 2021. — 1248 с.
25










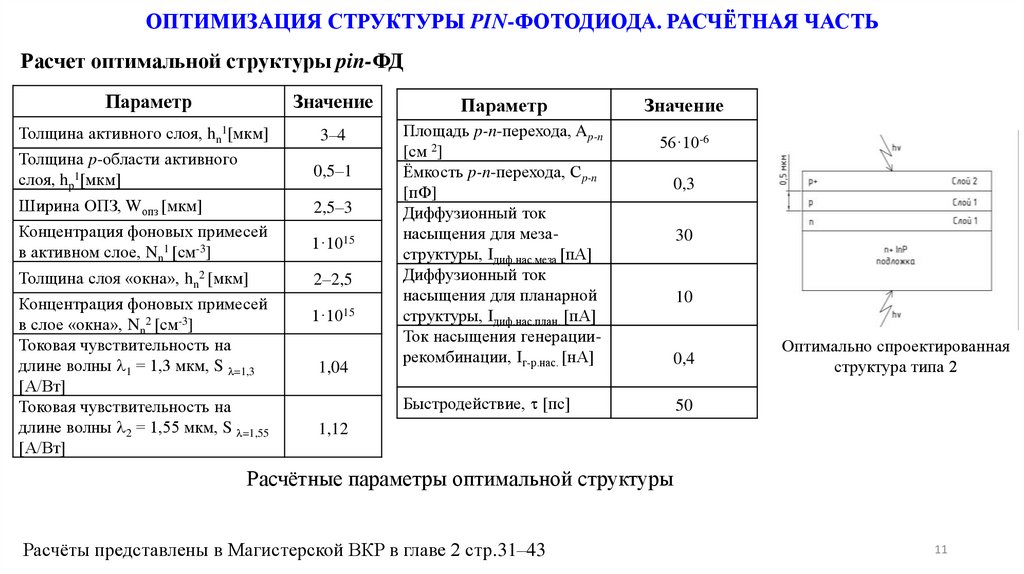



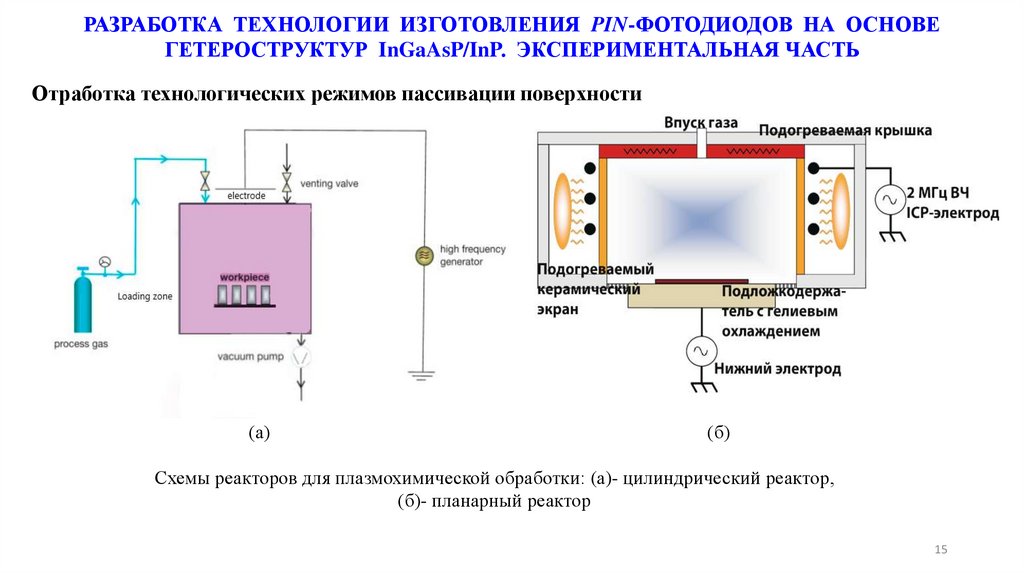







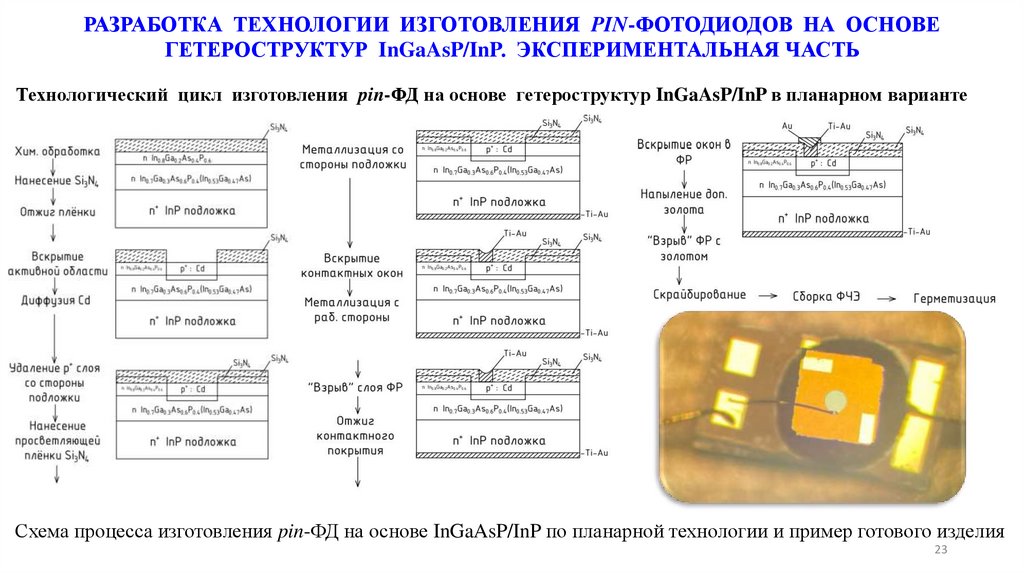



 Интернет
Интернет








