Похожие презентации:
Электронная микроскопия
1.
Электронная микроскопия.Длинна волны Де Бройля
λ=h/p
Значение импульса, для скоростей близких к скорости света
p=meV(1-V2/C2)-0,5
при V<<C получим привычную запись p=m0V
Запишем длину волны Де Бройля для скоростей близких к скорости света
λ= hC(2me C2Еe) -0,5
Для электрона, ускоренного до энергии Еe=100 эВ и meC2≈0,51 МэВ получим λе=0,12нм
Излучение
Видимый свет
Мягкое рентгеновское
Жесткое рентгеновское
Проникающее
λ
700-400нм
80-0,01нм
0,01-10-5нм
Менее 10-5нм
Длина волны электрона, ускоренного в электрических полях (10-300 кВ), составляет 100 - 1 пм
2. Измерение радиуса атома опытным путём
В таблице приведены измеренные опытным путём ковалентные радиусы для элементов, опубликованныеамериканским химиком Д.Слейтером в 1964 году. Значения приведены в пикометрах (пм или 1 × 10-12 м) с точностью
около 5 пм. Оттенки цвета ячеек варьируются от красного до жёлтого по мере увеличения радиуса; серый цвет —
отсутствие данных.
3. Вычисленные радиусы атомов
В таблице приведены значения радиусов атомов, рассчитанные по теоретическим моделям, опубликованныеитальянским химиком Энрико Клементи и другими в 1967 году. Значения даны в пикометрах (пм).
4.
5.
Физические основы электронно-лучевых оптических приборов были заложены X. Бушем в 1926 г., разработавшимпервую электромагнитную линзу и исследовавшим фокусирующие свойства осесимметричных полей.
Буш Ханс (Hans Busch)( 21.11.1884 - 16.ХII.1973) - немецкий физик, основоположник электронной оптики. В 1911
получил степень доктора философии в Геттингенском ун-те, где в 1920-21 был приват-доцентом, в 1922-27- профессор
Йенского ун-та, в 1927 — 30 — технический директор одного из заводов Всегерманского электротехнического об-ва в
Берлине, в 1930 — 51 — профессор Высшей технической школы в Дармштадте и с 1934 — также директор Научно-
6.
В 1928 немецкими учеными М. Кноллем и Э. Руской был начат проект по созданию первого просвечивающегоэлектронного микроскопа и спустя три года было получено первое изображение объекта, сформированное в
электронном пучке. Через 10 лет (1937 г.) М. фон Арденне и в 1942 независимо от него выдающимся нашим
гениальным инженером Владимиром Косьмичём Зворыкиным был разработан первый растровый электронный
микроскоп, работающий по принципу последовательного сканирования образца тонким электронным пучком.
М. Кнолль
и
Э. Руска
Зворымин В.К.
7.
8.
К середине 1960-х гг. электронные микроскопы достигли высокого технического совершенства, что определило ихширокое применение в научных исследованиях. По сравнению со световыми микроскопами использование
электронного луча с малой длиной волны позволяет существенно увеличить разрешающую способность. В настоящее
время используются несколько конструкций электронных микроскопов: просвечивающие, растровые (сканирующие),
эмиссионные и отражательные.
Взаимодействие электронного
пучка с веществом.
9.
Просвечивающая электронная микроскопия.Просвечивающая
электронная микроскопия является одним из самых высокоразрешающих методов исследования
поверхности и морфологии, в том числе и СБИС, обеспечивающим разрешение порядка 0,2 нм.
В 1931 г. был создан первый электронный микроскоп, а Р. Рюденберг получил патент на его применение.
Просвечивающая электронная микроскопия дает возможность получить в одном эксперименте изображения с высоким
разрешением и микродифракционные картины участка образца.
Современные просвечивающие электронные микроскопы обеспечивают разрешение до 0,1 нм и размер участка, с которого
снимается микродифракционная картина - до 50 нм.
По полученному изображению можно судить о строении материала, а по дифракционной картине – о типе кристаллической
решетки.
Эмпирическое правило - толщина образца не должна превышать более чем в 10 раз величину разрешающей способности.
Для получения сверхвысокого разрешения это правило уже не работает. Образец приготовляется в виде фольги или тонкой
пленки, называемой репликой.
Энергия применяемых электронных пучков лежит в пределах 60 500 кэВ. Но имеются уникальные приборы,
использующие энергии свыше 1 МэВ (это позволяет использовать более толстые образцы).
После проявления и печатания, осуществляемых обычными фотографическими методами, или соответствующего
преобразования изображения, получают так называемую электронную микрофотографию. Увеличение конечного
изображения может достигать 500 000 раз. (деталь структуры размером 2 нм на изображении будет иметь размер только 1
мм).
10.
Рис. 3. Принципиальная схемапросвечивающего электронного микроскопа
возрастает разрешающая способность оптической системы просвечивающего электронного микроскопа. Рост
ускоряющего напряжения также приводит к возрастанию проникающей способности электронов.
11.
На микроскопах с напряжением 1000 и более кВ возможно изучение образцов толщиной до 5-10 мкм. Проходячерез отверстие анода пучок электронов попадает в конденсоры и корректор юстировки, где происходит
окончательное наведение электронного луча на изучаемый образец.
После прохождения объекта электроны рассеиваются. Их фокусировка и получение первичного изображения на
экране осуществляется с помощью системы линз (объективной, промежуточной и т.п.). Аппретурная диафрагма
позволяет выбирать из всех электронов, прошедших через образец, либо только сильно рассеянные электроны, либо
нерассеянные или слаборассеянные электроны.
В первом случае на полученном изображении более светлыми будут выглядеть участки, соответствующие
участкам образца с большей рассеивающей способностью (темнопольное изображение), а во втором – наоборот
(светлопольное изображение).
Фиксация изображения на ранее выпущенных микроскопах осуществлялась на фотопленку или фотопластинки. В
современных микроскопах используются цифровые фото- и кинокамеры.
Для уменьшения явления астигматизма, вызванного отклонениями в симметрии магнитного поля
электромагнитных линз и нарушения геометрической формы полюсных наконечников. Для микродифракционных
исследований в состав микроскопа включают подвижную селекторную диафрагму, которая заменяет аппретурную.
Электроны, отклоняющиеся объектом на достаточно большие углы, задерживаются специальной диафрагмой, а
через ее отверстие пройдут только электроны, отклонившиеся на малые углы. Вследствие этого в точках конечного
изображения, соответствующих месту расположения тяжелых атомов объекта, электронов окажется меньше, чем в
других точках этого изображения.
Хотя амплитудный контраст в том смысле, в каком его понимают в световой микроскопии, не имеет места
(прозрачность объекта везде одинакова), все же, из-за наличия апертурной диафрагмы достигается эффект,
эквивалентный амплитудному контрасту.
В настоящее время имеется большой выбор промышленных образцов просвечивающих электронных
микроскопов. Для большей универсальности между объективной и промежуточной линзами в них устанавливают
12.
дополнительную линзу. В отличие от стеклянных линз преломляющую силу магнитной и электронной линзы можнолегко менять путем изменения тока возбуждения в обмотке. Поэтому увеличение, обеспечиваемое микроскопом,
можно менять непрерывно от нескольких сотен до сотен тысяч раз, а указанная дополнительная линза облегчает
возможность получения резкого изображения во всем этом широком диапазоне.
Существует три разновидности метода просвечивающей электронной микроскопии: прямой, полупрямой и
косвенный.
Прямой метод дает наиболее полную информацию о структуре объекта, которым служит тонкая металлическая
пленка (фольга) прозрачная или полупрозрачная для электронов. Обычно фольги получают путем утонения
массивных образцов. На последних стадиях процесса утонения наиболее часто применяют технологию
электрохимической полировки. В ряде случаев фольги получают также путем физического напыления в вакууме на
водорастворимые подложки (NaCl, KCl). При исследованиях по этому методу удается различать отдельные
дислокации и их скопления. Иногда микроскопы снабжают специальными приставками. Например, при
использовании приставки, позволяющей растягивать фольгу в колонне микроскопа, можно непосредственно
наблюдать эволюцию дислокационной структуры при деформации.
При исследовании этим методом можно проводить и микродифракционный анализ. В зависимости от состава
материала в зоне изучения получают диаграммы в виде точек (монокристаллы, или поликристаллы с зерном больше
зоны исследования), сплошные или состоящие из отдельных рефлексов (очень мелкие кристаллики в зернах или
несколько малых зерен).
С помощью микродифракционного анализа можно также определять ориентировки кристаллов и
разориентировки зерен и субзерен. Просвечивающие электронные микроскопы с очень узким лучом позволяют по
спектру энергетических потерь электронов, прошедших через изучаемый объект, проводить локальный химический
анализ материала, в том числе анализ на легкие элементы (бор, углерод, кислород, азот).
Косвенный метод связан с исследованием не самого материала, а тонких реплик, получаемых с поверхности
образца. В методическом плане он наиболее простой, так как изготовление фольг является сложным и достаточно
13.
длительным процессом. Изготовление реплик значительно проще. Его проводят либо путем напыления в вакууме наповерхность образца пленки углерода, кварца, титана или др. веществ, которую можно потом отделить от образца,
либо используют легко отделяемые оксидные пленки (например, для меди), получаемые оксидированием
поверхности. Еще более перспективно использование реплик в виде полимерных или лаковых пленок, наносимых в
жидком виде на поверхность шлифа. Для косвенного метода не требуется дорогостоящие высоковольтные
микроскопы. Однако, косвенный метод значительно уступает в разрешении прямому.
Разрешение лимитируется точностью самой реплики и достигает в лучшем случае (углеродные реплики)
несколько нм. Кроме того, возможно появление различных искажений и артефактов в процессе изготовления самой
реплики. Поэтому этот метод применяется в настоящее время достаточно редко. Многие его задачи, в том числе
фрактография, в значительной мере решаются теперь методами растровой электронной микроскопии.
Полупрямой метод иногда применяют при исследовании гетерофазных сплавов. В этом случае основную фазу
(матрицу) изучают с помощью реплик (косвенный метод), а частицы, извлеченные из матрицы в реплику, исследуют
прямым методом, в т.ч. и с помощью микродифракции. При этом методе реплика перед отделением разрезается на
мелкие квадратики, а затем образец протравливают по режиму, обеспечивающему растворение материала матрицы и
сохранение частиц других фаз. Травление проводят до полного отделения пленки-реплики от основы. Особенно
удобен метод при изучении мелкодисперсных фаз в матрице при малой объемной их доле. Отсутствие у реплики
собственной структуры позволяет исследовать дифракционные картины от частиц. При прямом методе такие картины
выявить и отделить от картины для матрицы очень сложно.
14.
Если в методе ПЭМ используется фольга, полученная непосредственно путем доведения образца до тонкойфольги, то имеет место разрушающий метод контроля, если используется реплика, представляющая собой
выращенную на поверхности образца тонкую пленку (до мельчайших подробностей повторяющую поверхностную
структуру образца) и отделенную от него с помощью специальных методик, то неразрушающий. Получение таких
реплик является исключительно кропотливым и неблагодарным процессом с очень низким выходом годных реплик.
Для улучшения качества изображения, получаемого с фольги, применяется метод затенения, заключающийся в
напылении хорошо поглощающего электроны материала на поверхность фольги под острым углом так, чтобы он
конденсировался больше на одной стороне
выступа, чем на другой. Для получения реплики на
поверхность образца напыляется или каким-либо
другим
методом
осаждается
специальный
материал, толщиной обычно порядка 10 100 нм. В
качестве покрытий используются органические и
неорганические
напыляемые
материалы,
электролитически осаждаемые металлы, окислы и
прочее, хотя самым распространенным материалом
Схема создания реплики
является уголь. Затем подложка удаляется, и
свободная пленка реплики помещается в камеру образцов электронного микроскопа.
Толщина образца должна быть меньше средней длины свободного пробега первичных электронов при упругих
столкновениях. Часто возникают ситуации, когда морфология исследуемого объекта характеризуется наличием
фазовых границ,
выходящих на обе поверхности просвечиваемой фольги, что накладывает
дополнительные ограничения на максимально допустимую толщину образца.
Схема оттенения фольги
15.
Приготовление фольги является тоже весьма трудоемким процессом, поскольку применение для этой цели какихлибо механических устройств на последней стадии невозможно. Обычно образец разрезается на миллиметровыепластинки, которые затем механическим путем полируются до толщин порядка 50 мкм.
Затем образец подвергают прецизионному ионному травлению с обратной стороны от исследуемой поверхности,
в результате чего он утоньшается до толщины порядка 50 10 нм. Если образец имеет сложный состав, то надо
учитывать, что скорость эрозии различных материалов при ионном распылении различна. В общем итоге
получаемый срез дает прямую информацию не столько о самом образце, сколько о чрезвычайно тонкой пленке,
оставшейся после его обработки. Поскольку большая часть подложки безвозвратно исчезает, трудно коррелировать
получаемые данные с характеристиками носителя подложки.
Контрастность увеличенного изображения достигается за счет столкновений электронов с атомами мишени, что
приводит к их рассеянию и потерям энергии, поэтому эти электроны отклоняются от направления оптической оси и
не участвуют в процессе создания изображения. Чтобы собрать рассеянные электроны в фокальной плоскости
изображения линз объектива помещается апертурная диафрагма, которая исключает образование фона на экране и
вуали на фотопластинке.
В связи с развитием нанотехнологии и особенно методов получения ультрадисперсных и наноразмерных
порошков наблюдается возрождение определенного интереса к ПЭМ. Подвергаемые исследованию
ультрадисперсные и наноразмерные частицы высаживаются на очень тонкую и практически прозрачную для
электронных лучей мембрану, после чего и помещаются в колонну ПЭМ. Таким образом, можно наблюдать их
структуру непосредственным образом, практически также, как в обычном оптическом микроскопе, только с
несравненно более высоким разрешением.
16.
Растровая электронная микроскопия.Физические и технические основы работы РЭМ.
Метрологическим и технологическим инструментом (зондом), имеющим самые минимальные размеры, является
остросфокусированный и максимально сжатый пучок заряженных частиц электронов или ионов. Применение
электронов существенно более предпочтительно, поскольку масса электронов мала и их применение не вызывает в
исследуемом объекте физико-химических или структурных изменений. Применение электронных зондов, является
неразрушающим методом контроля до определенных параметров энергии и плотности тока пучка электронов.
В растровом электронном микроскопе изображение исследуемого
объекта формируется при сканировании его поверхности тонко сфокусированным (в идеале 2-3 нм) лучом
электронов. Такой луч часто называют электронным зондом. Диаметр зонда в современных приборах может
составлять 5-1000 нм в зависимости от решаемых задач.
При взаимодействии электронного зонда с твердым телом возникает масса различных физических явлений и
эффектов.
Эффекты, возникающие
при взаимодействии электронного
луча с веществом
1- электронный луч, 2- изучаемый образец, 3- отраженные
электроны, 4- вторичные электроны, 5- ток от поглощенных электронов,
6- катодолюминисценция, 7- рентгеновское излучение, 8- электроны, 9наведенный ток, 10- электроны, прошедшие через образец.
Для формирования картины поверхности используют отраженные
электроны и вторичные электроны. Создаваемые ими сигналы после их
регистрации приборами усиливают, а затем используют для модуляции
яркости изображения на электронно-лучевой трубке, развертка которой
синхронна со смещением электронного зонда. Таким образом, между
каждой точкой на поверхности образца ставится в соответствие точка на
17.
экране электронно-лучевой трубки. Яркость изображения точкисоответствующей точки на изучаемой поверхности.
пропорциональна
интенсивности сигнала от
При использовании сигнала от отраженных электронов получается информация от слоя толщиной 1-2 мкм и
диаметром существенно большим зоны падения электронного луча. Изображение поверхности получается с не очень
высоким разрешением, зато отличается сильным черно-белым контрастом. Такой режим может быть полезен при
изучении структуры на металлографических шлифах.
При использовании сигнала от вторичных электронов достигается наибольшее разрешение, так как вторичные
электроны возникают в слое толщиной порядка 1 нм, а зона их возникновения ограничена областью вокруг падения
электронного луча. Контрастность изображение несколько ниже, чем при использовании отраженных электронов,
однако оно имеет стереометрический характер.
Можно выделить следующие основные методы исследования твердого тела, связанные с электронным зондом:
AEM (аналитическая электронная микроскопия); AES (электронная оже-спектроскопия); AEAPS (электронная ожеспектроскопия потенциала появления); EDS (электронная спектроскопия с дисперсией по энергиям); EELS
(спектроскопия электронных потерь энергии); EMA (электронный микроанализ); ESCA (электронная спектроскопия
для химического анализа); FEM (полевая электронно-эмиссионная микроскопия); HEED (дифракция электронов
высоких энергий); HREELS (спектроскопия характеристических потерь энергии электронов высокого разрешения);
LEED (дифракция электронов низких энергий); RHEED (дифракция электронов высоких энергий); SEM
(сканирующая электронная микроскопия, в отечественной литературе используется термин растровая электронная
микроскопия с аббревиатурой РЭМ); TEM (просвечивающая электронная микроскопия соответственно ПЭМ).
Применение остросфокусированного (до 10 ангстрем в диаметре) электронного зонда позволяет исследовать
локальную область образца примерно таких же размеров.
Важным достоинством растровой электронной микроскопии является сочетание большой разрешающей
способности (до 10 нм, а при использовании специальных катодов из гексаборида лантана – до 5 нм) с большой
глубиной фокуса (при разрешении 10 нv она составляет 1 мкм). Это позволяет проводить высококачественные
18.
19.
Эмитируемые катодом электроны ускоряются и формируются в электронный луч (зонд) с помощью системыдиафрагм, линз, стигматоров и т.п. Отклоняющие катушки, соединенные с генератором, обеспечивают синхронную с
электронно-лучевой трубкой развертку (сканирование) электронного зонда по изучаемому участку поверхности
образца. Формирование яркости изображения осуществляется по сигналам от детекторов отраженных электронов,
вторичных электронов и рентгеновского излучения. Управление увеличением (от 20 до 10000) осуществляется
специальным устройством путем изменения отношения амплитуд развертки луча по экрану и электронного зонда по
образцу.
Формирование и использование остросфокусированных электронных пучков в метрологических и иных
целях связано с физическими явлениями, существенно ухудшающими возможную разрешающую способность:
1. Сферическая аберрация возникает вследствие того, что электроны, движущиеся по траекториям, удаленным
от оптической оси, фокусируются сильнее, чем электроны, движущиеся вблизи оптической оси. Для электронных
лучей, движущихся через линзу, оптическая сила линзы тем больше, чем дальше они от оптической оси это
вызывает появление на образце кружка рассеяния.
2. Хроматическая аберрация возникает вследствие начального разброса электронов по энергиям, а,
следовательно, и по скоростям, при прохождении их через линзу. Эти изменения в большей степени происходят
вследствие несовершенства стабилизации различных источников питания, нежели вследствие чисто физических
причин.
3. Дифракция обусловлена волновой природой электронов и ограничениями на апертуру в объективной линзе,
которые обеспечивают так называемый кружок рассеяния d = 1,22 ; = 12,26/Е1/2 (энергия электронов Е в эВ, в
ангстремах); угол расхождения.
4. Астигматизм обусловлен тем, что на практике электростатические и магнитные линзы не обладают совершенно
идеальной симметрией вследствие ошибок при механической обработке, неоднородности магнитных полей внутри
железа, асимметрии обмоток и нерегулярностей, вызываемых загрязнениями и рядом других причин. Поэтому линза,
а, соответственно, и пятно на поверхности образца имеют не круговую, а эллиптическую симметрию.
20.
Глубина пробега электронов в образцеОсновными, определяющими параметрами
физического
процесса
взаимодействия электронов с
образцом являются глубина пробега
электронов в образце (определяет глубину анализа) и коэффициент обратного
отражения
(определяет возможность съёма сигнала и его интенсивность. Пробег
электронов в мишени можно посчитать по довольно простой и не точной
модели Канайя – Окаяма:
Траектории движения электронов
в мишени по М-К.
R=0,0276 E1,67 A / (Z0,889
где E (энергия электронов в пучке) задается в кэВ, А (атомный вес) в г/моль, а
(плотность вещества мишени с номером Z) - в г/см3. Тогда R - вычисленная
полная длина пробега электронов в мишени будет выражена в мкм.
Существенно более точные данные получаются при применении метода Монте Карло, в котором прослеживается
траектория движения каждого электрона и все потери его энергии. Такой расчет для 5 траекторий показан на вверху, а
результаты полного расчета (обычно 20000-30000 траекторий) – внизу рисунка.
Отраженные электроны могут возникать как в результате однократного упругого отражения, так и в актах малоуглового
многократного рассеяния. Оценки показывают, что для энергии падающих электронов 10 – 30 кэВ и мишеней,
содержащих легкие элементы (с малым атомным номером), несколько более половины всех отраженных электронов
рождается в результате многократных малоугловых актов взаимодействия. Для тяжелых элементов ситуация меняется на
обратную.
21.
Электроны зонда, проникая в материал мишени, многократновзаимодействуют с электронами атомов, решётки, с электрическими
полями ядер, теряя энергию вплоть до захвата электрона зонда каким-либо
центром решетки. Так как траектории движения каждого электрона имеют
весьма сложную форму, в образце мишени образуется область, в которой
электроны зонда растрачивают всю свою энергию. Эта область получила в
литературе название области взаимодействия. Расчет этой области показан
с лева, а результаты эксперимента ниже
Область взаимодействия электронов с
мишенью. Расчет.
.
Область взаимодействия электронов
с мишенью. Эксперимент
22.
Коэффициент отражения электронов.Важной величиной является также коэффициент отражения, определяемый по эмпирической
формуле:
n = - 0,0254 + 0,016 Z – 1,86 10-4 Z2 + 8,3 10-7 Z3







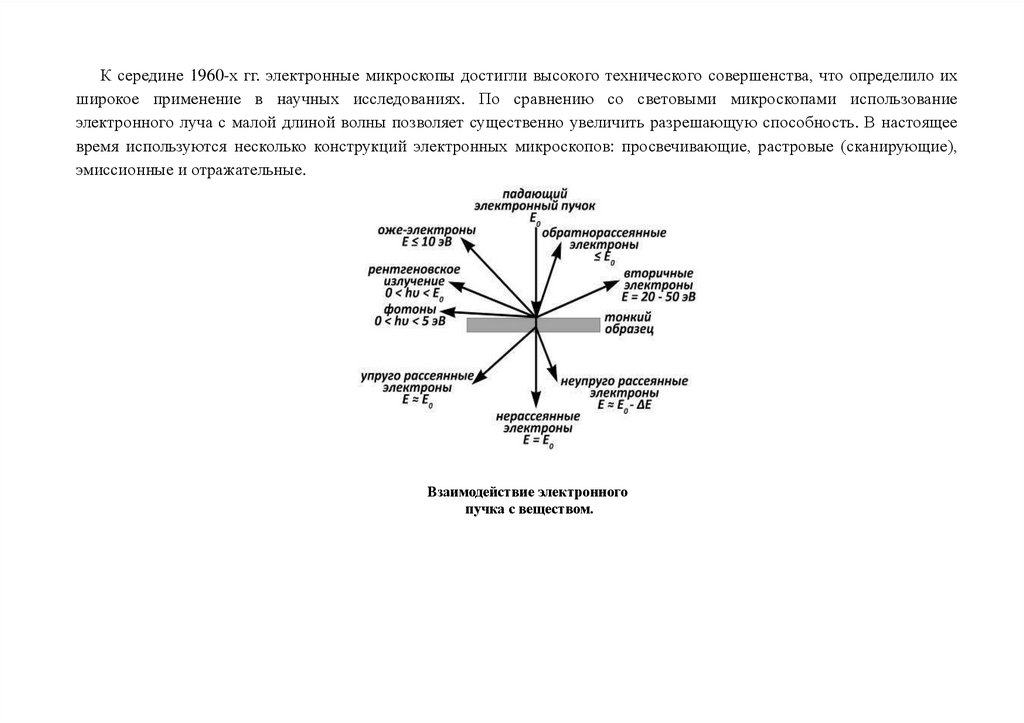





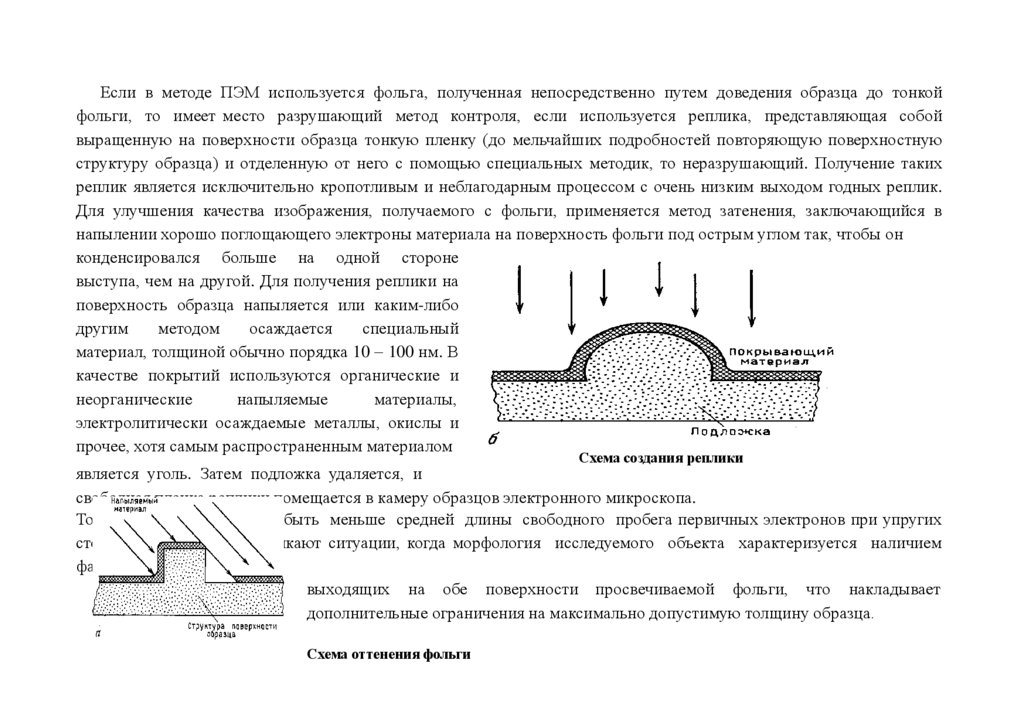






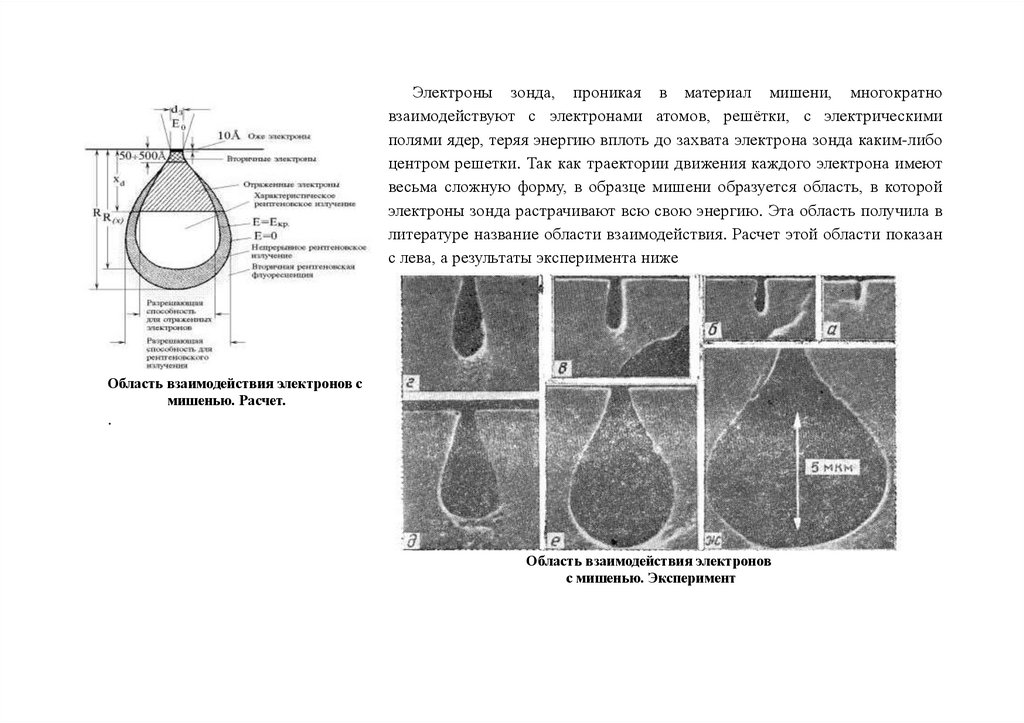

 Биология
Биология Электроника
Электроника








