Похожие презентации:
Гибридные технологии. Нанотранзисторы
1. Гибридные технологии
Нанотранзисторы2. СУБМИКРОННЫЕ СТРУКТУРЫ КРЕМНИЙ-НА-ИЗОЛЯТОРЕ (КНИ)
СУБМИКРОННЫЕ СТРУКТУРЫ КРЕМНИЙНА-ИЗОЛЯТОРЕ (КНИ)• В области субмикронных размеров за счет
полной диэлектрической изоляции КНИтранзисторы обладают рядом преимуществ
перед их аналогами на объемном кремнии —
более низким энергопотреблением, высокими
пробивными напряжениями, большим
быстродействием.
3. НАНО-МЕТРОВЫЕ СТРУКТУРЫ КНИ И КМОП (КОМПЛЕМЕНТАРНАЯ СТРУКТУРА МЕТАЛЛ-ОКСИД-ПОЛУПРОВОДНИК;)
НАНО-МЕТРОВЫЕ СТРУКТУРЫ КНИ И КМОП(КОМПЛЕМЕНТАРНАЯ СТРУКТУРА МЕТАЛЛ-ОКСИДПОЛУПРОВОДНИК;)
•В нано-метровом диапазоне привлекательность
КНИ обусловлена прежде всего возможностью
решения
ряда
проблем,
свойственных
короткоканальным
транзисторам,
а
также
возможностью изготовления новых приборов,
работающих на квантово-размерных эффектах.
4. Транзистор на основе нанотрубки
• В традиционном полевом транзисторе канал переноса носителейзаряда (дырок и электронов), который представляет собой область
между стоком и истоком, обогащенную основными носителями
заряда, образуется в подзатворной области под действием
электрического поля, возникающего при приложении напряжения к
затвору. Меняя напряжение на затворе, можно управлять каналом
переноса (концентрацией носителей заряда в подзатворной области).
При этом, как правило, рассматриваются два состояния полевого
транзистора: открытое и запертое. В открытом состоянии существует
канал переноса заряда, и под воздействием напряжения между
стоком и истоком возникает электрический ток. В запертом состоянии
канала переноса нет и тока между стоком и истоком не возникает.
5. Структура полевого транзистора на основе нанотрубки
а подложку из кремния, которая сама являетсяуправляющим электродом (затвором), наносится
тончайшая пленка защитного слоя — оксида кремния. На
этой пленке расположены сток и исток в виде тонких
проводящих рельсов. Между этими рельсами
располагается сама нанотрубка с полупроводниковой
проводимостью. В обычном состоянии концентрация
свободных носителей зарядов (дырок и электронов) в
нанотрубке мала, то есть она является диэлектриком.
Зона проводимости в данном случае отделена от
валентной зоны запрещенной зоной шириной в несколько
электрон-вольт. Однако при помещении нанотрубки в
электрическое поле ширина запрещенной зоны меняется
и концентрация свободных носителей зарядов
увеличивается. В этих условиях нанокарбоновая трубка
становится проводником. Электрическое поле,
управляющее проводимостью нанокарбоновой трубки,
создается затвором, которым, как уже отмечалось,
является кремниевая подложка. При потенциале затвора
порядка 6 В концентрация свободных носителей заряда в
валентной зоне достигает максимума, и нанотрубка
становится хорошим проводником
6. одноэлектронный транзистор Japan Science & Technology Corporation
одноэлектронный транзистор JapanScience & Technology Corporation
• Проводящий канал транзистора
(остров) отделен от стока и истока
туннельными барьерами из тонких
слоев изолятора. Чтобы транзистор
мог работать при комнатной
температуре, размеры острова не
должны превышать 10 нм. Высота
потенциального барьера равна 0,173
эВ.
7. КМОП технология
• Микро-конструкция•остров
был
крупнее,
высота
потенциального барьера была 0,04 эВ,
и рабочая температура не превышала
60 °К. Материалом для острова
служит отдельный кластер аморфного
кремния,
поверхность
которого
оксидирована при низкой температуре
для создания тонкого барьерного слоя
.
8. технология системной интеграции полупроводниковых и металлических углеродных трубок
На подложку — пластину из оксидированногополированного
кремния
—
наносится
композиция, состоящая из пучков слипшихся
полупроводниковых
и
металлических
нанотрубок углерода, которые трудно отделить
друг от друга при массовом производстве.
Поверх полученной пленки литографическим
методами наносятся узкие полоски обычного
металла. С помощью электрического сигнала
можно переводить углеродные нанотрубки из
полупроводникового состояния в состояние
изолятора.
Углеродные нанотрубки
9. Кремниевый транзистор, созданный на основе КМОП-технологии
транзистор,созданный на
основе КМОПтехнологии
КНИ-технологии
полупроводниковых
Принципиальная схема элементарного полупроводникового транзистора,
составляющего
основанные
на
использовании трехслойной подложки со структурой
«кремний – оксид кремния – кремний». Подложка,
выполненная
по КНИ-технологии,
представляет
собой трех-слойный пакет, которые состоит из
монолитной кремниевой пластины, диэлектри-ка и
размещенного на нем тонкого поверхностного слоя
кремния.
больших
интегральных
миллионов элементарных транзисторов на кристалле)
изготовления
систем,
основу
схем
(несколько
10.
КНИ подложки, где в качестве диэлектрика-изолятора выступает диоксид кремния SiO2(гораздо реже – сапфир; в этом случае техноло-гия называется «кремний-на-сапфире», или
КНС). Подложки могут быть получены несколькими различными способами. Один из них,
термическое оксидирование, – отжиг пластины Si при высокой температуре. КНИтехнология подразумевает образование изолирующего слоя SiO2 достаточно большой
толщины, который при необходимости может быть частично стравлен. В следующем
сегменте производственного цикла на слой оксида наращивается тонкий слой Si,
например, по эпитаксиальной технологии. Одно из преимуществ использования КНИподложек состоит в возможности формирования транзисторов с латеральными затворами,
когда и канал, и затворы создаются из одного и того же слоя кремния. Увеличение
пропускной способности канала может быть достигнуто предварительным легированием
пластины Si, например, фосфором P, для увеличения проводимости. При отжиге пластины
Si, вследствие физико-химического процесса сегрегации (выталкивания фронтом волны
оксидирования SiO2/Si примесей фосфора вглубь материала Si),может быть сформирован
высокопроводящий слой, канал транзистора. При этом образуются узколокализованные
зоны повышенной концентрации P в Si, исток и сток транзистора. Важной особенностью
транзисторов на КНИ-структурах является их работоспособность в более широком
температурном диапазоне и радиационная стойкость.
11. Архитектура КНИ-транзистора. Пластина кремния после операций оксидирования, эпитаксии, легирования, травления и металлизации.
12. SON-транзисторов и транзисторов FinFET корпорации Intel
• Наноразмерныегетероструктуры конструкции:
базовая подложка, внутренний
изолятор, канал, исток, сток,
подзатворный диэлектрик,
затвор, боковые изоляторы
корпуса и затвора
Архитектура SON-транзистора
13. Компьютерное проектирование КНИ-транзистора
•Первый этап (рис.4.6-а) заключается в создании подложкитранзистора. Кремниевая монопластина толщиной 100 нм
(корпус транзистора) оксидируется, в результате чего
создается двухслойная пластина Si – SiO2. В КНИтехнологии формируют толстый 50-нм слой оксида. Для
усиления изолирующих свойств с целью устранить или
минимизировать токи утечки в корпус может быть
дополнительно к слою оксида SiO2 сформирован тонкий
(5нм) защитный слой нитрида кремния Si3N4.Второй этап
– формирование канала транзистора (рис.4.6-б). На слой
оксида по эпитаксиальной технологии наращивается слой
кремния. Этот слой кремния, высоколегированный
примесями донорного (фосфор P, мышьяк As) и/или
акцепторного (бор B) типа, обеспечивает проводимость nили p-типа (электронной или дырочной). Создается канал
толщиной 20нм и длиной 200 нм. В представляемой Последовательные стадии формирования наноструктур
конструкции центр канала имеет преимущественно n тип транзистора: двухслойная подложка (а), канал (б), боковые
изоляторы и подзатворный диэлектрик (в), затвор и
проводимости,
а
края
канала
(непосредственно подводящие контакты (г), крышка затвора, исток и сток (д),
соединенные с истоком и стоком транзистора) – электроподводящий слой (е).
проводимость преимущественно p-типа.
14.
• Сначала выращивается 20-нм слой Si, высоколегированныйфосфором (зона n-проводимости в центре канала). Далее маскируется
центральная часть и проводится травление краев слоя Si на его полную
глубину (20 нм). После этого защитные маски смываются
(стравливаются), и проводится эпитаксия нового 20-нм слоя Si,
высоколегированного бором. Этим обеспечивается p-проводимость на
краях канала, прилегающих к истоку и стоку. Создается П-образный
слой Si (толщина которого на данный момент составляет 20 нм по краям
и 40 нм в центре). Его края закрываются масками, и производится
травление в центре на глубину 20 нм. После удаления защитных масок
канал транзистора, с одинаковой по всей длине 20-нм толщиной,зоной
проводимости n-типа в центре и p-типа по краям, сформирован
15.
Однородный по толщине слой Si закрывается последовательно масками в нужных
позициях. Затем производится последовательная (борлевый край, фосфор – центр, бор –
правый край) ионная имплантация легирующих примесей в канал. Однако заметим, что при
этом не может быть достигнуто равномерное распределение примесей по глубине. В такой
технологии
зависимость
концентрации
примесей
поперек
канала
соответствует
распределению Гаусса, положение максимума которого определяется энергией имплантации
(глубина внедрения, например, фосфора требует около 1 – 2 эв/нм в зависимости от других
характеристик процесса и ориентации кристаллической решетки кремния). Третью стадию
производства (рис.4.6-в) составляет группа операций по формированию подзатворного
диэлектрика и боковых изоляторов.
16.
• Для повышения эффективности функционирования изолирующийдиэлектрик составляется из двух слоев (например, SiO2 и Si3N4).
Естественно, перед травлением накладываются защитные маски слева
и справа от зоны травления, с последующим их удалением.Ниже
упоминание о маскировании поверхности будет опускаться, однако
следует иметь в виду, что операции травления, оксидирования,
имплантации (и некоторых других) сопровождаются предшествующим
маскированием части поверхности и последующим удалением(при
необходимости) защитных масок.Левый и правый боковые изоляторы
создаются операцией оксидирования. Они отделяюткрая проводящего
канала транзистора от других НЭМС-структур в пластине
полупроводникового материала.
17.
•Следующая,четвертая,
стадия–
группа
операций
по
формированию
затвора
транзистора и областей контакта канала с
истоком
и
стоком.
На
горизонт
поверхности,сформированный в предыдущей
стадии, проводится эпитаксия толстого (20 нм)
высоколеги рованного слоя кремния. Далее этот
слой оксидируется в четырех зонах. При этом
вместо единого слоя образуются три области Si
с
хорошей
электропроводностью,
изолированные друг от друга и внешних границ
оксидом.
18. NRAM (Nonvolatile Random Access Memory).
• В предложенной компанией схеме) на кремниевую подложкунаносится тонкая изолирующая пленка оксида кремния, вдоль
которой размещены токопроводящие электроды шириной в 130
нм, отделенные друг от друга изолирующими слоями. Над
электродами перпендикулярно к ним расположены массивы
нанотрубок, которые замыкаются с обеих сторон на проводящие
контакты. В обычном состоянии (состояние OFF) нанотрубки не
касаются электродов и находятся над ними на высоте порядка 13
нм. Если к нижнему электроду приложить напряжение, то
нанотрубка под воздействием электрического поля начнет
выгибаться и коснется нижнего электрода. Однако такое
состояние (состояние ON) оказывается устойчивым за счет
баланса между возникающим механическим напряжением и Вандер-Ваальсовыми силами В результате даже после исчезновения
напряжения форма нанотрубки не изменится. Таким образом,
меняя напряжение на электроде, можно переходить между двумя
стабильными механическими состояниями нанотрубок, в одном
из которых имеется контакт с электродом, а в другом — нет. Одно
из этих состояний будет отвечать логическому нулю, а другое —
логической единице.
19. Память на нанотрубках
Структура массива NRAM-памятина нанотрубках
Два устойчивых механических
состояния нанотрубок
20. Считывание информации с ячейки памяти на основе нанотрубок
информации с ячейкипамяти на основе
нанотрубок
Для того чтобы прочитать содержимое
элементарной ячейки памяти, между
нижним электродом и контактом, к
которому подсоединены нанотрубки,
отвечающие выбранной ячейке памяти,
подается напряжение. Если ячейка памяти
находится в состоянии OFF, при котором
нет физического контакта между
электродом и нанотрубкой, то
электрическая цепь оказывается
разомкнутой и напряжение будет
высоким, что соответствует логической
единице. Если же ячейка памяти
находится в состоянии ON, то есть имеется
контакт между нанотрубкой и нижним
электродом, то цепь замыкается и
напряжение будет низким, что
соответствует логическому нулю










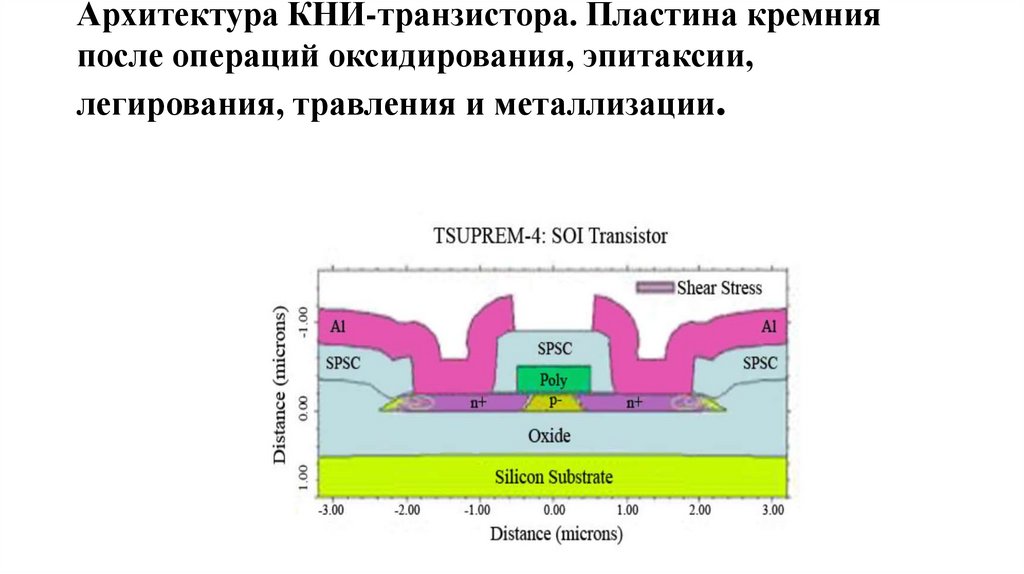

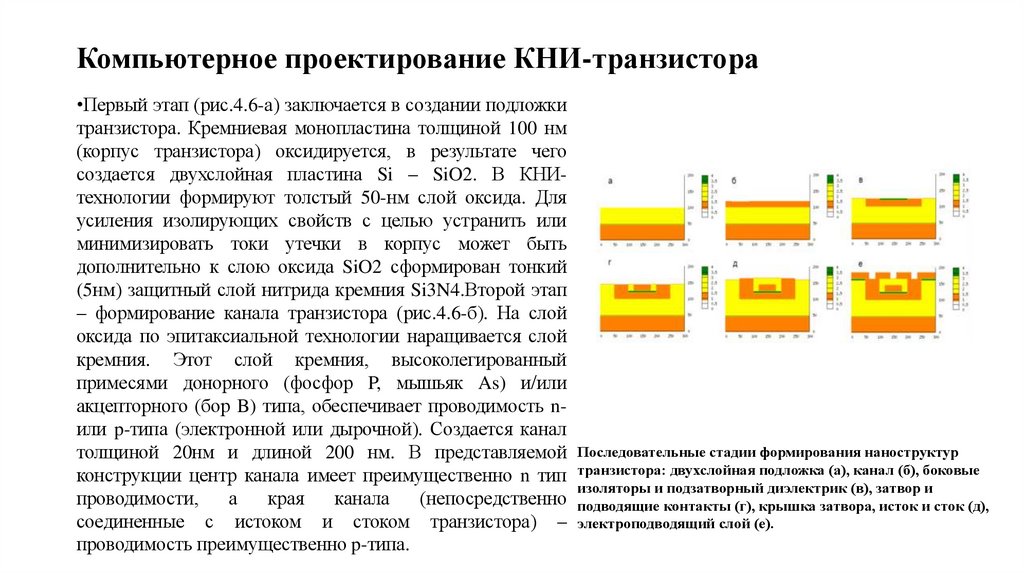





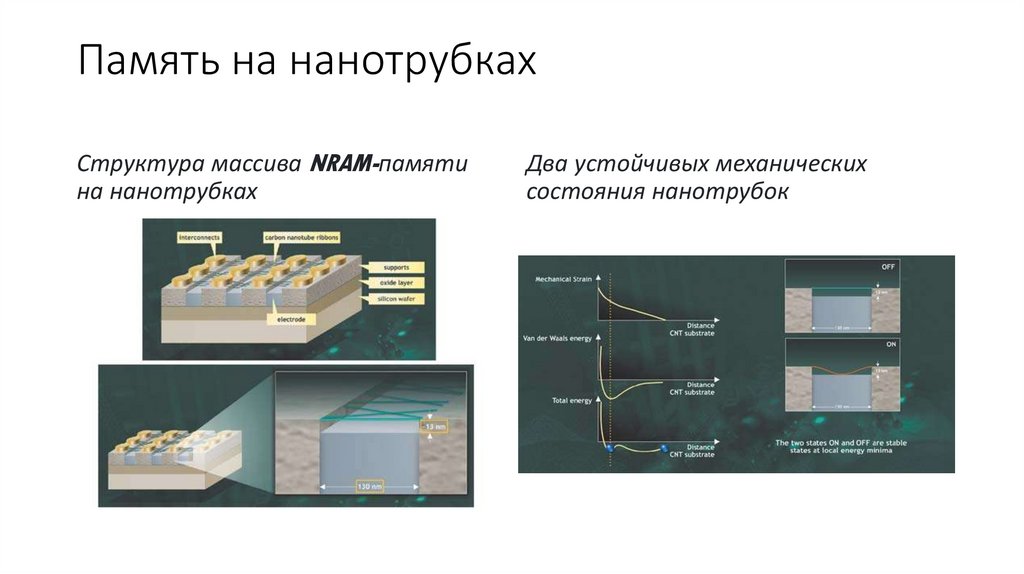
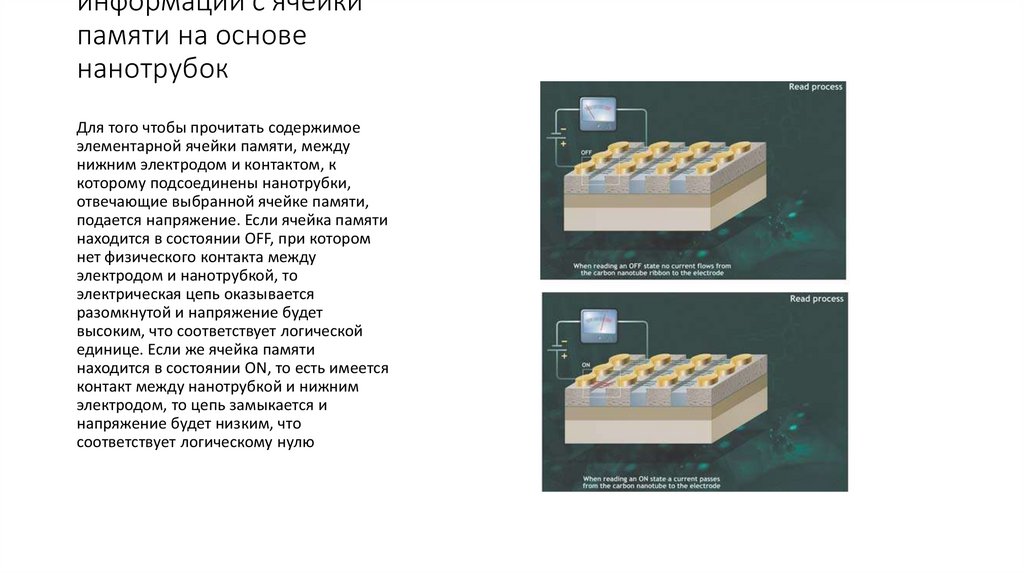

 Физика
Физика








