Похожие презентации:
Технологічні основи електроніки
1. “Технологічні основи електроніки“
Лектор доц. Опанасюк Надія Миколаївна1.1 Мета і завдання викладання навчальної дисципліни
Мета викладання дисципліни - формування у студентів поглибленого розуміння основ
технології виготовлення інтегральних мікросхем та приладів мікроелектроніки, та
сприяння розумінню фізичних процесів, їх практичного застосування при створенні нових
мікроелектронних пристроїв і систем.
Задачі викладання дисципліни пов’язані з необхідністю отримання бакалаврами
знань з технології виготовлення інтегральних мікросхем, активних та пасивних елементів
мікросхем та складання виробів мікроелектроніки.
Після засвоєння матеріалу навчальної дисципліни студент повинен:
ЗНАТИ:
- сучасні вимоги до технології виготовлення ІМС та мікроелектронних
приладів;
- матерiали, якi використовують при виробництвi мiкросхем;
- основні технологічні базові процеси виготовлення напівпровідникових ІМС (термічна
дифузія, іонна імплантація, фотолітографія, методи осадження тонких плівок,
трафаретний друк товстоплівкових елементів);
- технологію виготовлення плівкових пасивних елементів;
- методи та етапи складання виробів мікроелектроніки.
ВМІТИ (на експериментальному та діагностичному рівні):
- Зобразити послідовність формування структури напівпровідникових інтегральних
мікросхем різного типу на прикладі транзистора
- розробити спрощену схему технологічного процесу виготовлення напівпровідникових,
плівкових і гібрідних мікросхем;
- визначити орієнтовні параметри проведення основних технологічних базових
процесів. 1
Опанасюк Н.М.
2. ОЦІНЮВАННЯ (РЕГЛАМЕНТ)
а) Робота на аудиторних заняттях (0,2 R = 20 балів):
- Лекції: 12 лк. * 1 бал/лк. = 12 бал.
- Лабораторні заняття: 4 лаб. * 1 бал./лаб. = 4 бал.
б) Виконання та захист лабораторних робіт (3 лаб. роботи) – максимально 14
балів (при позитивному оцінюванні - захист лаб. роботи №1- 6 балів, №2 та
№3 - по 4 бали за кожну);
в) Розрахунково – графічна робота – 20 балів.
г) Складання комплексних письмових модульних контролів - всього 50 балів
(перший модульний контроль у І-му модульному циклі – 30 балів, другий - у
ІІ-му модульному циклі – 20 балів.
3. Підсумок рейтингових балів за мод. циклами (при позитивному
оцінюванні):
1-ий модульний цикл: (8 лк., модульний контроль) – 38 балів.
2-ий модульний цикл: (4 лк., 4 лаб. заняття; захист лабораторних робіт, РГР;
модульний контроль) – 62 бали.
2
Опанасюк А.С.
3. ШКАЛА ОЦІНЮВАННЯ ЗНАНЬ СТУДЕНТІВ
Сумма балівОцінка ESTS
Оцінка за національною
шкалою
ДСК або ПСК
залік
90-100
A
відмінно
82-89
B
добре
74-81
C
64-73
D
60-63
E
35-59
FX
1-34
F
зараховано
задовільно
незадовільно не зараховано
3
Опанасюк А.С.
4.
ЗМІСТВступ
Розділ 1 Загальна характеристика технологічного процесу виготовлення мікросхем.
1.1.Основні поняття та визначення
1.2. Класифікація технологічних процесів.
1.3.Мiкроклiмат та виробнича гiгiєна.
Розділ 2 Загальна характеристика технологічного процесу виготовлення мікросхем.
2.1.Формування структури напівпровідникових мікросхем
2.1.1.Вимоги до кремнієвих пластин
2.1.2. Елементи напівпровідникових інтегральних мікросхем
2.1.3 Послідовність виготовлення напівпровідникових мікросхем
2.1.4. Схема технологiчного процесу.
2.2 Легування напівпровідників.
2.2.1. Фiзичнi основи процесу термiчної дифузiї.
2.2.2. Практичнi способи проведення дифузiї.
2.2.3. Методи вивчення характеристик дифузiйних шарiв.
2.2.4 Фiзичнi основи процесу іонної імплантації.
2.2.5 Практичні методи проведення iонної iмплантацiї.
2.3 Епітаксія.
2.3.1 Автоепiтаксiя кремнiю хлориновим та силановим
методами.
2.3.2 Молекулярно-променева епiтаксiя.
2.4 Літографія.
2.4.1 Загальна характеристика фотолiтографічного
процесу.
2.4.2 Фоторезисти.
2.4.3 Технологія фотолітографічного процесу.
2.4.4 Фотошаблони та методи їх використання.
2.4.5 Електронолiтографiя.
2.4.6 Рентгенiвська лiтографiя.
2.4.7 Іонна лiтографiя.
4
5.
Розділ 3 Технологiя гiбридних iнтегральних мiкросхем3.1 Технологiя тонкоплiвкових iнтегральних мiкросхем.
3.1.1 Загальна характеристика технологічного процесу.
3.1.2 Методи нанесення тонких плівок металів.
3.2 Технологiя товстоплiвкових iнтегральних мiкросхем.
3.2.1 Пасти для товстоплівкових пасивних елементів.
3.2.2 Трафаретний друк та впалювання елементів.
3.2.3 Пiдгонка товстоплiвкових резисторiв та
конденсаторiв.
Розділ 4 Складання мiкросхем
4.1 Методи та етапи складання.
4.2 Роздiлення пластин та пiдкладок.
4.3 Монтаж навісних компонентів та плат.
4.4 Приєднання зовнішніх виводiв.
4.5 Складання мiкросхем на стрiчкових носiях.
4.6 Корпуси для iнтегральних мiкросхем та
напівпровідникових приладів.
4.7 Герметизацiя мiкросхем.
5
6.
• ЛІТЕРАТУРА
Опанасюк Н.М. Технологічні основи електроніки (практикуми): навчальний посібник /
Н.М.Опанасюк, Л.В.Однодворець, А.О.Степаненко, С.І.Проценко. - Суми: Сумський
державний університет, 2013.- 105 с.
Додаткова рекомендована література.
Готра З.Ю. Технологія електронної техніки: навч. посібник в 2 т. / З.Ю.Готра. - Львів:
Видавництво Національного університету «Львівська політехніка».-Т.1.- 2010.- 888 с.
. Готра З.Ю. Фізичні основи електронної техніки: навч. посібник в 2 т. / З.Ю.Готра.- Львів:
Видавництво Національного університету «Львівська політехніка» -Т.2.- 2010.- -884 с.
Готра З.Ю. Технологія електронної техніки: / З.Ю.Готра, І.Є. Лопатинський, Б.А.
Лукіянець та ін.; за ред.З.Ю.Готри.- Львів: Видавництво «Бескид Біт» , 2004.- -880 с.
Прищепа М.М. Мікроелектроніка: в 3 ч. / М.М. Прищепа, В.П. Погребняк. - Київ: Вища
школа. - Ч.1. Елементи мікроелектроніки.- 2004. - 432 с.
Закалик Л.І. Основи мікроелектроніки / Л.І. Закалик, Р.А. Ткачук.– Тернопіль: ТДТУ ім. І.
Пулюя, 1998.- 352 с.
Степаненко И.П. Основы микроэлектроники / И.П. Степаненко - Москва: Лаборатория
базових знаний, 2001. - 488 с.
Аваев Н.А. Основы микроэлектроники / Н.А. Аваев, Ю.Е. Наумов, В.Т. Фролкин. –
Москва: Радио и связь, 1991.–288 с.
Ігумнов Д.В. Основи мікроелектроніки / Д.В. Ігумнов, Г.В. Корольов, І.С. Громов.– Київ:
Вища школа, 2004. – 252 с.
Ефимов И.Е. Микроэлектроника. Физические и технологические основы, надежность / И.Е.
Ефимов, И.Я. Козырь, Ю.И. Горбунов. - Москва: Высшая школа, 1986.-464с.
Березин А.С. Технология и конструирование интегральных мікросхем / А.С.Березин,
О.Р.
6
Опанасюк А.С.
Мочалкина.– Москва: Радио и связь, 1992. – 320 с.
7.
Парфенов О.Д. Технология мікросхем / О.Д. Парфенов.-Москва: Высшая школа, 1986. - 320с.
Бер А.Ю. Сборка полупроводниковых приборов и интегральных мікросхем / А.Ю.Бер, Ф.Е
Минскер.-Москва: Высшая школа, 1986. – 279 с.
Ефимов И.Е. Основы микроэлектроники /. И.Е. Ефимов, И.Я Козырь. - Москва: Высшая
школа, 1983. – 384 с.
Пасынков В.В. Материалы электронной техники / В.В. Пасынков. - Москва: Высшая школа,
1980. – 406 с.
Курносов А.И. Технология производства полупроводниковых приборов и интегральных
мікросхем / А.И. Курносов, В.В. Юдин. - Москва: Высшая школа, 1986. – 368 с.
Черняев В.Н. Технология производства интегральных микросхем и микропроцессоров
/В.Н.Черняев. - Москва: Радио и связь, 1987. - 464 с.
Тилл У. Интегральные схемы. Материалы, приборы, изготовление / У. Тилл, Дж. Мансон. Москва: Мир, 1985.-501 с.
Моро У. Микролитография / У. Моро. - Москва: Мир, 1990.- 1240 с.
Борисенко А.С. Технология и оборудование для производства микроэлектронных устройств /
А.С. Борисенко, Н.Н. Бавыкин. - Москва: Машиностроение, 1983.- 320 с.
Молекулярно-лучевая эпитаксия и гетероструктуры / Под.ред. Л. Ченга и К. Плота.- Москва:
Мир, 1989.- 584 с.
Сугано Т., Введение в микроэлектронику / Т. Сугано, Т. Икома, Е.Такэиси. - Москва: Мир,
1988.- 320 с.
Медведев С.А. Введение в технологию полупроводниковых материалов / С.А. Медведев.Москва: Высшая школа, 1970.- 504 с.
Федоров Л.П. Производство полупроводниковых приборов / Л.П Федоров., В.М. Багров,
7
Ю.Н.Тихонов. - Москва: Энергия, 1979.- 432 с.
8. Розділ 1. Загальна характеристика технологічного процесу виготовлення мікросхем. 1.1.Основні поняття та визначення
• Інтегральною мікросхемою (ІМС) називається мікроелектронний виріб, який виконуєокрему функцію обробки та перетворення сигналу та має високу густину пакування
електрично-з’єднаних елементів та компонентів.
• Головною задачею мікроелектроніки є створення інтегральних мікросхем з мінімальними
розмірами структурних елементів, високим ступенем інтеграції, стабільністю властивостей і
характеристик та високою надійністю.
• Технологія ІМС представляє собою сукупність механічних, фізичних та хімічних способів
обробки напівпровідникових діелектриків та металів, у результаті яких створюється готова
мікросхема.
• Технологічним процесом мікроелектроніки називається процес виготовлення ІМС із
окремих матеріалів та який складається з ряду послідовних технологічних та
конструкторських операцій.
• Технологічна операція - це закінчена частина технологічного процесу, виконана на
одному робочому місці та обладнанні.
• Складовими частинами технологічної операції є переходи та прийоми. У процесі виконання кожної
технологічної операції відбувається формування структури ІМС. Важливим аспектом вдосконалення
технології мікроелектроніки є інтеграція операцій на одному робочому місці.
• Основу технології мікроелектроніки складають процеси трьох напрямків:
• - напівпровідникові - об'єднують процеси формування напівпровідникових структур;
• - плівкові - об'єднують процеси формування плівкових структур;
• - складальні - об'єднують процеси формування закінчених структур інтегральних мікросхем або
закінченої конструкції мікросхеми.
8
9.
• За технологією виготовлення інтегральні мікросхеми поділяються на• напівпровідникові,
• плівкові,
• гібридні.
Активні та пасивні елементи у напівпровідникових мікросхемах (НІМС)
виготовляються одночасно, причому пасивні елементи представляють собою певні області
транзисторів.
Плівкові інтегральні мікросхеми (ПІМС) містять лише пасивні елементи, виготовлені
шляхом плівкових технологій на діелектричній підкладці.
Гібридні мікросхеми (ГІМС) представляють собою вироби, у яких пасивні елементи
виготовлені за плівковими технологіями на діелектричній підкладці, на яку потім монтуються
навісні напівпровідникові активні елементи.
9
10. Класифікація технологічних процесів
За своїм призначенням та місцем у виробництві мікросхем всі операції об’єднуються у
самостійні технологічні процеси, які в свою чергу можуть бути розділені на три групи.
Перша група включає так звані заготовчі процеси. Вони мають за свою мету
виготовлення монокристалічних напівпровідникових злитків з певним видом
провідності та величиною опору Ця група включає в себе також процеси, пов’язані з
розрізанням злитків та пластин, обробку їх поверхні, а також виготовлення елементів
для деталей корпуса. Процеси цієї групи включають також виготовлення діелектричних
підкладок із ситалу, кераміки.
Друга група процесів – оброблююча, об’єднує всі технологічні процеси, пов’язані з
формуванням структури НІМС на групових пластинах. Як відмічалося раніше процеси
включають напівпровідникові (планарні) і плівкові технології. До напівпровідникових
процесів відносяться термічне окислення, дифузія іонна імплантація, епітаксія і різні
типи літографії (фото -, електронна, рентгенівська, іонна - літографія). До плівкових
відносяться процеси такі як нанесення на діелектричну підкладку шарів метала,
діелектриків напівпровідників у вакуумі, термічне розпилення, іонне променеве
розпилення), процеси отримання шарів матеріалів хімічним та електрохімічним
способом, трафаретний друк паст з діелектричними, провідними та резистивними
властивостями.
У третю групу процесів - складально-контрольну – входять розділення групової
пластини на окремі кристали, монтаж кристалів у корпус, приєднання виводів,
герметизація, контроль параметрів, механічні та кліматичні випробування, маркування
та пакування мікросхем.
10
11.
Перша група процесів є заготовчою для другої та третьої . Специфічність методів обробки та
обладнання цієї групи, а також незалежність від конкретної структури мікросхеми робить за мету
передачу її процесів спеціалізованим підприємством не мікроелектронної галузі промисловості.
Третя група процесів також характеризується специфічними методами обробки та обладнання, але
має більш тісний зв’язок з процесами другої групи. У більшості випадків при організації
виробництва процеси третьої групи передаються спеціальним цехам у межах одного підприємства.
Процеси цієї групи враховують типи і структуру інтегральних мікросхем
Найбільш повно особливості структури ІМС та головні ознаки інтегральної технології
відображаються другою групою процесів.
Усі процеси, пов'язані з формуванням структури, поділяються на три класи:
- нанесення шарів різних матеріалів (напівпровідників, діелектриків, металів) на
поверхню напівпровідникових пластин та діелектричних підкладок (епітаксія,
конденсація плівок);
- перерозподіл атомів у об'ємі твердої фази напівпровідника з метою створення
локальних областей з різним типом електропровідності (дифузія, іонне легування);
- вилучення речовин з поверхні локальних областей твердого тіла (фотолітографія,
електронна та іонна літографія, рентгенолітографія).
Незважаючи на різноманітність фізико-хімічних принципів, які лежать в основі процесів цієї групи,
їх об’єднує ряд характерних ознак. Останні вимагають концентрації цих процесів на різних
дільницях одного підприємства. Найбільш важливими з цих ознаки є наступні:
-взаємозв’язок виробничих дільниць, обумовлених циклічністю технологічного процесу
(наприклад, групові пластини не один раз повертаються до наступної обробки на
дільницю літографії, дифузії та ін.);
- обмежений час міжопераційного зберігання групових пластин;
- високі вимоги до виробничої гігієни.
11
12.
1.3. Мiкроклiмат та виробнича гiгiєна.Дуже важливим до забезпечення високого відсотку придатних виробів, а також високої надійності
мікросхем є дотримання стабільних кліматичних умов та виробничої гігієни.
До кліматичних параметрів виробничих приміщень відносять температуру та
вологість, сукупність яких визначає поняття мікроклімату.
За температурно-вологісними параметрами виробничих приміщення поділяються
на три класи:
1 клас - влітку і взимку температура 22 0,5 С, вологість 45%;
2 клас - літом 20 1 С, зимою 23 1 С, вологість 50 5;
3 клас - характерна така ж температура , як і в 2 класі, але з допуском 2 С,
вологість 50 10%,
Із-за високої вологості у приміщенні збільшується ймовірність абсорбції Н2О на технологічних засобах
виробництва та заготовках, що в свою чергу призводить до погіршення параметрів виробів.
Виробнича гігієна – це комплекс технологічних та організаційно-технічних заходів,
спрямованих на забезпечення чистоти повітряного середовища виробничих
приміщень, а також чистоти технологічних середовищ, метою якої є підвищення
якості виробів..
З точки зору виробничої гігієни приміщення характеризуються запиленістю.
Запиленістю повітряного середовища прийнято оцінувати кількість частинок,
розмір яких більше 0,5 мкм, що знаходяться в 1л повітря.
З точки зору запиленості приміщення поділяються на 5 класів.
12
13.
Таблиця1.1Параметри повітряного середовища виробничого приміщення
Клас
приміщення
1
2
3
Кількість
частинок
4
35
350
4
1000
5
3500
Для забезпечення чистоти повітряного середовища підприємства необхідно розміщати в
зелених зонах і далеко від іншого виробництва. Тиск повітря у робочих приміщеннях повинен
бути більше зовнішнього тиску, це не дає можливості попадати повітрю ззовні. Повітря
ззовні подається приміщення попередньо пройшовши очищення. Досягти максимальної
частоти на робочому місці можна користуючись боксами та скафандром.
Бокс – витяжна шафа, в якому повітря циркулює так, що зменшено до мінімуму попадання
у робочу зону повітря, що видихає оператор.
Скафандр ізолює оператора від деталі, з деталлю можна контактувати лише через гумові
рукавиці.
До технологічних середовищ відносять технологічні гази та технологічну воду. Вода
використовується на виробництві для промивки і як розчинник, вона повинна бути
деіонізованою, питомий опір 1-18 мОм*мм. Деіонізована вода практично не містить іонів
водню та ОН.
Високі вимоги пред’являються до технологічних газів та рідин, спеціального одягу
персоналу та технологічної документації. Технологічні гази застосовуються як реагенти а
також для захисту від окислення та корозії. До газів пред’являються спеціальні вимоги, так
13
вміст залишкових молекул повинен не перебільшувати 10-3 -10-4 відсотка, а частинок повинно
14.
Рис. 1.1. Загальний вигляд скафандра:1 — шлюзове вікно; 2 — скло для
спостерігання; 3 — гумові перчатки
14
15. Розділ 2 Технологія напівпровідникових інтегральних мікросхем 2.1.Формування структури напівпровідникових мікросхем
Розділ 2Технологія напівпровідникових інтегральних
мікросхем
2.1.Формування структури напівпровідникових
мікросхем
2.1.1.Вимоги до кремнієвих пластин
• Групова кремнієва заготовка завжди являє собою круглу
плоскопаралельну пластину діаметром до 300 мм та товщиною (в
залежності від діаметра) до 1мм.
• Послідуючі термічні та фотолітографічні обробки для
створення структур МС обумовлюють певні вимоги, які
пред’являються до геометричних та структурних
параметрів пластин:
15
16.
1. Шорсткість поверхні пластини повинна бути не нижче 14б14в класів (Rz=0,05-0,032 мкм).2. Потрібно, щоб пластини мали досконалу кристалічну
решітку як по об’єму, так і в поверхневому шарі.
Так як порушення структури в поверхневому шарі можуть визвати
появу дефектів (дислокацій, дефектів упаковки) у епітаксійному шарі або
змінити фронт дифузії Густина дислокації повинна бути не більше 10 см-2.
3. Прогин пластин повинен бути не більше 8-10 мкм.
Він обумовлюється різницею залишкових напружень на сторонах
пластини і появляється після розрізання злитків на пластини. Приводить
до дифракційних явищ в процесі фотолітографії, а при епітаксії - до
нерівномірного нагрівання пластини.
4. Неплоскостність и неплоскопараллельність (клиновидність)
пластин повинна витримуватись у межах ± 7-10 мкм.
Вплив цих параметрів такий прогину.
16
17.
• 5. Розіорієнтованість поверхні відносно заданоїкристалографічної площини повинна бути не гірше ±1 .
Кристалографічна орієнтація визначає швидкість епітаксії, дифузії,
окислення, травлення, а таким чином, і відтворюємість результатів
при зазначених процесах. Тому перед розрізкою на пластини
монокристалічний злиток повинен бути достатньо чітко
зорієнтований.
• 6. Різнотовщинність пластин в межах партії не повинна
перебільшувати ±(5-8) мкм, а відхилення по діаметру
±0,5мм
ці параметри забезпечують ідентичність геометрії пластин при
багаторазовій обробці їх у газових потоках (епітаксія, дифузія,
окислення). Деякі параметри забезпечують відтворюємість результатів.
Крім цього, ідентичність геометрії пластин полегшує також
автоматизацію подачі та орієнтацію при виконанні деяких операцій.
• 7. Пластини повинні мати технологічні елементи: базовий
зріз та фаску.
• Базовий зріз - указує найвигідніше розташування кристала з точки 17
зору якості розділення пластин, отриманні канавок заданого профілю
18. 2.1.1. Елементи напівпровідникових інтегральних мікросхем
• Всі елементи НІМС виготовляються у єдиномутехнологічному процесі на основі єдиної транзисторної
структури для даного типу.
• У більшості випадків в мікросхемах використовуються
транзистори зі структурою n-p-n+ (колектор – n-типу, база
р-типу, емітер n+-типу.) . Транзистори n-p-n+-типу мають
кращі характеристики, порівняно з транзисторами p-n-pтипу, що обумовлено рядом фізичних та технологічних
факторів. Область емітера має провідність n+, тобто є
сильно легованою донорними домішками. Біполярні
транзистори в деяких випадках виготовляють з декількома
колекторами та емітерами. Площа, яку займає одна
транзисторна структура на поверхні мікросхеми, складає 18
приблизно 0,01- 0,05 мм2.
19.
• Поряд з біполярними транзисторами у мікросхемах,особливо у процесорах, використовують транзистори зі
структурою метал-оксид-напівпровідник (МОН).
• Згадані транзистори за принципом дії відносяться до
польових. НІМС на МОН транзисторах є більш
технологічними, дешевими та компактними порівняно з
аналогічними схемами на біполярних транзисторах.
Геометричні розміри МОН транзисторів менше, ніж у
біполярних, що дозволяє значно підвищити ступінь
інтеграції. Площа, яку займає такий транзистор складає
0,001-0,002 мм2. Транзистори можуть мати n і р канал, який
може бути як індукований так і вбудованим . МОН
транзистори можуть бути використані у якості діодів,
резисторів та конденсаторів.
19
20.
Рисунок 2.1. Елементи напівпровідникових ІМС на базі МОНтранзистора: а) транзистор, б) діод, в) конденсатор
20
21.
Рис. 2.2 Елементи напівпровідникових ІМС на основі біполярноготранзистора: а) транзистор, б) діод, в) резистор
21
22. 2.1.3. Послідовність виготовлення напівпровідникових мікросхем
• Тип структури мікросхеми визначаєтьсянапівпровідниковим
матеріалом,
що
використовується в технології виготовлення
локальних областей, методом ізоляції елементів в
кристалі, типом та структурою транзистора.
Переважна більшість НІМС (90%) виготовляється
на основі кремнію. З цієї причини нами буде
розглянута послідовність виготовлення лише
кремнієвих мікросхем.
22
23.
• Дифузійно-планарна структураРис. 2.3.
структури.
Послідовність
формування
дифузійно-планарної
23



















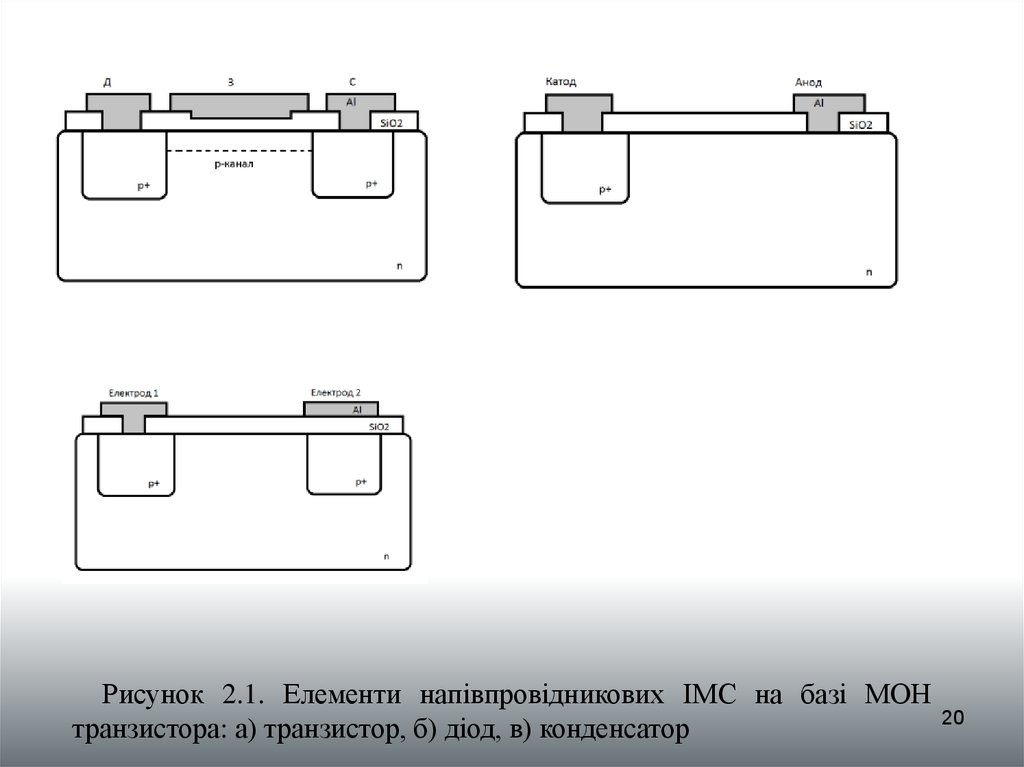


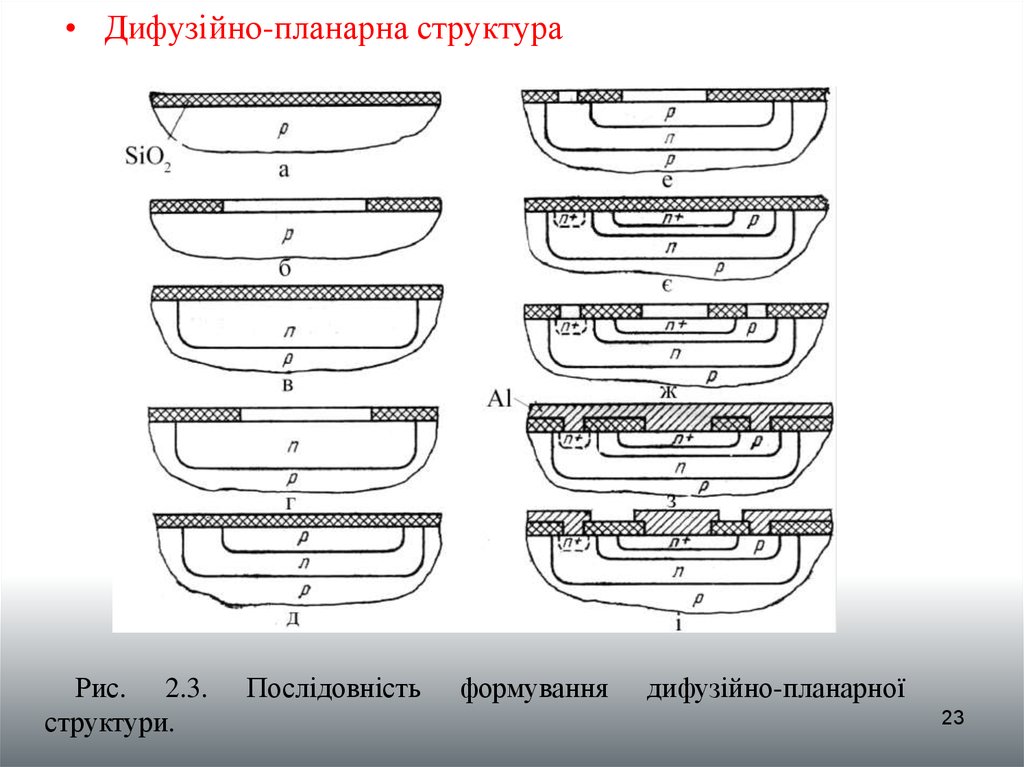
 Электроника
Электроника








