Похожие презентации:
Метод магнетронного распыления
1. Магнетронды тозаңдыру әдісі
Орындағандар:Асқарұлы Абдулғафур
Жумадилов Бауыржан
Кулшиев Халил
Тексерген:
Калкозова Жанар Каниевна
2.
Общие сведения методаМагнетронное
распыление
—
технология
нанесения
тонких
плёнок
на
подложку
с
помощью
катодного
распыления мишени в плазме.
Действие
магнетронного
распылителя
основано на распылении материала мишеникатода при его бомбардировке ионами
рабочего газа, образующимися в плазме
тлеющего разряда. Основные элементы
магнетронной распылительной системы - это
катод,
анод
и
магнитная
система,
предназначенная для локализации плазмы у
поверхности мишени – катода.
На катод подаётся постоянное напряжение от
источника питания. Основные преимущества
магнетронного способа распыления – высокая
скорость нанесение плёнки и точность
воспроизведения
состава
распыляемого
материала.
3.
Технологическая установкаПленки были получены методом
магнетронного
распыления.
В
ходе
эксперимента
использовались
два
магнетрона: верхний и нижний.
Вакуумный универсиалный
пост ВУП-5
4.
Используемые оборудования в ходе экспериментовВакуумметр
ионизационныйтермопарный
ВИТ-2
Контроллер расхода газа
MCV-500SCCM-D
Блок питания постоянного
тока модели
ADL-03Z040
5.
Рисунок 1 – Схема технологиидвух магнетронной системы
1,12 – магниты; 2,13 –
аноды; 3,14 – изолятор; 4 –
графитовая мишень марки
МПГ-6; 5 – подложка; 6 –
подачa рабочего газа; 7 –
откачка газа; 8- заземления, 9водоохлаждения магнетрона,
10 – контроллер расхода газа;
11 – газовая смесь
Ar+H(40%); 15,17 – подача
напряжение, 1*2*3*- число
магнитов
6.
Схема проведения экспериментов по получениюуглеродных пленок
Напыления углерода на кремний
Напыления углерода на кремний с
буферным слоем меди
7.
Процесс напыления углерода на кремниевую подложку8.
Напыления углерода на кремнийНапыления проводилось в атмосфере Аr+H2(40%) и рабочая давления на
камере составило 1*10-2 мм.рт.ст. Скорость потока газа варьировалась 6-8 sccm в
зависимости от давления газа к расходомеру. Растояния от катода до подложки во
всех экспериментах была равна 3 см. Напряжение на нижнем магнетроне
поддерживалось постоянным 500В, в то время как напряжение верхнего магнетрона
варьировалось от 150 до 300 В с шагом 50 В. Пленки напылялись на кремниевые
подложки с ориентациями [100] и [111]. Время напыления 3 часа.
Первая серия экспериментов была проведена с использованием всех трех
магнитов на верхнем магнетроне. Напряжение верхнего магнетрона была от 150 до
300 В с шагом 50 В. Кремниевые подложки с ориентациями [100] и [111].
Вторая серия экспериментов была проведена с использованием двух
магнитов на верхнем магнетроне. Напряжение верхнего магнетрона была от 150 до
300 В с шагом 50 В. Кремниевые подложки с ориентациями [100] и [111].
Третья серия экспериментов была проведена с использованием одного
магнита на верхнем магнетроне. Напряжение верхнего магнетрона была от 150 до
300 В с шагом 50 В. Кремниевые подложки с ориентациями [100] и [111].
9.
Процесс напыления углерода на кремния сбуферным слоем меди
10.
Напыления углерода на кремний сбуферным слоем меди
Напыления проводилось в атмосфере Аr+H2(40%) и робочие давление на
камере составило 10-2 мм.рт.ст. Сначала проводилось напыления буферного слоя
меди в течение 15 мин, затем подложку переместили ко второму нижнему
магнетрону, для напыления углерода на буферный слой меди, весь процесс
напыление проводилось в вакууме. Скорость потока газа варьировалась 6-8 sccm в
зависимости от давления газа к расходомеру. Растояния от катода до подложки во
всех экспериментах была равна 3 см. Напряжение на нижнем магнетроне
поддерживалось постоянным 500В, в то время как напряжение верхнего магнетрона
варьировалось от 150 до 300 В с шагом 50 В. Пленки напылялись на кремниевые
подложки с ориентациями [100] и [111]. Время напыления 3 часа.
Первая серия экспериментов была проведена с использованием всех трех
магнитов на верхнем магнетроне. Напряжение верхнего магнетрона была от 150 до
300 В с шагом 50 В. Кремниевые подложки с ориентациями [100] и [111].
Вторая серия экспериментов была проведена с использованием двух
магнитов на верхнем магнетроне. Напряжение верхнего магнетрона была от 150 до
300 В с шагом 50 В. Кремниевые подложки с ориентациями [100] и [111].
Третья серия экспериментов была проведена с использованием одного
магнита на верхнем магнетроне. Напряжение верхнего магнетрона была от 150 до
300 В с шагом 50 В. Кремниевые подложки с ориентациями [100] и [111]
11.
Молекулалы-сәулелі эпитаксия әдісіМолекулалық-сәулелік эпитаксия (MBE – Molecular Beam Epitaxy) – бұл жоғарғы
вакуум жағдайында материалдарды термиялық тозаңдату әдістемелерінің
жетілдірілген түрі. MBE әдісі берілген қалыңдықтың моноатомдық тегіс
гетероқұрылымдарды және берілген легирлеу профилдарымен бірге өсіруге
мүмкіндік береді. MBE қондырғысында «in situ» атты камерамен үлгілердің өсу
кезіндегі сапасын зерттеуге болады.
MBE әдісінің идеясы8 ші суретте берілген, блок-схемалы технологиялық
қондырғының көмегімен түсіндіруге болады. Атомның немесе молекуланың
ағындары арқасында сұйық буының немесе қатты материалдың,
сублимациясының
эффузиондық ұяшықтар генерацияның (I) зонасында
құралады. Атомның ( молекулалардың) ағындары төсеніштерге жіберіледі,
араласу зонасынан өтіп (II) , және зонаның өсуіне қамалайды, соның нәтижесінде
құрамына керек заттардан үлгі құралады.
12.
MBE қондырғысының бойындағы келесі өсу аймағына кіретінэлементарлықүдерістер (7 суретте):
• Адсорбция (жабысқақ) төсенішке атомдар мен молекулардың құралымдардың
байланысуын қамтыйды;
• Миграция (беттікдиффузия) жабысқақ атомдардың төсеніштің бетінде
диссоциациалану молекулары (ыдырау) байланысады;
• Гетероструктуралардың тұтастық құрамдас бөлігіндеатомдардың түзілуі,
төсеніштіңкристалдық торынанемесе өскелең моноатомдық қабаттың түзілуі;
• Термиялық десорбциялық (үзіп алу) атомдар, кристалдық ауа тартқыштың
түзілмеуі;
• Құрылымдану мен екі еселі өсу кристалдарының төсеніште немесе үстіңгі
қабатында өсуі;
• Кристалдық құрылымдағы өзара атомдардың араласуы [14].
13.
1 – төсеніш, 2 –қабыршақ, 3 – қалқалағыштар,4 – негізгі компонентті эффузиондық ұяшықтар, 5 - легирлеуші қоспаның
эффузиондық ұяшығы; I – молекулалық шоқтарының генерациясыныңаймағы, II –
шоқтардың араласу аймағы, III – төсеніштің кристалдану аймағы
Сурет 7– MBE қондырғының сызбасы [14]
14.
Kaneda және басқалары [15] МВЕ әдісі Si(111) және β-SiC (0001) төсеніштерінде1100 С-ден жоғары төсеніш температурасында SiС стехиометрия қабыршағын алады.
Авторлар стехиометриялық қабыршақтың адатомдар қатынасы Si:С 1:1 болу керек
деген шешім шығарды [17,18].
V. Y. Karasev және басқалар [16] кремний карбиді үлгірлерінМЛЭ әдісімен таза
алмастың қабатында алған. Алынған үлгілердің құрылымын уақыттың шынайы
көлемінде, температураның өзгеруінде Si төсенішімен ағынын бақылауға болады.
Олар уақыттың шынайы көлемінде басқарудың барлық мүмкіндіктерін Si құрылымды
үлглерің алмасты төсеніште өзгеріс температурасын, өсуінің жылдамдығын зерттеді.
Andreas Fissel [18] және оның қызметкерлері гексагональды политипті (ἀ-) және
кубтық (3C-) құрылымды гетероэпитиксалды SiC құрылымының өсуін бақылады. Бұл
жұмыс қаттыфазалы көзді молекулярды-сәулелік эпитаксии әдісі арқылы жасалынды.
Төсеніштерде мынандай құрылымдар алынды 4H/3C/4H-SiC (0001) және 6H/3C/6HSiC (0001) , алғашында бірнеше қабаттың нанометрлерінің 3C-SiC бәсең
температурада (1550) содан температураның көтерілгенде ἀ-SiC жоғарғы қабатының
бөлігінде 3C- SiC ең жоғарғы температурада (1600 К) алынды. Өскеннен кейін көп
аймақтарда, 3C-SiC тұратындар, SiC гексагональды қабатты
материалдыңпластиналары табылды. Нәтижесінде гетероструктурлы өсудің бірнешеуі
белгілі бір 3C-SiC ἀ-SiC нысанға келтіріледі.




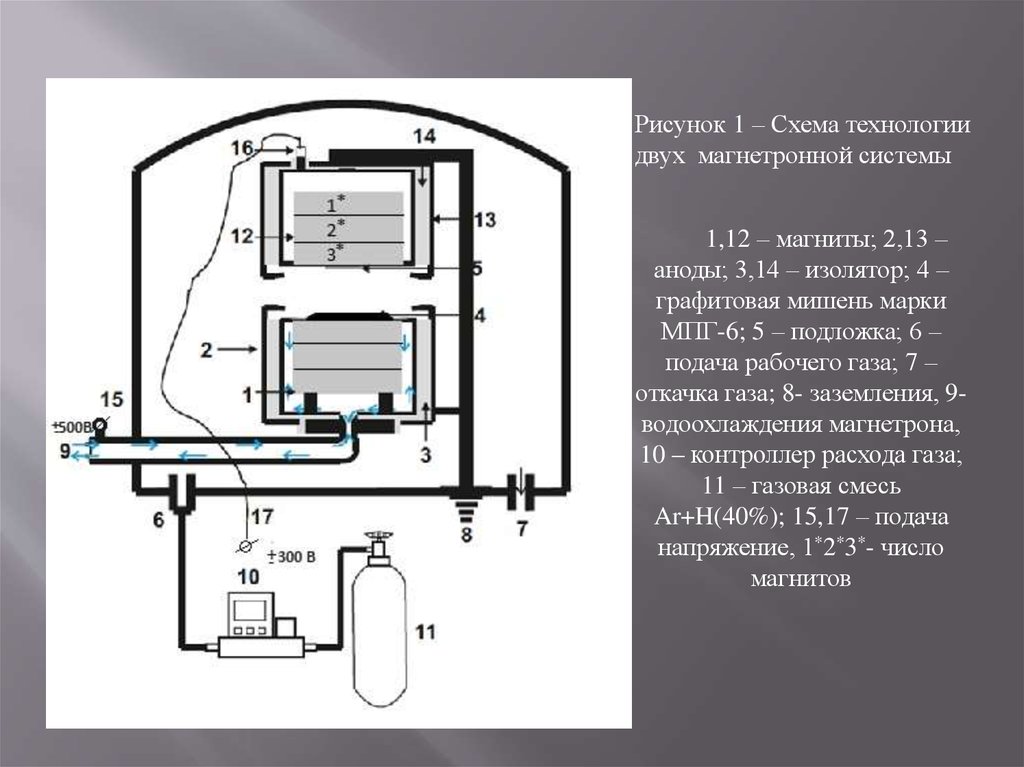







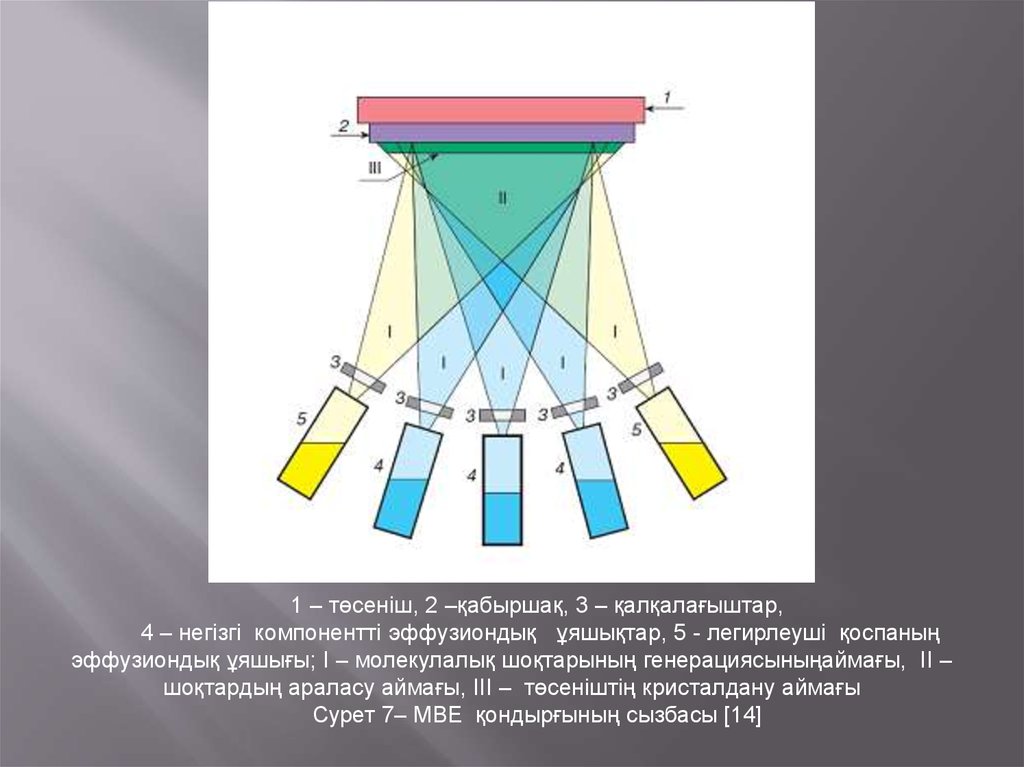

 Промышленность
Промышленность








