Похожие презентации:
Трассировка печатных плат
1.
Трассировка печатных платВопросы - ответы
Москва – Санкт-Петербург
2019
Александр Акулин
2.
Методы повышенияэффективности трассировки
3.
Повышение эффективности трассировки• Единый маршрут проектирования
• Повторяемые модули – повторяемая трассировка,
создавать библиотеку фрагментов
• Авто-трассировщик
• Авто-интерактивная трассировка
• Командное проектирование
• Получение подтверждений на промежуточных этапах
• Использовать горячие кнопки, скрипты, макросы
• Избегать переделок
• Сразу настраивать правила DFM для онлайн-контроля,
чтобы не потребовалось переделывать проект в конце
3
4.
Маршрут проектирования• Создание и ведение единой библиотеки Footprint
– Автоматически – программа PCB Library Expert
• Чистка и верификация схемы и ссылок на футпринты
• Нетлист – обеспечить качество, загрузить
• Создание платы по шаблону
– Конструктив (унифицированные или импорт DXF)
– Цветовые настройки слоёв (унифицированные)
– Стекап типовой (унифицированные)
– Технологические нормы и DFM-правила (унифицированные)
• Расстановка компонентов – группами с автовыделением
по схеме (листы, блоки, «комнаты») автоматически
• Определить правильно количество слоёв, исходя из:
– Габариты
– Применяемые интерфейсы
4
5.
Маршрут проектирования 2• Разработка стека слоёв по единому маршруту
– Питание-земля в центре
– Импеданс и параметры сигналов / дифф.пар
– Изоляция сигналов землями
• Физические константы и электрические правила
– Импеданс
– Типы компонентов, BGA
– Ограничения поставщика PCB
• Конечное размещение компонентов
– DC/DC можно трассировать уже сейчас
• Ожидание подтверждения от всех отделов
• Планирование трассировки – бэндлы, раскраска, план
• Трассировка
– Хитрости, скрипты и методики ускорения – предоставить для всех
5
6.
Маршрут проектирования 3• Порядок трассировки
– Фанаут всех SMD и BGA (хотя бы предварительно)
– Земля – полигоны и SMD
– Сначала память и выравнивание длины
– Сопровождение сигналов полигонами питания
– Скоростные интерфейсы, дифф.пары, потом остальное
• Использовать Auto-Interactive Routing
• Использовать Авто-выравнивание длин и фаз
• Опция командной работы
– запустил долгую операцию и трассируешь другую часть платы
• Использовать автоматизирующие функции
– Авто-Чистка шелкографии
– Авто-Проверки DRC и DFM
– Авто-Разработка чертежей (утилита BluePrint), шаблоны
– Авто-генерация производственных файлов
6
7.
Хитрости трассировки• Трассировка группой сигналов
7
8.
Возможности автотрассировщика SPECCTRA• SPECCTRA встроена в САПР OrCAD Professional и
позволяет делать автотрассировку в окне редактора,
выборочно или полностью
8
9.
Возможности автотрассировщика SPECCTRA• Можно автоматизированно создавать фанаут любых
микросхем и пассивных компонентов,
корректировать и размножать созданный фанаут
9
10.
Возможности автотрассировщика SPECCTRA• Можно выполнить автотрассировку выбранной цепи,
шины или компонента – Route by Pick
10
11.
Чек-лист перед началом трассировки• Настройте режимы Constraint Manager PCB Editor
• Определите классы сигналов, задайте правила
11
12.
Чек-лист перед началом трассировки• Настройте режимы Constraint Manager PCB Editor
• Определите классы сигналов, задайте правила
• Настройте области разрешения и запрета
трассировки – Keep-in и Keep-out
• Добавьте авто-fan-out для подключения трасс
• Задайте слои полигонов земли и питания
• Проведите вручную критические сигналы
12
13.
Чек-лист перед началом трассировки• Настройте области разрешения и запрета
трассировки – Keep-in и Keep-out
• Добавьте авто-fan-out для подключения трасс
• Задайте слои полигонов земли и питания
• Проведите вручную критические сигналы
13
14.
Запуск автотрассировки черезрабочее окно SPECCTRA
• Можно выполнить фанаут в окне SPECCTRA
и запустить автотрассировку всей платы
14
15.
Пост-обработка результатов автотрассировки врабочем окне SPECCTRA
• Можно выполнить дополнительную пост-обработку
• Последовательность операций можно записать в
командный файл и применять его в дальнейшем
15
16.
Пост-обработка результатов автотрассировки вСАПР OrCAD PCB Editor
• Результаты трассировки переданы в САПР OrCAD
• С помощью команды GLOSS мы «причесываем»
трассировку, срезаем или скругляем углы трасс
16
17.
Критерии необходимостиприменения СВЧ-материалов
для 10-гигабитных линий
18.
СВЧ или FR4• Применение FR4 ухудшает глазковую диаграмму, из-за
уменьшения запаса по времени и напряжению
• Необходимо существенно более точное моделирование
– Использование Sigrity
• Необходимо компенсировать неравномерность свойств
диэлектрика
– Наклонная трассировка
– Более короткие линии связи
– Более точное выравнивание длин
– Динамическое выравнивание фазы на каждом повороте
• Необходимо обеспечивать возвратный путь тока
– Система возвратных переходных отверстий
– Контроль возвратных путей и моделирование с реальной землей
• Все нюансы SI/PI становятся крайне важны
– Power-aware модели IBIS, задержки, cross-talk, и др.
18
19.
Трассировка дифф.пар иstitching vias
20.
Дифф.пары и stitching viasво внешних и внутренних слоях
• Рекомендуем моделировать канал в Sigrity
и на основании этого принимать решение
• Избегать cross-talk
– Зависит от расстояния до опорного слоя сверху и снизу
• Избегать помех (особенно внешний слой)
– Однако защитные земли и via защищают слабо, нужно добавлять
внешние экраны
• В принципе stitching via – это способ снижения cross-talk
• Также связывание земель большим количеством vias –
это в принципе хороший способ улучшить Power Integrity
20
21.
Повороты на 45°, а не скругленные22.
Повороты на 45°, а не скругленные повороты• Существенной разницы по качеству SI нет
• Возможны нюансы с выравниванием фазы на повороте
• Резкий сдвиг фазы при повороте на 45° может быть
менее хорош, чем плавный сдвиг фазы при скруглении
• Можно делать трассировку 45° и потом делать автоконвертацию в скругленные
• Скругление может уменьшить длину трассы
• Поворот на 45° может создать небольшой скачок
импеданса, возвратный ток может течь с небольшим
отклонением от тока в углах линии, можно делать
вырезы в полигонах земли в углах поворота.
• Рекомендация – моделировать такие тонкие нюансы
скоростных каналов в Sigrity 3D FEM.
22
23.
Cтруктуры microviaдля HDI-плат с BGA
24.
Cтруктуры microvia для HDI-плат с BGA• Необходимо знать параметры производства
– Aspect Ratio для microvia, для сквозных и для скрытых отверстий
– Гарантийный поясок
– Диаметр площадки внешней и внутренней
– Возможность стековых microvia, заполнения медью, толщины
• При использовании комбинации разных предельно
возможных параметров – уточняйте возможность такого
их сочетания, т.к. каждое усложнение ухудшает
производимость платы
• Типичные рекомендуемые структуры:
– 1+N+1
– 2+N+2
– От завода зависит, где располагать ядра и где препреги
– От завода зависит, как делать внутреннее скрытое отверстие
– Другие типы структур подлежат согласованию
24
25.
Cтруктуры microvia для HDI-плат с BGA• Типовые
25
26.
Cтруктуры microvia для HDI-плат с BGA• 2 цикла прессования
26
27.
Cтруктуры microvia для HDI-плат с BGA• 3 цикла прессования
27
28.
Cтруктуры microvia для HDI-плат с BGA• 4 цикла прессования
28
29.
Cтруктуры microvia для HDI-плат с BGA• Стековые микроотверстия
29
30.
Cтруктуры microvia для HDI-плат с BGA• Структура 3 + Nb + xxx
30
31.
Методы расширения каналовмежду переходными отверстиями
• Квадранты и микроотверстия
31
32.
Методы расширения каналовмежду переходными отверстиями
• Сдвижка via в фанауте
32
33.
Методы расширения каналовмежду переходными отверстиями
• Вынесение via вне микросхемы и регулярный шаблон via
33
34.
Методы расширения каналовмежду переходными отверстиями
• Совместное использование blind/buried vias
и смещение с созданием областей и каналов
34
35.
Методы расширения каналовмежду переходными отверстиями
• Размещение microvia в ряды
Слой 2 с трассами и слой 3
(видны buried via
и свободное пространство
для трассировки в слое 3)
35
36.
Методы расширения каналовмежду переходными отверстиями
• Via-in-pad со смещением, Via-in-pad с выходом в слой 3
36
37.
Методы расширения каналовмежду переходными отверстиями
• Фанаут в слой 2 и 3 с учетом направления трасс в слоях
37
38.
Методы расширения каналовмежду переходными отверстиями
• Фанаут BGA «регионами»
38
39.
Cтруктуры без микроотверстий с BGA 0.35• 8L 0.6mm \ELIC\ 40/50um line\ 0.35mm BGA pitch
39
40.
Планарные трансформаторы41.
Планарные трансформаторы• Важно знать соотношение толщины меди и
зазора/проводника в слое – зависит от завода
• Медь до 6 oz (180 мкм)
• Количество смолы в препреге должно быть достаточным
для заполнения пространств в зазорах
• Свободные поля по возможности заполняйте медью
• Минимальная толщина ламината определяет пробивное
напряжение между обмотками
• Скрытые переходные отверстия – структура зависит от
завода
• Используется полиимид для повышения пробивных
напряжений и рабочей температуры
• Расчёт топологии трансформатора возможен в САПР
электромагнитного моделирования IMST Empire XPU
41
42.
Планарные трансформаторы• Структура платы с медью 180 um
42
43.
Платы на керамической основе44.
Платы на керамической основе• Среди наших поставщиков имеется завод,
ориентированный именно на производство СВЧ-плат
– Керамо-содержащие ламинаты
– Особые технологии травления топологии
– Более жесткие нормы
– Покрытия под СВЧ (в том числе золото по чистой меди)
– Наличие материалов СВЧ на складе
– Высокие цены
• Имеется завод, производящий СВЧ-сборки LTCC (низкотемпературная керамика)
– Между 4 и 5 классом точности
– Разные нюансы СВЧ-технологий
– До 20 слоев керамики
– Не очень низкие потери, к сожалению (сопоставимо с Rogers)
– Возможна приемка заказчика
44
45.
Платы на керамической основе• Hybrid\Depth Control Routing\Embed Copper coin\Im Ag\
RF line +/-1mil
45
46.
Вырезы под кристалл в плате47.
Вырезы под кристалл в платеПроблема с обеспечением без-зазорного габарита этого
выреза, или вытекания препрега в щелях
• Можно обсудить с заводом (зависит от завода):
– Использование препрега с низкой текучестью
– Использование лазера для устранения излишков препрега
– Использование другой технологии формирования выреза,
которая позволит получить более точный размер
– Использование фрезеровки наружу в углах выреза, для
устранения радиусов по углам
– Использовать лазер для формирования выреза
– Еще одна проблема – выход проводника на край выреза
• Оформление требований при заказе платы
– Чертеж с указанием допусков и требований
– Сечение
– Структуру слоёв надо согласовать с заводом заранее
– Метод изготовления надо согласовать с заводом заранее
47
48.
Вырезы под кристалл в плате6L38GHz\edge plating\Depth control routing\Non-plated cavity
bottom\I-Ag
48
49.
Неоднородность толщиныпроводника на внешнем слое
50.
Неоднородность толщины проводника навнешнем слое
Проблема с неоднородной толщиной меди для
многослойной платы с несколькими типами blind via
• Можно обсудить “Button plating”, зависит от завода
– Гальваническая медь только на площадках
• Можно уходить во внутренние слои
• Можно обеспечивать контроль импеданса во внешнем
слое, тем самым толщина меди будет скомпенсирована
подтравом проводников, и негодные платы (по
импедансу) будут отбракованы самим производителем
• Можно снимать излишнюю медь, но нет гарантии, что
после «чистки» толщина по всей поверхности платы
будет строго одинаковой
• Можно избегать микроотверстий на внешнем слое
или уменьшать количество типов микроотверстий
50
51.
Технические основы изготовлениягибко-жестких плат
52.
Технические основы изготовления гибкожестких плат• Имеется отдельный полнодневный семинар по ГЖПП
• Имеется цикл статей на основе стандарта IPC
• Допустимые параметры зависят от завода
• Рекомендации:
– Не более чем 5й класс точности
– Учет пластичности гибкого материала, «уход» размеров
– Учет ломкости на краях гибкого материала, упрочнения
– Не более 16 слоев в жесткой и не более 8 в гибкой части
– Вопрос по перегибу, если в гибкой части более 2 слоев
– Технология «книжный переплет»
– Дополнительные средства повышения надежности переходных
отверстий (капельки, увеличенные площадки и др.)
– Снижение класса точности в гибком слое
– Вопросы импеданса в гибкой части
– Вопрос стыковки гибкой и жесткой части, безадгезивные слои
52
53.
Заполнение via54.
Заполнение viaПараметры токопроводящей, диэлектрической,
теплопроводящей пасты.
Значения пропускаемого тока при заполнении via
токопроводящей пастой или медью.
Разница в стоимости и надежности между заполнением
токопроводящей/теплопроводящей пастой и медным
заполнением
• Зависит от завода
– Диэлектрическая – сопоставима со смолой в препреге
– Руководствоваться типами заполнения по IPC-стандартам
– Токо/теплопроводящая – на основе серебра, зависит от завода
– Большие токи – выгоднее заказать удвоение толщины меди
– Полное медное заполнение – сложно, мало кто может делать
– Можно делать стековые микроотверстия с полным заполнением
– Можно делать «медную монету», встроенную в плату
54
55.
Заполнение via медью и медная монета55
56.
Параметры Backdrilling57.
Параметры BackdrillingЗависит от завода
Как правило, хвостик стакана = 0.15 мм
Как правило, диаметр сверла = диаметр отв +0.25 мм
Стоимость – добавляет 5-15% к стоимости заказа
(а микроотверстия добавляют от 50 до 100%)
Надежность – на высоком уровне (отверстия заполнены
смолой)
57
58.
Параметры BackdrillingПример параметров от завода
58
59.
Пятирядный выводноймезонинный разъем
60.
Пятирядный выводноймезонинный разъем
Есть ли у Вас подходы к их пайке, обеспечивающие
дальнейшую нормальную сборку?
• Паяем паяльником с тонким жалом, опыт
положительный
• Слышали про технологию «колечки припоя», но такого
опыта нет
60
61.
Свежая информация повозможностям производства
62.
Свежая информация по возможностямпроизводства
• Заводы выставляют на сайт слишком крутые параметры,
но постепенно их снижают
– Попытка снизить риски
– Утеря квалифицированных сотрудников
– Износ оборудования
– Экономия на материалах и технологиях
• Некоторые «крутые» параметры сложно сочетать в
одном проекте
• Некоторые параметры на сайте «перепродавца» взяты
от разных заводов-производителей и не могут
использоваться совместно
• Некоторые параметры в принципе несовместимы или
могут противоречить один другому
• Можем дать «технологические» файлы для CAM350,
настроенные на конкретные заводы
62
63.
Разная толщина меди в одном слое64.
Разная толщина меди в одном слоеНапример, одновременно 18мкм для ВЧ-линий, 70мкм для
питания и 35мкм для прочих?
Какие к ним требования, допуски, надежность, сколько
стоит применение таких решений?
• Есть, но, как правило, 2 разных толщины, не 3
• Дорого
• Вполне надежно, серийная технология
• Допуски – зависит от завода, далеко не каждый завод
может такое делать, сложно согласовать, особенно если
заказ небольшой
• Присылайте «пробный заказ», будем пытаться
разместить на заводе, но цена может быть высокая
64
65.
Малый диаметр via и толстая фольга66.
Малый диаметр via и толстая фольгаПри данной толщине фольги нельзя реализовать такое via
по той причине, что у него малый диаметр
металлизированной площадки и при травлении меди
большой толщины получится ситуация, что данная
площадка будет вытравлена целиком
• Надо учитывать трапециевидность сечения меди при
травлении.
• Наклон стенки может быть от 20˚ до 30˚
66
67.
Ширина основания проводника и еговерхней части
68.
Ширина основания проводника и его верхнейчасти
• Очень зависит от завода
• Как правило, трапеция с известным наклоном
• Можно по каждому заводу попытаться получить
информацию, но это зависит не только от толщины
меди, но и от количества циклов металлизации, и от
толщины базовой фольги. Слишком много переменных.
• Зачем нужна эта информация?
• Импеданс рассчитывается и согласовывается с заводом
на этапе запуска.
68
69.
Применение microvia и HDI-структур,но с 5 классом
70.
Применение microvia и HDI-структур, но с 5классом
Что лучше, надежнее, дешевле – повышение класса
точности до 6-7 или применение microvia и HDI-структур,
но с 5 классом?
• Как правило, лучше микровиа и 5й класс – это многие
могут делать
• Есть возможность делать платы с проводниками и
зазорами 50 мкм, но это гораздо дороже, и мало кто
может делать
• Есть возможность делать 38 мкм (во внутренних слоях),
но очень дорого (и минимальный заказ от 8000 USD)
70
71.
Применение microvia и HDI-структур, но с 5классом
Проводники 50/50 мкм
71
72.
Зазор в 0,2мм между отверстием viaи проводниками
73.
Зазор в 0,2мм между отверстием via ипроводниками
Ситуация, когда возник диалог с заводом из-за большой
сложности обеспечения зазора в 0,2мм между отверстием
via и проводниками для платы толщиной 2,65мм, какие
еще есть острые моменты?
• Есть много технологических сложностей и нюансов,
которые надо учитывать. Зазоры – это наиболее острый
момент. Все нюансы описать – это нужна отдельная
книга. Например, неплохая книга Kraig Mitzner.
• Видимо, речь идет про зазор от меди до стакана
отверстия во внутреннем слое. Мы об этом сообщаем на
каждом семинаре.
• Рекомендуем использовать CAM350 с функцией DFMStream для анализа всех потенциальных проблемных
участков в вашем проекте.
• Или использовать САПР Allegro Venture с DFM-анализом.
73
74.
CAM350 - Анализ в пакетном режимеНастраиваемый
Запустите проверку
интерфейс
правил в процессе
Дружелюбный пользовательский интерфейс делает анализ DRC/DFM
обработки проекта, или
пользователя
очень простой задачей
поставьте в очередь
повышает вашу
производительность
74
75.
CAM350 - Редактор правил “DFM-Streams”Добавьте множество
процессов
проверки в
Создайте уникальные
Простое редактирование
очередь,
включая
очистку
маршруты
проверок
в
Создайте
потоки “Streams” для запуска последовательных
процессов
правил через дерево
или
данных,
сравнения,
зависимости
от заводадиалог
проверки
зазоров
и DFM
производителя
или
типа
продукции
75
76.
CAM350 - Просмотр ошибок в 2D или 3DДиаграммы ошибок
позволяют вам легко
фильтровать
результаты
Анализируйте
…или
в реалистичном
ошибкиошибок
или в3D
2D…
Интерактивное
окно
просмотра
делает простым
обзор результатов анализа
76
























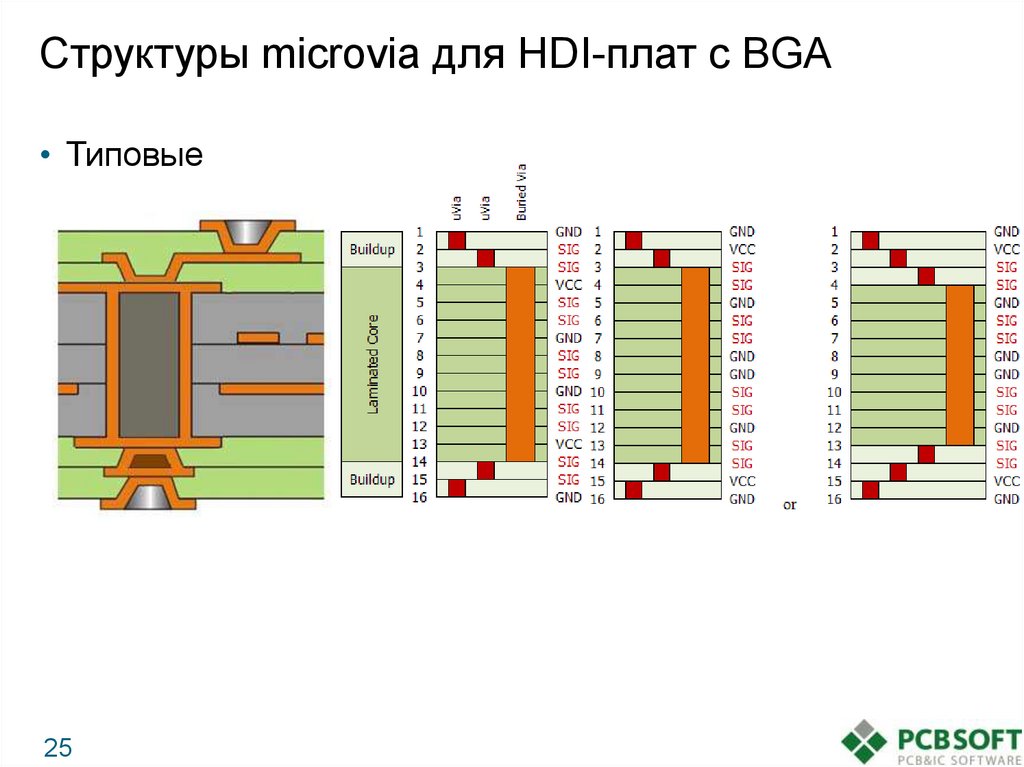



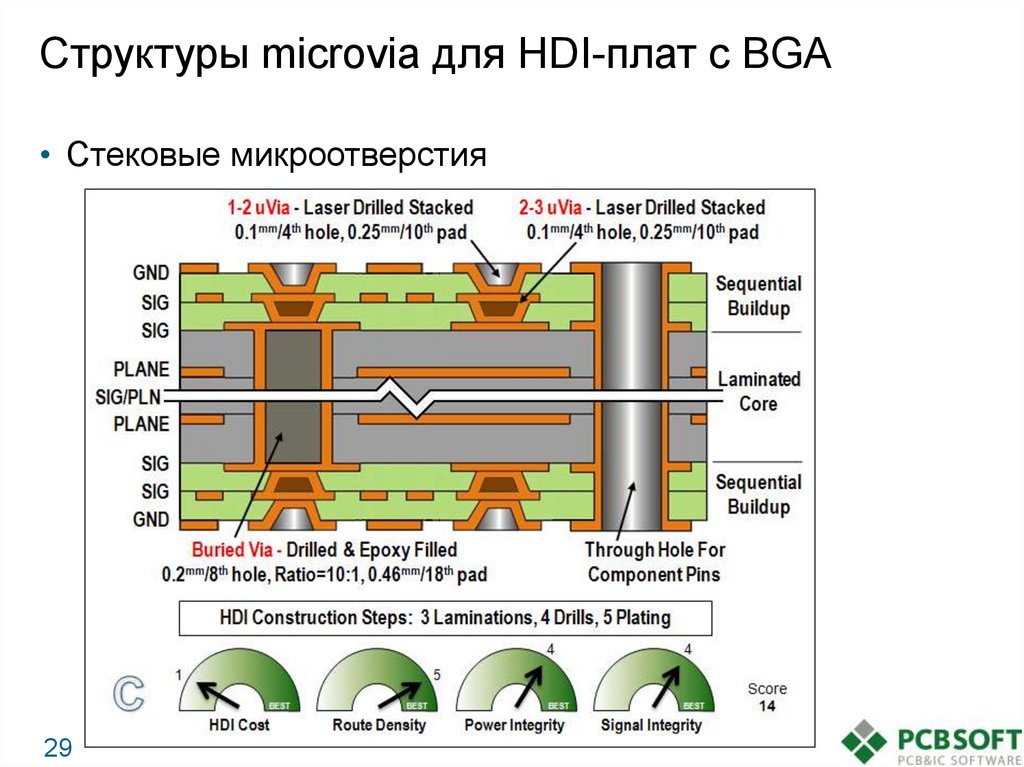



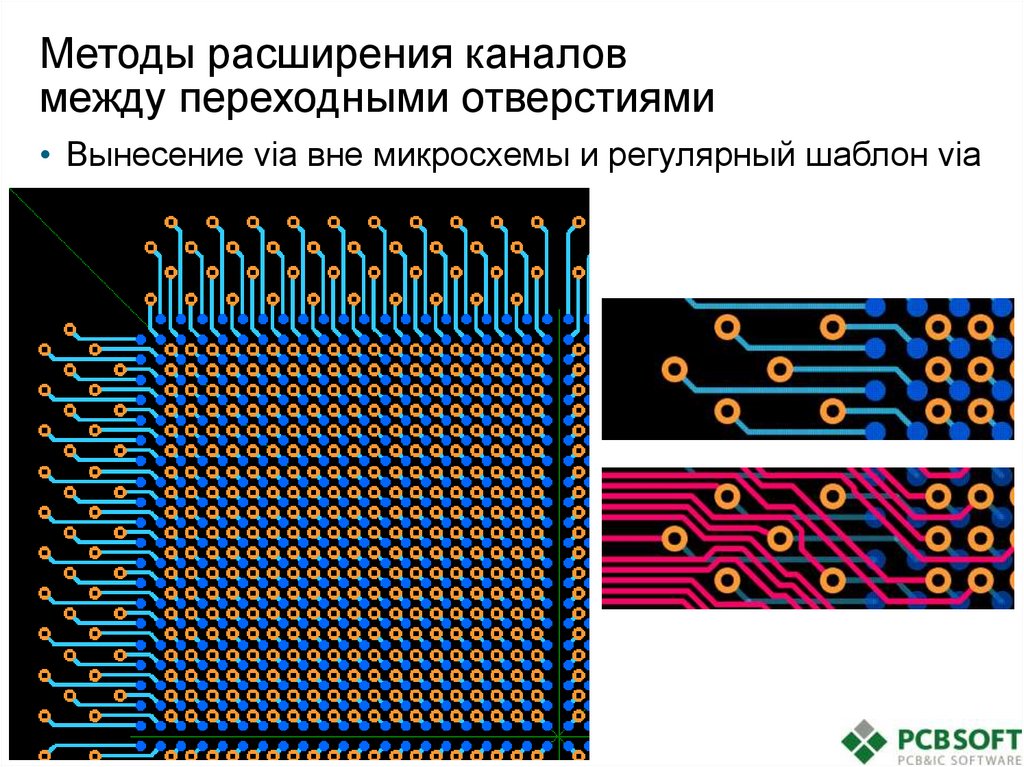
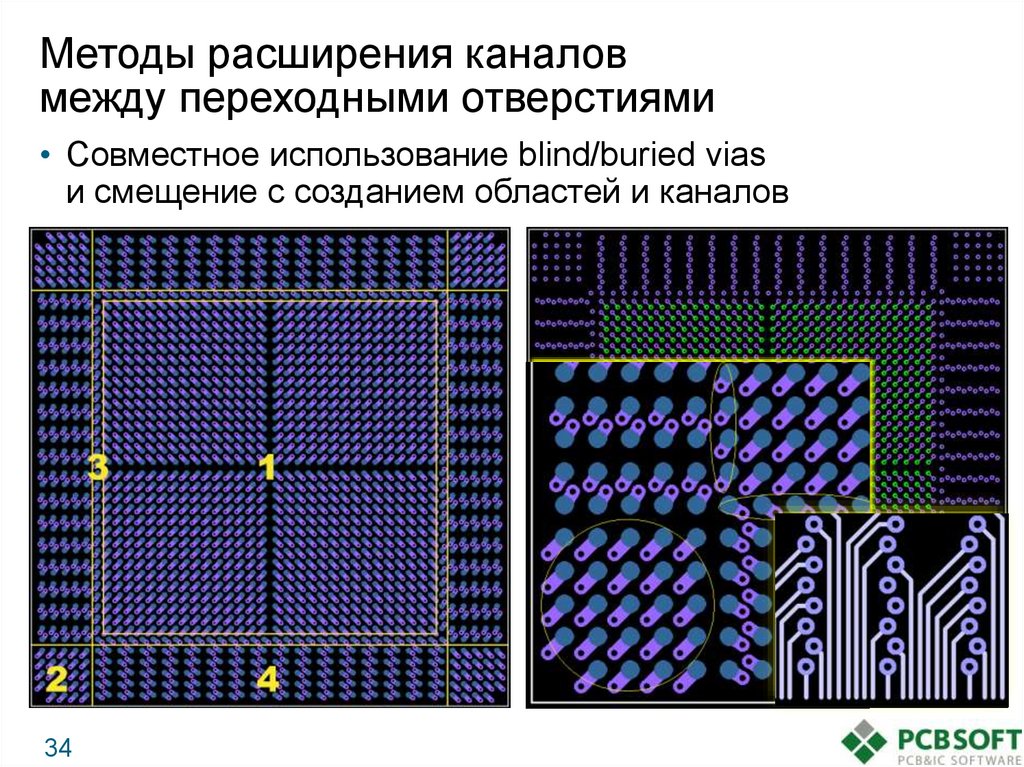










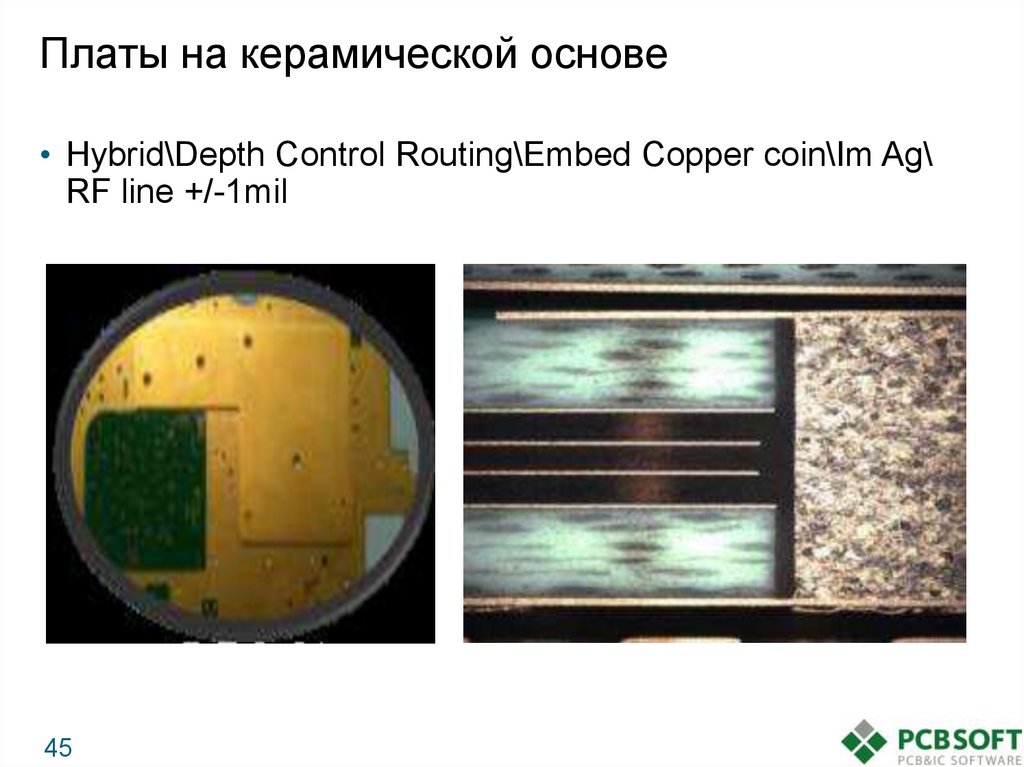
































 Программное обеспечение
Программное обеспечение








