Похожие презентации:
Механические напряжения и деформации в тонких пленках
1. Наномеханика Nanomechanics of materials and systems
Lecture 3Механические напряжения и
деформации в тонких пленках.
Mechanical stresses and strains in thin
films.
2. Деформация сплошной среды Deformation of continuum
Displacement field uR=r+u
Transformation of an object
dR = =F · dr = (R ) · dr = dr · ( R)
dr = F=−1 · dR = (r ) · dR = dR · ( r)
R = R(r)
FT = ( R) = ei∂/∂ri Rj Ej= ∂Rj (r)/∂ri ei Ej
=
F = (R ) = ∂Rj (r)/∂ri Ej ei.= ∂R/∂r
Конечное или
деформированное
состояние
e2
=
e3
dR
R
e1 u
V
u+du
dr
v
r
Исходное
недеформированное
состояние
F
Все функции однозначны, непрерывны и дифференцируемы нужное число раз
3. Тензор малой деформации Infinitesimal strain tensor
u1x1
1
2
1
2
(
(
u1
x2
u1
x3
1
2
u2
x1
u3
x1
(
)
)
1
2
(
u2
x1
u2
x2
u3
x2
u1
x2
u2
x3
12 ( u u ) ( u ) s
kl (
1
2
u
ul
xk
uk
xl
)
)
1
2
(
1
2
(
u3
x1
u2
x3
u3
x3
u1
x3
u3
x2
)
)
тензор деформации - strain tensor
)
тензор дисторсии - deformation gradient
Физический смысл εii – удлинение/укорочение вдоль оси оси i
Физический смысл εij – изменение углов между осями θ/2
4. Тензор вращений Rotation tensor
1 ( u22 x1
0
1 ( u1
2 x2
ux2 )
1 ( u1
2 x3
u1
)
x2
0
1
u3
)
x1
1 ( u3
2 x2
ux2 )
1 ( u3
2 x1
xu1 )
1 ( u2
2 x3
x3 )
3
u
2
0
3
12 ( u u ) u A
u
kl 12 ( x l
k
uk
xl
)
Физический смысл – вращение вокруг мгновенной оси
u
5. Тензор напряжений Коши Cauchy stress tensor
tn n ;нормальные напряжения nn n n; normal stress
касательны е напряжения ns n s; shear stress
ij ei e j t i e j
i, j
6. Закон Гука (Hooke’s law)
C ;( 4)
ij Cijkl kl
uk
ij Cijkl
xl
тензор упругих констант (stiffness tensor)
Cijkl C jikl Cijlk C jilk
кубическая симметрия – 3 независимых константы: c44≠(c11-c12)/2
гексагональная симметрия - 5 независимых констант: c11, c12, c13, c33, c44;
c66=(c11-c12)/2
тетрагональная и тригональная симметрии – 9 независимых констант
ромбическая симметрия – 9 независимых констант
моноклинная симметрия – 13 независимых констант
триклинная симметрия – 21 независимая константа
7. Тензор упругих констант изотропного материала (stiffness tensor for isotropic material)
Модуль Юнга (Young modulus)Коэффициент Пуассона (Poisson ratio)
Модуль сдвига (shear modulus)
G=μ
8. Полная система уравнений статической теории упругости Full system of equations in static elasticity
b 0(3)
( u )
(6)
(4)
S
C
(6)
Unknown (6), (6), u(3)
Boundary conditions u S u 0
or n t n
9. Эпитаксия (Epitaxy)
ГетероэпитаксияГомоэпитаксия
Рассогласование параметров решетки
Lattice mismatch
10. Запрещенная зона и параметры решетки полупроводников
Adapted from V. Keramidas and R. Nahory. Lucent Technologies, Murray Hill, New Jersey, 200111. Правило Вегарда (Vegard’s rule)
Параметр решетки бинарного твердого раствора (сплава) двух материаловс одинаковой стуктурой решетки может быть найден путем линейной
интерполяции между параметрами решетки исходных соединений,
например для твердого раствора Si1-xGex:
12. Примеры полупроводниковых гетероструктур
Причины рассогласование параметров решеткипленки и подложки
13. Причины рассогласование параметров решетки пленки и подложки
Просвечивающая электроннаямикроскопия высокого разрешения
A HRTEM [110] cross-sectional view of a coherent interface that develops with no
interface defects during the epitaxial growth of an Al film on a MgAl2O4(001) substrate.
(After Ruhle, Max-Planck Institut fur Metallforschung, Germany.)
14. Просвечивающая электронная микроскопия высокого разрешения
Собственные и упругие деформацииEigenstrain and elastic strain
u = u + u*, где u* - неупругое (пластическое) смещение
Тензор дисторсии β (distortion tensor)
=
(u u*)
t
t * ( u u*)S
( 4 )C
b 0
Граничные условия u(R)|S = uo(R)
Boundary conditions n . σ = F
=
15. Собственные и упругие деформации Eigenstrain and elastic strain
Собственные напряженияEigenstrain
Film and substrate separated, but with distributed force f acting on the film edge
so that its strain is exactly the mismatch strain. This loading gives rise to an
equi-biaxial state of stress at each material point in the film; such a state of
stress with magnitude σ is illustrated on the right side.
16. Собственные напряжения Eigenstrain
Пленка на недеформируемой подложкеFilm on a rigid substrate
0
33 13 23 0;
11 c11 c12
22 c12 c11
c c
33 12 12
32 0 0
0 0
31
0 0
21
11 22 m ; 12 0;
c12
0
0
c12
0
0
c11 0
0
c44
0
0
0
0
c44
0
0
0
0 11
0 22
0 33
0 2 32
0 2 31
c44 2 21
Материалы с кубической решеткой и ориентацией (001)
σm =Mf εm;
Mf= c11+ c12- 2c122/c11;
ε33= - 2εm c12/c11
17. Пленка на недеформируемой подложке Film on a rigid substrate
Изотропный материалIsotropic material
zz 0; rr ; rr
rr
E
Mf=Ef / (1-ν)
E
rr (1 )
E
18. Изотропный материал Isotropic material
Критерий недеформируемости подложкиCriterion for the rigid substrate assumption
19. Критерий недеформируемости подложки Criterion for the rigid substrate assumption
Рентгеновская дифракция на упруго-напряженных пленкахX-ray diffraction in strained films
(m)
11
(m)
22
m
m
Mf
,
(m)
33
2 f
1 f
m
2 f
Ef
m
Материалы с кубической решеткой и ориентацией (001)
σm =Mf εm;
Mf= c11+ c12- 2c122 /c11;
ε33= - 2εm c12/c11
20. Рентгеновская дифракция на упруго-напряженных пленках X-ray diffraction in strained films
Наряженная пленка на деформируемой подложкеStressed film on a deformable substrate
In the upper diagram, the elastic mismatch is maintained by externally applied
traction of magnitude σm; there is no interaction between the film and substrate in
this condition and the substrate is unrestrained. If the externally applied traction is
relaxed, the mismatch strain in the film induces a curvature in the substrate as
shown in the lower diagram.
21. Пленка и подложка с кубической симметрией с ориентацией {001}
Деформации в пленке и подложкеStrain in a film/substrate sandwich
Если деформации зависят только от z: ε = ε(z)
0
t
2
z 2
( ij *ij ) 0;
then
i, j x, y
ij *ij aij zbij
Для подложки *ij 0 ( substrate)
Для пленки *ij 0 ( film )
22. Наряженная пленка на деформируемой подложке Stressed film on a deformable substrate
Формула Стони (Stoney formula)Граничные условия на поверхности σkz=0 и условия равенства нулю
равнодействующей силы и момента.
Net force and torque must be zero for equilibrium.
Для изотропной среды:
В случае тонкой пленки на толстой подложке
hs / 2
M
s
hs / 2
hs / 2
z dz f ; M s 0 z h
hs / 2
0
s
/2
M f mh f ; 0
3 hs / 2
z
zM
z
dz
fh
/
2
;
M
s
0
s
s
3
hs / 2
M f hf
M s hs
M f m h f hs / 2;
hs / 2
-обратный радиус кривизны структуры
-curvature (Stoney formula)
m
6M f h f
2
s s
Mh
m
23. Деформации в пленке и подложке Strain in a film/substrate sandwich
Упругие деформации в пленке и подложкеThe distribution of normalized strain εrr=εm versus normalized distance z/hs across the
thickness of a substrate-film system for three values of the ratio hf/hs. The neutral
plane of the substrate is located by the value of z at which εrr/εm = 0. The material
properties are such that Mf/Ms = 1.
24. Формула Стони (Stoney formula)
Точность формулы СтониAccuracy of Stoney formula
M s ( 0 z ) for 12 hs z 12 hs
rr
1
1
M
(
z
)
for
h
z
f
0
m
s
2
2 hs h f
25. Multi-beam optical stress sensor
Экспериментальное определение кривизны структурExperimental study of curvature
• Лазерное сканирование поверхности (Laser scanning)
• Многолучевое оптическое отражение (Multibeam
optical reflection)
• Отражение изображения светлой сетки (Grid
reflection)
• Изменение картины интерференции (Optical
interference fringes)
26. Упругие деформации в пленке и подложке
Scanning laser method2θ
Используется для in-situ мониторинга деформаций при наращивании
пленок, например, при MBE и MOCVD.
27. Точность формулы Стони Accuracy of Stoney formula
Многослойные структурыMultilayer structures
To 1-rst order in the small parameters hi/hs, the total curvature
is equal to the simple sum of the curvatures that would be
induced if each individual layer would be deposited by itself
on the substrate. Each individual curvature κSt;i is given by the
Stoney formula.
28. Экспериментальное определение кривизны структур Experimental study of curvature
Влияние анизотропии на деформацииAnisotropy in curvature
29. Scanning laser method
Область геометрически-нелинейных деформацийGeometrically nonlinear deformations
2
ds dr ( w dr )
2
Вращения, вызванные изгибом с вертикальным смещением
w(r), могут быть не малы, даже если деформации малы.
Stoney formula: w’(R) = κR and εo = 1/6 κ∙hs
~1
В выражение для деформации надо добавить член второго
порядка малости, связанный с вращениями. Членами второго
порядка малости, связанными с растяжением-сжатием,
пренебрегаем.
30. Grid reflection method
Изменение кривизны по площадиVariation of curvature
Experimentally observed and numerically estimated variation of curvature
as a function of radial position, measured from the center of a Si substrate
with a W film deposit. After Finot et al. (1997).
31. Coherent gradient sensor method
Bifurcation in equilibrium shapeExample:
graphite-polyimide laminate
Требование минимума упругой энергии приводит к
R – radius of the wafer
32. Многослойные структуры Multilayer structures
Экспериментальное определение упругих деформацийв пленках
Experimental determination of strain in films
• Измерения параметра решетки пленок по
рентгеновской дифракции
X-ray diffraction
• Измерения кривизны структур
Optical measurements of curvature
• Микро-Рамановская спектроскопия
Micro-Raman scattering
• Просвечивающая электронная микроскопия
Transmission electron microscopy
• Изменение энергий электронных состояний
Change in electronic states
33. Влияние анизотропии на деформации Anisotropy in curvature
Raman intensity (arb. units)Микро-Рамановская спектроскопия
Micro-Raman scattering
Olympus microscope
Lateral mapping
SiN
GaN buffer
sapphire
Confocal measurements
A1(LO)
1000
E1(TO)
100
A1(TO)
10
0
12
24
36
48
60
Lateral shift across SiN mask (mm)
2.7
DwE2 (cm-1)
SiN
GaN
8mm SiN stripes and 4mm windows
grooves
10000
E2(high)
2.6
2.5
569.7
SiN
GaN
SiN
GaN buffer
sapphire
wE2 (cm-1)
569.6
569.5
569.4
569.3
569.2
0
5
10
15
20
Shift of focal plane (mm)
25
30
34. Область геометрически-нелинейных деформаций Geometrically nonlinear deformations
Просвечивающая электронная микроскопияTransmission electron microscopy
Численный анализ электронномкроскопических изображений
позволяет построить поле
смещений.
Strain mapping into a uniaxial
45 nm strained channel pinched
between Si80Ge20 source and
drain. Simulation is on the left
and experiment on the right.
Courtesy of CEMES-CNRS,
Toulouse, France
35. Изменение кривизны по площади Variation of curvature
Изменение энергий электронных состоянийChange in energy of electronic states
36. Bifurcation in equilibrium shape
Домашнее задание (Homework) 3Пленка Ge толщиной 4 нм выращена эпитаксиально на подложке Si
толщиной 400 мкм с ориентацией (111).
Epitaxial 4nm Ge film was grown on 400μm Si (111) substrate.
Определить (determine):
1) Тензоры напряжений и деформаций в пленке в предположении, что
подложка не деформируется. and , for rigid substrate
2) Радиус кривизны структуры по формуле Стони. Stoney curvature.
3) Тензоры напряжений и деформаций в пленке и в подложке с учетом
кривизны. Stress and strain tensors in the structure with curvature.
5.658












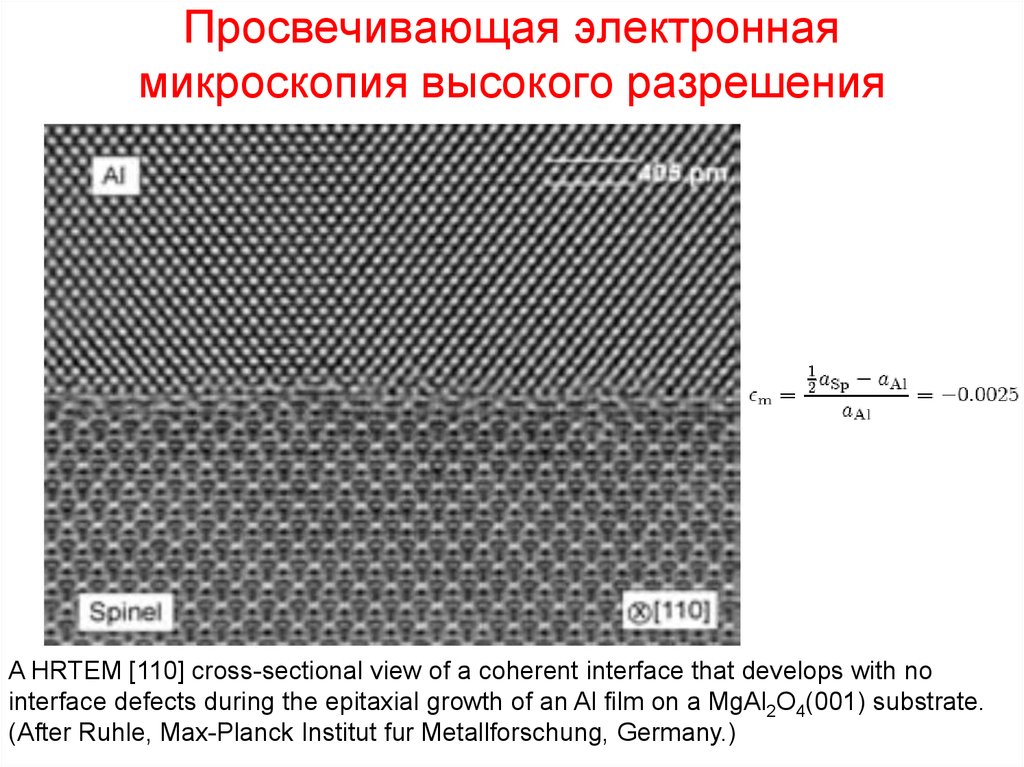

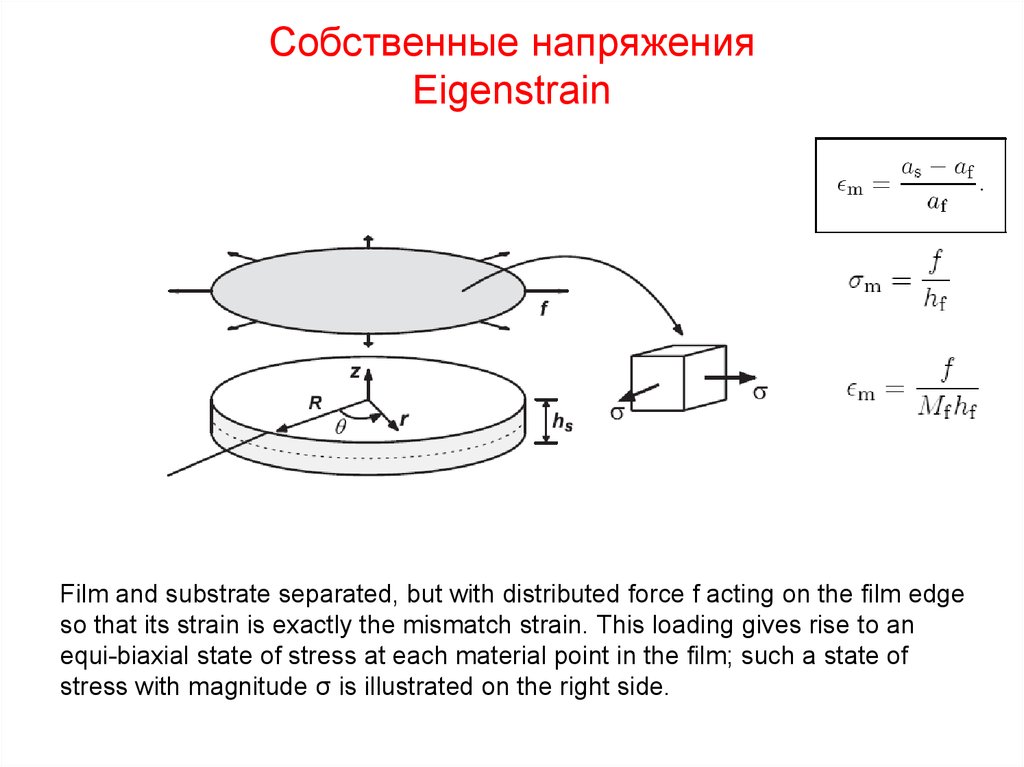





















 Физика
Физика








