Похожие презентации:
Біполярні транзистори
1. ОСНОВИ МІКРО- і НАНОЕЛЕКТРОНІКИ Лекція 07 Біполярні транзистори
Анатолій ЄвтухІнститут високих технологій
Київського національного університету імені Тараса Шевченка
2. Статичні характеристики. Вольт-амперні характеристики
Умовне позначення і назвиелементів біполярного
транзистора. а) p-n-p- транзистор;
б) n-p-n– транзистор.
Три схеми включення p-n-pтранзистора. а- схема зі спільною
базою; б- схема зі спільним
емітером; в- схема зі спільним
колектором.
3. Вольт-амперні характеристики
Статичні характеристикитранзистора можна безпосередньо
отримати із теорії p-n переходу.
Вважаємо, що ВАХ емітерного і
колекторного переходів
відповідають рівнянням
ідеального діода.
Нехтуємо:
- ефектами обумовленими
поверхневою рекомбінацієюгенерацією;
- послідовним опором;
-високим рівнем інжекції.
Біполярний транзистор p-n-p- типу, включений по схемі зі спільною базою(а), профіль
легування транзистора зі ступінчатим розподілом домішок (б) і зонна діаграма при
нормальній роботі (в).
4. Вольт-амперні характеристики
Із рівняння неперервності і рівняння для густини струмів визначаютьсярівноважні характеристики. Для нейтральної області бази маємо:
0
p pB
B
2 p
DB 2 .
x
J p qDB
p
,
x
J n J tot qDB
p
.
x
де pB- рівноважна густина неосновних носіїв в базі; Jtot- повна густина струмів
провідності; B- час життя неосновних носіїв; DB- коефіцієнт дифузії.
Залежність повного емітерного струму від прикладеної напруги:
I E AJ p ( x 0) AJ n ( x xE ) A( qDB
Aq
p
x
x 0 ) A( qDE
n
x
x xE
)
qV
DB pB
W
qV
1
D n
qV
cth( )[(exp( EB ) 1)
(exp( CB ) 1)] Aq E E (exp( EB ) 1).
W
LB
LB
kT
kT
LE
kT
ch( )
LB
LB DB B - дифузійна довжина дірок в базі;
LE DE E
LC DC C
- дифузійна довжина електронів в емітері;
- дифузійна довжина електронів в колекторі.
5. Вольт-амперні характеристики
Залежність повного колекторного струму від прикладеної напруги:I C AJ p ( x W ) AJ n ( x xC ) A( qDB
Aq
DB p B
LB
p
x
x W
) A( qDC
n
x
x xC
)
qV
D n
qV
qV
1
W
[(exp( EB ) 1) cth( )(exp( CB ) 1)] Aq C C (exp( CB ) 1).
W
kT
LB
kT
LC
kT
sh( )
LB
Струм бази:
I B I E IC .
6.
Нерівномірний розподілдомішки в базі.
Транзистор з подібним розподілом
домішки- дрейфовий транзистор,
оскільки в його базу вбудоване
електричне поле, що прискорює дрейф
дірок. В цьому випадку повний струм
колектора матиме вид
qVEB
I C I 1exp(
) I2.
kT
I1
qADB ni2
W
.
N ( x)dx
0
Профіль легування транзистора з
градієнтом концентрації домішки в
базі.
де I2 - струм насичення.
Кількість домішки на одиницю площі
бази- число Гумеля.
W
Qb N ( x)dx
0
q
ADB ni2 .
I1
Для Si біполярних транзисторів число
лежить Гумеля в діапазоні 1012-1013 см-2.
7.
Типова характеристика базовогоструму.
Можна виділити чотири ділянки:
1) область малих струмів, де базовий
струм змінюється по закону
exp(qVEB/mkT) з m 2;
2) область ідеальної поведінки;
3) область середнього рівня інжекції,
характерна значним спадом
напруги на опорі бази;
4) область високого рівня інжекції.
Для зменшення опору бази і
послабшення ефектів обумовлених
високим рівнем інжекції, необхідно
змінити профіль легування бази і
конструкцію самого транзистора.
Залежність колекторного і базового
струму від напруги емітер-база.
Для покращення характеристик в області
малих струмів необхідно зменшити
густину пасток в збідненій області і на
поверхні напівпровідника.
8. Коефіцієнт підсилення струму
Коефіцієнт підсилення струму в схемі зі спільною базою 0 .(в гібридній системі параметрів чотириполюсника позначається як hFB).
0 hFB
I pE
I E
ефективність емітера .
I C I pE I pC I C
.
I E
I E I pE I pC
I pC
I pE
коефіцієнт переносу в базі Т.
I C
коефіцієнт помноження колектора М.
I pC
0 T M T .
Коефіцієнт підсилення струму в схемі зі спільним емітером 0.
(в гібридній системі параметрів чотириполюсника позначається як hFE).
0 hFE
I C
.
I B
9.
Оскільки IB=IE-IC, то0
0
.
1 0
0- близький до 1.
0- значно більший одиниці.
При нормальній роботі p-n-p транзистора VEB>0 і VCB<<0. У виразах для струму
нехтуємо VCB. В цьому випадку справедливі наступні співвідношення:
Приріст діркового струму із емітера
= --------------------------------------------------Приріст загального емітерного струму.
AJ p ( x 0)
Приріст діркового струму, що досяг колектора
T= -----------------------------------------------------------Приріст діркового струму із емітера
J p (x W )
1
W2
T
1 2 .
W
J p ( x 0)
2 LB
ch( )
LB
J E
[1
n E DE LB
W
th( )] 1 .
p B D B LE
LB
<1
T<1
Величини, що доповнюють і T до 1, пропорційні електронному струму, що
витікає з базового контакту.
В біполярному транзисторі з шириною бази 0.1LB, T>0.995 і 0 повністю визначається .
10.
Якщо Т близький до 1, то:0 hFE
1
pB DB I E
W
p 1
NE
N
cth( ) B ( )
E.
LE DE LB
LB
nE W
N BW
Qb
Залежність
коефіцієнту
підсилення
транзистора
(на
частоті 5 ГГц) від дози домішки
імплантованої в базу.
11.
hFEКоефіцієнт підсилення по струму в загальному випадку залежить від струму
колектора.
При дуже малих струмах колектора
вклад
рекомбінаційно-генераційного
струму в збідненій області емітера і
поверхневих струмів витоку може
перевищувати корисний дифузійний
струм неосновних носіїв в базі.
Відповідно, ефективність емітера є
низькою.
hFE
I C
exp( qVEB / kT )
qV
1
exp[ EB (1 )] ( I C )1 1 / m .
I B exp( qVEB / mkT)
kT
m
Залежність коефіцієнту
підсилення транзистора від
струму колектора.
Зниження кількості об’ємних і поверхневих пасток приводить до збільшення hFE при
низьких рівнях струму..
Коли величина базового струму попадає в інтервал, що відповідає ідеальній
поведінці, hFE досягає області максимальних значень.
12. hFE
При подальшому збільшенні колекторного струму густина неосновних носіївінжектованих в базу наближається до вихідної густини основних носіїв (умова
високого рівня інжекції).
Інжектовані носії визивають підвищення густини основних носіїв в базі, що в свою
чергу призводить до зниження ефективності емітера.
Зменшення коефіцієнту підсилення при збільшенні IC - ефект Вебстера.
При високому рівні інжекції:
hFE
I C exp( qVEB / 2kT )
exp( qVEB / 2kT ) ( I C ) 1 .
I B
exp( qVEB / kT )
0 hFE
1
pB DB I E
W
p 1
NE
N
cth( ) B ( )
E.
LE DE LB
LB
nE W
N BW
Qb
Щоб мати великий коефіцієнт підсилення hFE, ступінь легування емітера повинна
бути в багато разів вищою, ніж ступінь легування бази, тобто NE/NB>>1.
Однак при дуже високій концентрації домішки в емітері починають проявлятися ефект
звуження ширини забороненої зони і ефект оже-рекомбінації. Обидва визивають
зменшення hFE.
13. Ефект звуження ширини забороненої зони
Звуження ширини забороненої зони в сильнолегованому кремнії пов’язано з підвищенням
енергії електростатичної взаємодії основних
і неосновних носіїв.
3q 2 q 2 N E 1 / 2
E g
(
)
16 s s kT
При кімнатній температурі звуження зони
описується формулою
Eg 22.5( N E / 1018 )1/ 2 , [meV ]
Густина власних носіїв в емітері
niE2 N C NV exp[ ( E g E g ) / kT ] ni2 exp( E g / kT ).
0 hFE
1
ni2
pB
.
NB
pB DB I E
W
p 1
NE
N
cth( ) B ( )
E.
LE DE LB
LB
nE W
N BW
Qb
niE2
ni2
nE
exp( E g / kT ).
NE NE
Звуження ширини забороненої
зони в кремнії.
hFE
pB
exp( E g / kT ).
nE
Оскільки Eg зростає з концентрацією
легування, то коефіцієнт підсилення по
струму падає
14. Ефект оже-рекомбінації
Оже-рекомбінація полягає у взаємному знищенніелектрона і дірки, яке супроводжується
передачею енергії іншій вільній дірці.
Такий процес, що протікає при участі двох
дірок і одного електрона, можливий при
інжекції електронів у високолеговану p+
область. Такою областю є емітер p+-n-p
транзистора.
Оже-рекомбінація – процес протилежний
лавинному помноженню.
Час життя при оже-рекомбінації
Залежність коефіцієнта підсилення
A
транзистора від струму колектора.
1
.
Gp p2
де p- концентрація основних носіїв, Gpшвидкість рекомбінації.
(Gp=(1-2)x10-31
см6/с
кімнатній температурі)
для
Si
при
а- врахування лише генерації ШХР;
б- врахування генерації ШХР і звуження
ширини забороненої зони;
в- врахування генерації ШХР, звуження
ширини забороненої зони і ожерекомбінації;
г- експериментальні результати.
15.
Аналогічно протікає рекомбінація в високолегованій n+ області приучасті двох електронів і однієї дірки з характерним часом життя
A
1
.
Gn n 2
Час життя електронів (неосновних носіїв) в p- емітері визначається формулою
1
1
p
1
A
,
де p -час життя, обумовлений рекомбінацією типу типу Са-Нойса-Шоклі
При збільшенні концентрації носіїв оже-рекомбінація
стає домінуючою і визиває зменшення часу життя
неосновних носіїв в емітері. В свою чергу це приводить
до скорочення дифузійної довжини LE, що знижує
ефективність емітера.
AJ p ( x 0)
J E
n E DE LB
W 1
[1
th( )] .
p B D B LE
LB
16.
Ефект КіркаВ сучасних біполярних транзисторах зі
слабо легованим епітаксійним колектором
на коефіцієнт підсилення впливає зміщення
під дією великих струмів області з високим
електричним полем з точки А в точку В.
В результаті ефективна ширина бази зростає
відWB до (WB+WC). Це явище отримало
назву ефект Кірка. Воно приводить до
збільшення числа Гумеля в базі Qb і до
зниження hFE.
Профіль легування n-p-n -транзистора
з епітаксійним колектором.
17. Вихідні характеристики
Струми на виході транзистора зв’язані з розподілом неосновних носіїв в області бази. Увипадку транзистора з високою ефективністю емітера в формулах для IE, IC залишаються
лише члени пропорційні градієнту неосновних носіїв (dp/dx) при x=0 і x=W відповідно.
Основні співвідношення в транзисторі можна сформулювати наступним чином.
1. Прикладені напруги задають густини струмів неосновних носіїв на границях
областей за допомогою фактора exp(qV/kT).
2. Емітерний і колекторний струми пропорційні градієнтам густини неосновних носіїв
(дірок) на границях переходів, тобто при x=0 і x=W.
3. Базовий струм дорівнює різниці між емітер ним і колекторним струмами.
За допомогою цих графіків можна пояснити статичні вольт-амперні характеристики транзисторів.
Розподіл густини дірок в базі p-n-p
транзистора при різних прикладених
напругах. а- нормальне включення:
VCB=const, VEB- змінна; б- нормальне
включення: VEB=const, VCB- змінна; в- VEBпозитивне, VCB=0; г- обидва переходи
зміщені в прямому напрямку; дврахування струмів ICO і ICO’; е- обидва
переходи зміщені в оберненому напрямку.
За допомогою цих графіків можна
пояснити
статичні
вольт-амперні
характеристики транзисторів.
18. Вихідні характеристики
Для даного транзистора емітерний струм IEі колекторний струм IC є функціями
прикладених напруг VEB і VCB, тобто
IE=f1(VEB, VCB) і IC=f2(VEB, VCB).
В схемі з спільною базою колекторний
струм практично рівний емітерному
струму ( 0=1) і фактично не залежить від
VCB
Вихідні характеристики транзистора.
а- в схемі зі спільною базою; б- в схемі зі
спільним емітером.
19.
В схемі зі спільним емітером зі збільшенням VCE ширина бази W зменшується іспостерігається збільшення 0. Відсутність насичення вихідних характеристик
транзистора в схемі зі спільним емітером обумовлено значним збільшенням 0 з
ростом VCE. Цей факт отримав назву ефекту Ерлі.
0 hFE
1
pB DB I E
W
p 1
NE
N
cth( ) B ( )
E.
LE DE LB
LB
nE W
N BW
Qb
В транзисторі з шириною бази набагато більшою розміру збідненої області в базі
напруга Ерлі дорівнює
VA
qN BWB2
s
.
20. НВЧ-транзистори
Для покращення високочастотних властивостейтранзисторів мають бути суттєво зменшені
розміри активних областей і значення паразитних
параметрів.
Задача зменшення двох критичних параметрів
дискретних транзисторів:
- ширини емітерної смушка;
- товщини шару бази.
Транзистор зі смужковою
геометрією електродів.
Зменшення вертикальних розмірів в основному
зобов’язане розвитку дифузійних процесів і іонної
імплантації.
Зменшення горизонтальних розмірів зобов’язане
успіхам літографії.
За
рахунок
топології
транзистора
досягаються необхідні струмові параметри. Для цього
варіюється кількість смушкових областей емітера і
контактів до бази.
За допомогою зміни профілю легування
досягаються необхідні частотні властивості і
прийнятні пробивні напруги.
21.
Оскільки рухливість електронів в кремнії більша рухливості дірок, то всікремнієві НВЧ-транзистори – прилади n-p-n типу. Для зменшення послідовного
колекторного опору в якості підкладки використовують епітаксій ну n-n+
структуру.
Задачі:
Мінімізувати (а) дефекти упаковки (окислення), (б) дислокації (епітаксія).
Дифузійні трубки (а)
і дифузійні виступи
(б) в базі вздовж
дислокацій.
22. Частота відсічки
Частота відсічки fT є найбільш важливим показником якості НВЧ-транзистора.Визначається як частота, на якій коефіцієнт підсилення по струму
I
в режимі короткого замикання схеми зі спільним емітером дорівнює 1. hFE C
I B
Частота відсічки зв’язана з фізичною структурою транзистора через час затримки
носіїв, що пролітають від емітера до колектора, ec:
fT
1
ec
.
Час
затримки ec є сума чотирьох часів затримки, які характеризують послідовні
дорівнює 1.
фази руху носіїв від емітера до колектора:
ec E B C C' .
E- час зарядки збідненого шару емітера, визначається виразом:
E re (C e C c C p )
kT
(C e C c C p ),
qI E
де re - опір емітера; Ce- ємність емітера; Cc- ємність колектора; Cp - інші паразитні
ємності пов’язані з базовим виводом; IE- емітерний струм, який приблизно рівний
колекторному струму.
23. Частота відсічки
Друга складова часу затримки являє собою час прольоту через шар бази і дорівнює:W2
B
,
D B
де =2 для випадку рівномірного легування бази.
У випадку нерівномірного розподілу домішки в базі, як в дрейфовому транзисторі,
коефіцієнт має бути збільшеним
Якщо вбудоване поле Ebi постійне, то коефіцієнт приймає значення
2[1 (
bi 3 / 2
) ],
0
де E0=2DB/ BW. При Ebi/E0 =10 60, тобто за рахунок великого вбудованого поля
досягається значне зменшення B.
Третя складова часу затримки пов’язана з прольотом носіїв через збіднений шар
колектора:
C
xC W
,
2v s
де vs - гранична швидкість носіїв в колекторі.
24. Частота відсічки
Четверта компонента затримки обумовлена часом, протягом якого заряджаєтьсязбіднена ємність колектора:
C' rc C c ,
де rc- послідовний опір колектора, Cc - ємність колектора.
В епітаксійному транзисторі rc може бути суттєво зменшеним і час затримки ’c
знехтувано малий в порівнянні з іншими часами затримки.
Таким чином, вираз для частоти відсічки fT має вид
fT
1
ec
{[
kT (Ce Cc C p )
qI C
W 2 xC W 1
]} .
DB
2v s
Видно, що для підвищення частоти відсічки необхідно зменшити товщину бази
транзистора, товщину колектора і працювати при високих густинах струму.
Однак при зменшенні товщини колектора відбувається відповідне зменшення
пробивної напруги. Отже необхідно шукати компроміс між високочастотними
властивостями транзистора і його здатністю витримувати високі напруги.
25. Частота відсічки
Зі збільшенням робочого струмучастота
відсічки
підвищується,
оскільки час зарядки емітера E
обернено
пропорційний
струму.
Разом з тим, коли струм стає досить
великим і густина інжектованих
неосновних носіїв зрівнюється або
перевищує концентрацію домішки в
базі, ефективна товщина бази зростає
від WB до (WB+WC).
При низьких густинах струмів ec
падає з ростом JC, і колекторний
струм переноситься в основному за
рахунок дрейфу, тобто
J C q C N C C ,
де C, NC, EC - рухливість, концентрація
домішки і електричне поле в
колекторному
епітаксійному
шарі
відповідно.
Час руху носіїв від емітера до колектора в
залежності від густини колекторного струму.
При подальшому наростанні струму час
затримки приймає мінімальне значення, а
потім починає зростати, особливо швидко
при струмі J1. Цьому струму відповідає
максимальне однорідне електричне поле
C (VC 0 VCB ) / WC
26.
де VC0 -контактний потенціал колектора, VCB - напруга прикладена між базою іколектором. Струми, що перевищують , не можуть вже переноситись через епітаксійну
область колектора тільки за рахунок дрейфової компоненти. Величина J1 рівна
J1 q C N C (VC 0 VCB ) / WC .
В результаті ефекту Кірка цей струм є оптимальним з точки зору максимальної частоти
відсічки. Слід відмітити, що зі збільшенням VCB одночасно зростає і величина J1.
Вихідна потужність обернено пропорційна квадрату
частоти, що є результатом обмежень, які
накладаються полем лавинного пробою і граничною
швидкістю носіїв.
Залежність потужності від частоти для
біполярних НВЧ-транзисторів.




















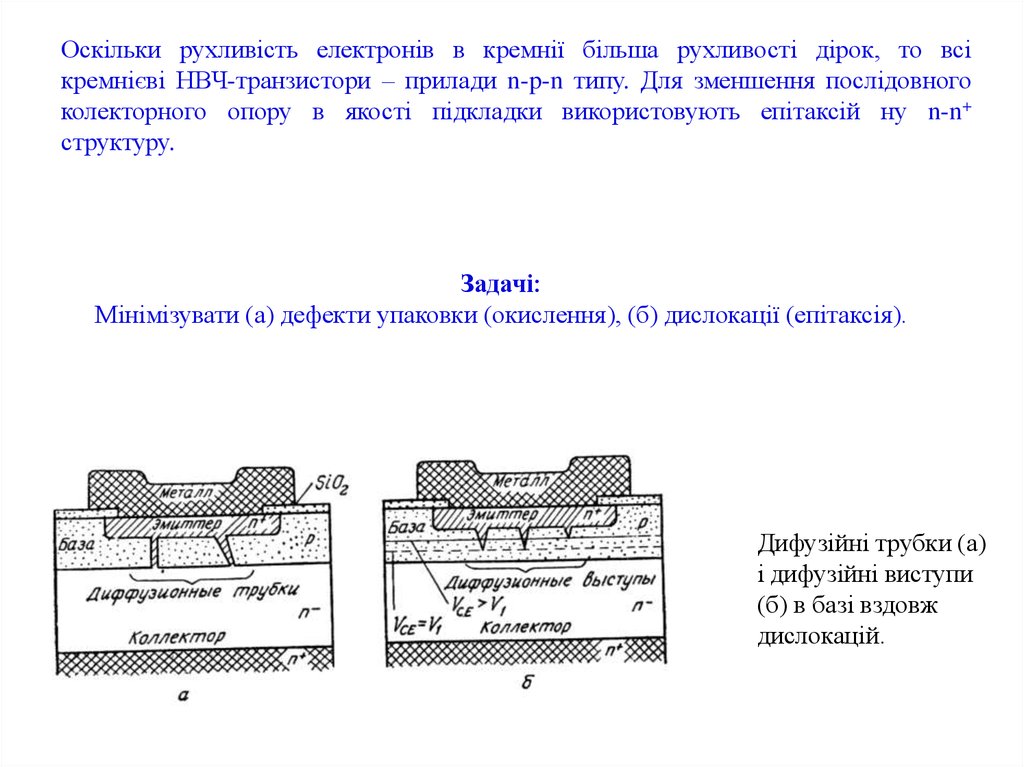






 Электроника
Электроника








