Похожие презентации:
Контакт метал - напівпровідник
1. ОСНОВИ МІКРО- і НАНОЕЛЕКТРОНІКИ Лекція 03 Контакт метал - напівпровідник
Анатолій ЄвтухІнститут високих технологій
Київського національного університету імені Тараса Шевченка
2. Ідеальна модель і поверхневі стани
q m - q ( + Vn).Контактна різниця
потенціалів.
q Bn = q ( m - ).
n – тип;
q Bp = Eg – q ( m - ).
p – тип;
q ( Bn + Bp) = Eg.
Зонні енергетичні діаграми контактів металнапівпровідник
3. Збіднений шар
Зонні енергетичнідіаграми контактів
метала з
напівпровідниками n- і
p- типів при різних
зміщеннях.
а – при термодинамічній
рівновазі; б- при прямому
зміщенні; в- при оберненому
зміщенні.
4.
Рівняння Пуасона: 2 =- / 0 sРізкий несиметричний p-n перехід;
Наближення різкої границі збідненого шару:
( qND при x<W і 0, dV/dx 0 при x>W )
W- ширина збідненого шару.
2 s
kT
W
(Vbi V ) ,
qN D
q
V ( x)
qN D
s
( x)
qN D
1 2
(Wx x ) Bn ,
2
m ( x 0)
kT
Qsc qN DW 2q s N D (Vbi V ) .
q
2qN D
s
s
(W x) m
(Vbi V
kT
)
q
qN D
s
2(Vbi V
W
x,
kT
)
q
.
5.
Питома ємність збідненого шаруC
1
C2
2(Vbi V
q s N D
kT
)
q
,
Qsc
V
q s N D
2(Vbi V
kT
)
q
s
W
2
ND
q s
.
1
2
d
(
1
/
C
)
/
dV
.
Якщо концентрація ND постійна у всій області
збідненого шару, то на графіку 1/C2 від V
отримаємо пряму лінію.
Якщо концентрація ND не постійна, то, вимірюючи
диференційну ємність можна визначити профіль
легування.
6. Ефект Шотткі
q2q2
F
,
2
2
4 0 (2 x)
16 0 x
x
q2
E ( x) Fdx
.
16 0 x
q2
PE ( x)
q x.
16 0 x
d [ PE ( x)] / dx 0
Енергетична діаграма системи металвакуум.
Ефективна робота виходу при прикладанні
зовнішнього електричного поля зменшується. Це
зменшення є наслідком суперпозиції зовнішнього
електричного поля і сили зображення.
xm
q
16 0
,
q
2 xm .
4 0
7.
Зниження енергетичногобар’єра як функція
електричного поля в діодах
Au – Si.
q
.
4 s
Енергетичні діаграми бар’єра
Шотткі між металом і
напівпровідником n– типу
при різних напругах
зміщення.
8. Теорія процесів переносу заряда
1.Надбар’єрний переніс.2. Квантовомеханічне
тунелювання електронів
через бар’єр.
3. Рекомбінація в області
просторового заряду.
Чотири основні процеси
переносу при прямому
зміщенні.
4. Інжекція дірок із металу в
напівпровідник.
9. 1. Теорія термоелектронної емісії.
Припущення:1. Висота бар’єру q Bn набагато більша kT
2. Область, що визначає термоелектронну емісію, знаходиться в термодинамічній
рівновазі.
3. Протікання повного струму не порушує цієї рівноваги.
J s m
qv dn.
dn N ( E ) F ( E )dE ,
x
EF q
v 2 v x2 v y2 v z2
B
q(Vn Vbi )
4 qm * k 2 2
qV
J s m (
)
T
exp[
]
exp(
)
3
kT
kT
h
q
qV
A*T 2 exp( B ) exp(
).
kT
kT
J n [ A*T 2 exp(
J ST A*T 2 exp(
J m s
q B
A T exp(
)
kT
*
2
q Bn
qV
qV
)][exp(
) 1] J ST [exp(
) 1],
kT
kT
kT
q Bn
).
kT
Струм не залежить від форми бар’єра, а лише від його
висоти.
10. 2. Дифузійна теорія
Припущення:1. Висота бар’єру q Bn набагато більша kT шарі грає суттєву роль.
3. Концентрація носіїв при x=0 і x=W не залежить від
2. Розсіяння електронів при їх русі в збідненому струму.
4. Концентрація домішок в напівпровіднику досить мала, і виродження відсутнє.
Необхідно враховувати дві компоненти струму (дифузійну та польову):
J x J n q[n( x) Dn
n
qn( x) V ( x) n
] qD
[
].
Співвідношення
Ейнштейна:
n Граничні умови:
x
kT
x
x
Співвідношення Ейнштейна:
D
q
kT
Граничні умови:
qV (0) q (Vn Vbi ) q Bn ,
qV (W ) qVn qV ,
EC (0) E F
q
N C exp( Bn ),
kT
kT
qV n
n(W ) n N C exp(
).
kT
n(0) N C exp[
11.
Розподіл потенціалу в бар’єрі Шотткі:qV ( x)
q2ND
s
x2
(Wx ) q Bn .
2
q 2 Dn N D q(Vbi V )2 N D 1 / 2
q Bn
qV
qV
Jn {
[
] exp(
)}[exp( ) 1] J SD [exp( ) 1].
kT
s
kT
kT
kT
JSD сильніше залежить від напруги і менш чутлива до температури, ніж JST.
12. 3. Термоемісійна- дифузійна теорія.
В якості граничної умовивикористовується швидкість
термоелектронної рекомбінації vR на
границі розділу метал-напівпровідник.
J q n
d n
.
dx
n- густина електронів в точці х
q( n )
n N C exp(
kT
J q(nm n0 )v R
Між xm і x=0
.
Енергетична діаграма контакту
з урахуванням ефекту
Шотткі. q (x)– потенціальна
енергія електрона, q (x) положення квазірівня Фермі.
J
де
qN C v R
q
qV
exp( Bn )[exp(
) 1],
1 vR / vD
kT
kT
W
q
q
exp[
( Bn )]dx] 1
kT
kT
xm
vD [
-ефективна швидкість дифузії.
13.
Якщо vD>>vR, то передекспоненційному члені залишається лише vR і справедливатеорія термоелектронної емісії.
Якщо vD<<vR, то переважає процес дифузії.
Остаточний вираз для вольт-амперної характеристики:
де
f p exp(
qV
) 1],
kT
q Bn
** 2
J S A T exp(
),
kT
*
f
f
A
p Q
A**
.
1 f p f Q vR / vD
J J S [exp(
xm
) ймовірність проходження електроном бар’єра з урахуванням
розсіювання на оптичних фононах.
fQ- відношення повного струму до струму при нехтуванні квантовомеханічним
тунелюванням і відбиванням.
14. Ефективна постійна Річардсона
Розрахункові значенняефективної постійної
Річардсона як функціії
електричного поля в бар’єрі
метал-кремній.
15. 4. Тунельний струм
Дві компоненти струму: термоелектронна і тунельна.J s m
q(Vb V n )
A*T
A*T
T ( ) exp[
]d
k 0
kT
k
J m s
q (Vb )
F (V )T ( )(1 F
s
При V>>kT/q
n
)d ,
0
q Bn
A*T
A*T
exp(
) T ( ) exp( )d
k
kT 0
kT
k
J J S [exp( qV / nkT ) 1].
m
q (Vb )
F T ( )(1 F )d .
m
s
0
q V
. n- фактор неідеальності.
kT (ln J )
J J S exp( qV / kT ).
Тунельна компонента густини струму домінує при високому рівні легування і
низьких температурах.
J t exp(
q Bn
),
E00
T ( ) exp(
q Bn
),
E00
E00
Тунельний струм експоненційно залежить від
q N D
.
*
2 sm
ND
16.
Теоретичні іекспериментальні вольтамперні характеристики
діодів Au-Si.
Теоретичні і експериментальні вольт-амперні характеристики діодів Au-Si.
Залежності густини струму
насичення (а) и фактору неідеальності
n (б) від концентрації
легуючої
домішки в діоді Au-Si при різних
температурах.
Відношення тунельного струму до струму
термоелектронної емісії в діодах Au-Si.
17. 5. Інжекція неосновних носіїв.
Рівняння неперервності:p n p n 0 1 J p
0
.
p
q x
Рівняння густини струму для неосновних
носіїв:
J p q p pn qD p
Енергетична діаграма
епітаксійного бар’єру Шотткі.
pn
.
x
При низькому рівні інжекції можна
знехтувати дрейфовим членом в
порівнянні з дифузійним.
Отримуємо:
Jp
Jp
.
J p Jn Jn
При збільшенні електричного поля домінуючою стає дрейфова компонента.
J
q p p n .
Js
- росте пропорційно густині струму.
18. Висота бар’єра
q m- робота виходу метала; q Bn- висотаенергетичного барєру; q B0асимптотичне значення при
нульовому електричному полі; 0енергетичний рівень на поверхні;
- зниження барєра за рахунок сил
зображення; - падіння потенціалу на
проміжному шарі; - електронна
спорідненість напівпровідника; Vbiвбудований потенціал;
s- діелектрична проникність
напівпровідника; i- діелектрична
Детальна енергетична діаграма контакту
проникність проміжного шару; метал-напівпровідник – типу при
товщина проміжного шару; Qscнаявності проміжного шару
густина обємного заряду в
товщиною порядку міжатомних
напівпровіднику,
відстаней.
Qss- густина заряду на поверхневих станах
напівпровідника; Qm- густина
поверхневого заряду в металі.
19. Висота бар’єра
Два припущення:1.Товщина проміжного шару між металом і напівпровідником або дорівнює нулю, або
порядку міжатомних розмірів і тому він є тунельно прозорим для електронів , а
його вплив зводиться лише до падіння потенціалу на ньому.
2. Енергетична густина поверхневих станів не залежить від типу металу і визначається
лише властивостями поверхні напівпровідника.
Густина заряду на поверхневих станах:
Qss qDs ( E g q 0 q Bn q ).
Поверхнева густина заряду збідненого шару напівпровідника:
Qsc 2q s N D ( Bn Vn
QM (Qss Qsc )
kT
).
q
Закон Гауса:
Edx
1
0
m ( Bn ).
Qm
i
,
Виключим і отримуєм:
2q s N D 2
kT qDs
( m ) ( Bn )
(
V
)
( E g q 0 q Bn q ).
Bn
n
2
q
i
i
20.
Вирішуємо відносно Bn і отримуємо:c 22 c1
Bn [c 2 ( m ) (1 c 2 )(
0 ) ] {
c 23 / 2 [c1 ( m )
q
2
Eg
c1 c1
c 2 c12 1 / 2
kT
(1 c 2 )(
0 ) (Vn
)
] }.
q
c2 c2
q
4
Eg
де
c1
2q sN D 2
2
i
.
c2
i
i q Ds
2
.
При s 10 0, i= 0 і ND<1018 см-3 величина c1 мала тому вираз для висоти бар’єру
спрощується до виду
Bn c2 ( m ) (1 c2 )(
Eg
q
0 ) c2 m c3 .
Якщо c1 і c3 можна визначити експериментально, а значення відомо, то
0
Eg
q
c2 c3
.
1 c2
І із виразу для c2:
Ds
(1 c2 ) i
.
2
c2 q
21.
Два граничні випадки:1. Якщо Ds , то c2 0 і
q Bn ( E g q 0 ) q .
В цьому випадку рівень Фермі на поверхні фіксується поверхневими станами на
енергії, що перевищує край валентної зони на величину q 0 . При цьому висота
бар’єра не залежить від роботи виходу металу і повністю визначається ступенем
легування і поверхневими властивостями напівпровідника.
2. Якщо Ds 0 , то c2 1 і
q Bn q( m ) q .
Висота енергетичного бар’єра ідеального діода Шотткі (при відсутності
поверхневих станів).
22. Виміри висоти бар’єру. 1. Метод вольт-амперної характеристики
При прямому зміщенні з V>3kT/qJ n A**T 2 exp(
Bn
Залежність густини струму в
діодах W-Si і W-GaAs від
прикладеної в прямому
зміщенні напруги.
q Bn
q(V )
) exp(
),
kT
kT
kT
A**T 2
ln(
)
q
JS
Теоретичне значення A**=120 A cм-2 К-2
23. 2. Метод енергії активації.
ln( I F / T 2 ) ln( Ae A** ) q( Bn VF ) / kT.Ае- площа електрично активної області.
При постійній напрузі прямого зміщення з
тангенса кута нахилу залежності ln(IF/T2) від
1/T знайдемо висоту бар’єра Bn.
Залежність струму від температури
в координатах, що
використовуються для
визначення висоти бар’єру.
24. 3. Метод вольт-фарадної характеристики
Залежністьвід прикладеної
напруги для діодів W-Si і WGaAs.
1/C2
Напівпровідник з одним мілким і
одним глибоким донорними
рівнями. ND і NT– концентрації
мілких і глибоких донорів,
відповідно.
25.
CQsc
V
q s N D
2(Vbi V
kT
2(Vbi V )
1
q
,
2
q s N D
C
kT
)
q
s
W
.
2
ND
q s
1
2
d
(
1
/
C
)
/
dV
.
Якщо концентрація ND постійна у всій області
збідненого шару, то на графіку 1/C2 від V
отримаємо пряму лінію.
Якщо концентрація ND не постійна, то, вимірюючи
диференційну ємність можна визначити профіль
легування.
Висота бар’єра визначається із залежності 1/С2 від V.
Bn
kT
Vi Vn
,
q
де Vi - точка перетину з віссю напруг, а qVn - різниця енергій між рівнем Фермі і
дном зони провідності напівпровіднику, яку можна вирахувати, якщо відома
концентрація легуючої домішки. Останню можна знайти з тангенса кута нахилу
залежності 1/С2 від V.
26. 4. Фотоелектричний метод.
Принципова схема установки дляфотоелектричних вимірювань
(а) і енергетична діаграма
процесів фотозбудження (б).
Залежність кореню квадратного
від фотовідгуку,
перерахованого на один фотон,
від енергії фотона для діодів WSi і W-GaAs.
27.
Теорія Фаулера.Залежність квантового виходу R від енергії фотона h виражається формулою:
R
T2
x2 2
e 2 x e 3 x
x
[
(e
...
6
4
9
E s h 2
де h 0=q Bn - висота бар’єру, Es - сума h 0 і енергії Фермі, відрахована від дна зони
провідності металу, x=h( - 0)/kT.
При умові Es>> h і x>3 отримуємо спрощений вираз
R (h h 0 ) 2
при
h( 0 ) 3kT,
або
R h( 0 ).
28. Омічний контакт.
Теоретичні і експериментальнізалежності питомого опору
контактів від 1/ ND .
Омічні контакти з малою висотою
бар’єру (а) і високим ступенем
легування (б).
29.
Найбільш важливою характеристикою контакту є питомий опір при нульовому зміщенніJ 1
Rc ( ) V 0
V
1. В контакті метал-напівпровідник з низьким рівнем легування домінує
термоелектронна компонента струму
q
k
Rc * exp( Bn ).
kT
qA T
В цьому випадку
qV
) 1],
kT
q
J S A**T 2 exp( Bn ),
kT
f p f Q A*
**
A
.
1 f p f Q vR / vD
J J S [exp(
2. В контакті метал-напівпровідник з більш високим рівнем легування домінує
тунельна компонента струму
q
q N D
T ( ) exp( Bn ),
E
.
00
*
E00
2 sm
При цьому
2 s m* Bn
q Bn
Rc exp(
) exp[
(
).
E00
ND
Звідси видно, що в тунельній області
питомий опір контакту експоненційно
залежить від Bn
ND























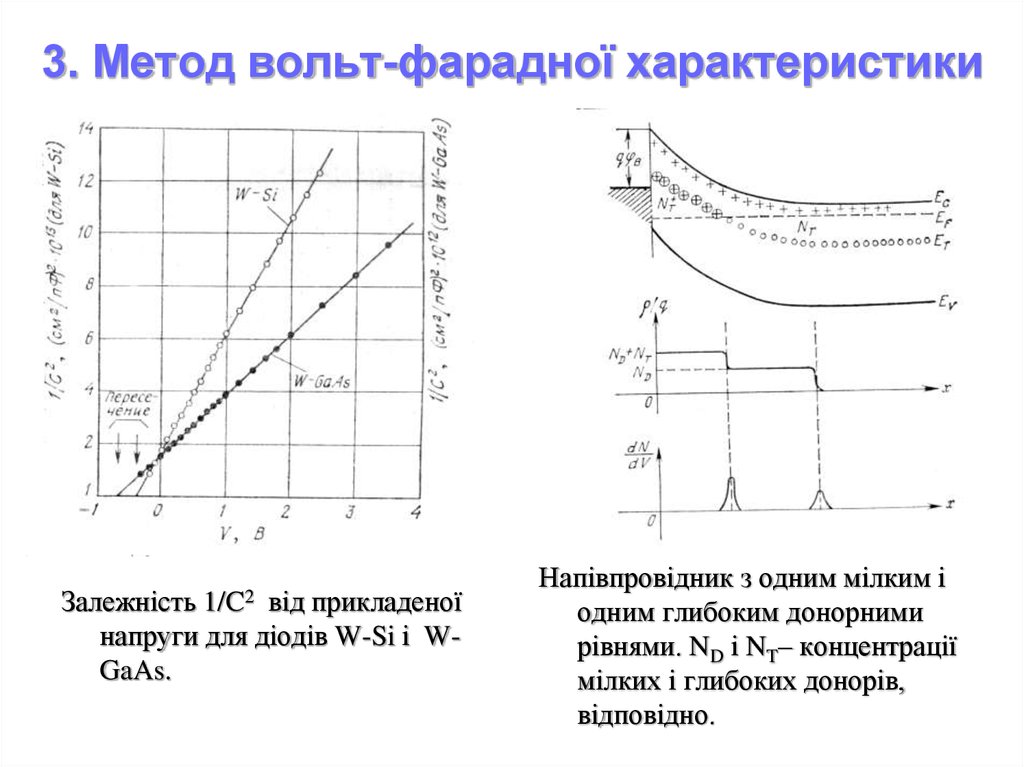



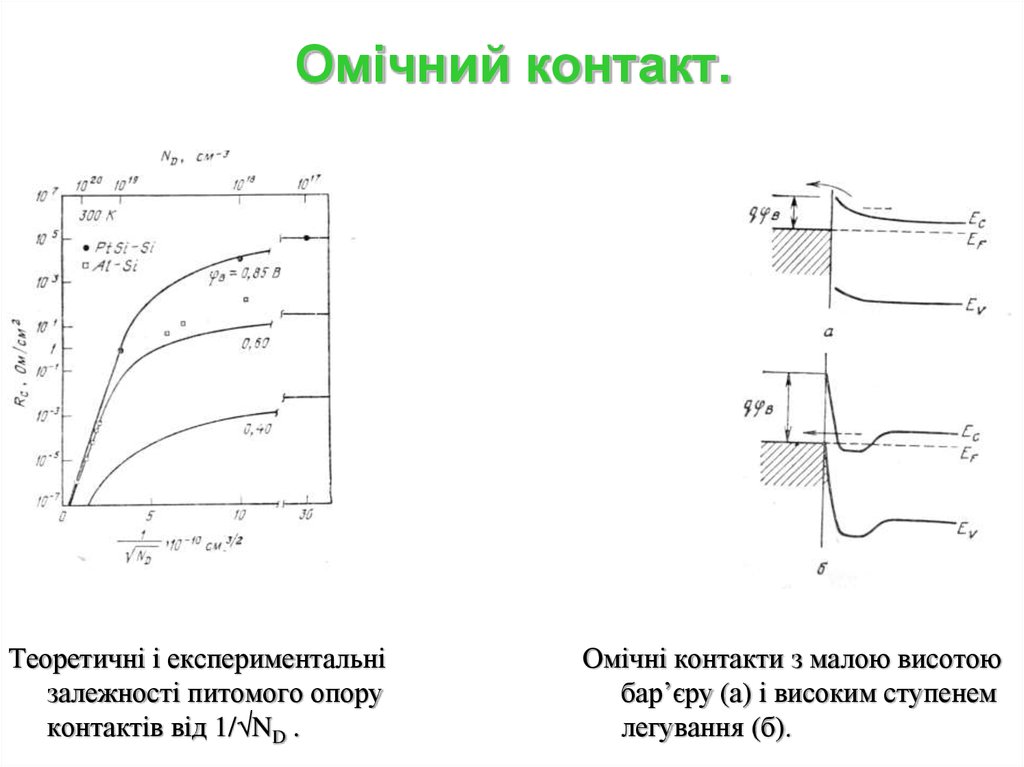


 Электроника
Электроника








