Похожие презентации:
Гетероперехід. Емісійна модель різкого p-n гетеропереходу
1. ОСНОВИ МІКРО- і НАНОЕЛЕКТРОНІКИ Лекція 05 Гетеропереходи
Анатолій ЄвтухІнститут високих технологій
Київського національного університету імені Тараса Шевченка
2. Гетероперехід
Гетероперехід – перехід утворений між двома різними напівпровідниками.Якщо напівпровідники мають однаковий тип провідності – ізотипний гетероперехід.
Якщо напівпровідники мають різний тип провідності – анізотипний гетероперехід.
Ідеальний різкий гетероперехід без пасток на границі розділу (Андерсон).
Зонні діаграми двох ізольованих напівпровідників при умові електронейтральності (а)
і ідеального анізотипного p-n - гетероперходу при тепловій рівновазі (б).
3.
Рівноважні діаграмиенергетичних зон до
(а) і після (б)
утворення різкого pn гетеропереходу.
4.
Ширина збідненого шару в кожному напівпровіднику і бар’єрна ємністьзнаходиться з рішення рівняння Пуасона для різкого переходу з кожної
сторони границі розділу.
Одна з граничних умов – неперервність електричної індукції на границі
розділу
1 1 2 2
Повний контактний потенціал
Vbi Vb1 Vb 2 .
2 N A2 1 2 (Vbi V ) 1 / 2
x1 [
] .
qN D1 ( 1 N D1 2 N A2 )
C [
x2 [
2 N D1 1 2 (Vbi V ) 1 / 2
] .
qN A2 ( 1 N D1 2 N A2 )
qN D1 N A2 1 2
]1 / 2 .
2( 1 N D1 2 N A2 )(Vbi V )
Відношення напруг на кожному напівпровіднику
Vb1 V1 N A2 2
.
Vb 2 V2 N D1 1
V V1 V2 .
5. ВАХ гетеропереходів Дифузійна модель Андерсона
Струм термоелектронної емісії.J A*T 2 exp(
qV2
qV2
qV
)[exp(
) exp( 1 )].
kT
kT
kT
J J 0 (1
V
qV
)[exp(
) 1].
Vbi
kT
qA*TVbi
qV
J0
exp( bi ).
k
kT
Обернений струм не має насичення, а при
великих значеннях V лінійно зростає з
напругою.
В прямому напрямі залежність J від qV/kT можна
апроксимувати експоненційною функцією
qV
J exp(
).
nkT
Зонні діаграми ідеального ізотопного n-n гетеропереходу (а), а також ідеальних p-n (б) і p-p
– гетеропереходів (в).
6.
Діаграма енергетичних зон різкого p-n гетеропереходу при прямомузміщенні (пунктирні лінії); неперервні лінії відповідають нульовому
зміщенню.
7. Емісійна модель різкого p-n гетеропереходу
Переніс заряду здійснюється в основному електронами, прирозрахунку ВАХ враховуються накоплення неосновних носіїв заряду
на краях збідненої області і вплив потенціального барєру (у виді
“пічка” на n- стороні гетеропереходу ) на проходження струму.
I I
qV
I s d [exp( ) 1].
Is Id
kT
I s qSN d1
Dn1
n1
.
Якщо Is<<Id, то повний струм дорівнює величині струму в моделі Шоклі для
гомопереходу.
qV
I I s [exp(
) 1].
kT
Якщо Is>>Id, то повний струм співпадає зі струмом розрахованим в діод ній
емісійній моделі Шоткі.
I I d [exp(
qV
) 1]
kT
8. Емісійно-рекомбінаційна модель p-n гетеропереходу
Допускається, що на границі розділу знаходиться тонкий шардефектної кристалічної гратки з великою швидкістю рекомбінації, а
носії заряду досягають границі розділу за допомогою термічної емісії
через відповідні бар’єри.
I I 0 [exp(
qV
) 1].
kT
I 0 B exp(
qVK
).
kT
1 2.
Схема емісійнорекомбінаційної моделі p-n
гетеропереходу.
9. Тунельна модель різкого p-n гетеропереходу
Потенціальний барєр у виді пічка в широкозонномунапівпровіднику n типу електрони можуть подолати або
термічною емісією через бар’єр, або тунелюванням крізь нього.
x2
T exp{ 2
2mn* [Wb ( x) qaV ]
x1
dx}.
Якщо тунелювання через барєр є
домінуючим механізмом
протікання струму, то загальний
вираз ВАХ при прямому зміщенні
має вид
I I s (T ) exp(
V
).
V0
10. Тунельно-рекомбінаційна модель різкого p-n гетеропереходу
Допускається, що відбуваєтьсятунелювання електронів із зони
провідності широкозонного
напівпровідника на незайняті
локальні центри в забороненій
зоні вузькозонного матеріалу pтипу з наступною
рекомбінацією з діркою.
Можливі і ступінчаті тунельнорекомбінаційні процеси.
Діаграма енергетичних зон різкого p-n
гетеропереходу при прямому (а) і оберненому
(б) зміщенні, яка ілюструє тунелювання
електронів.
11. Різкі ізотипні гетеропереходи
В ізотипних гетеропереходахтипу n-n і p-p вклад неосновних
носіїв заряду в електричний
струм знехтувано малий.
Ізотипні гетеропереходи
відносяться до пристроїв з
основними носіями заряду.
Рівноважна діаграма енергетичних зон різкого
n-n гетеропереходу.
12.
«Пічок» і «провал» обумовлені вибраними параметрами напівпровідників,які контактують: 1> 2 і Eg1<Eg2 ( Wg1< Wg2).
На відміну від анізотропних гетеропереходів, збіднений шар утворюється лише з
боку широкозонного напівпровідника, а з боку вузькозонного напівпровідника
збагачений шар, товщина якого менша шару збіднення. В зв’язку з цим прикладена
напруга падає в основному на широкозонному напівпровіднику
Vk 2
1 N d1 kT
qV
{ [exp( k1 ) 1] Vk1}.
2 Nd2 q
kT
Ємність перехідної області
C n n
qSN d 2 2
.
2Vk
Vk 2 Vk1
Для різких n-n переходів Андерсон отримав наступний вид ВАХ:
qVk 2
qVk1
I B exp(
)[exp(
) 1].
kT
kT
B qSN d 2
kT
.
2 mn*
- коефіцієнт пропускання електронів через поверхню розділу; mn*-ефективна маса
електронів в широкозонному напівпровіднику.
Ізотипний гетероперехід вважається зміщеним в прямому напрямку, якщо прикладена
напруга зменшує контактну різницю потенціалів.
13. Прилади на гетеропереходах
Зонні діаграми для надградок з шарамиGaAs і Al0.3Ga0.7As, що чергуються і для
почергово легованої надградки.
Варізонна структура. а- зміна складу вздовж структури;
б- рівноважна зонна діаграма; в- зонна діаграма при
прямому зміщенні.
Температурна залежність рухливості в
GaAs і в почергово легованій надградці.








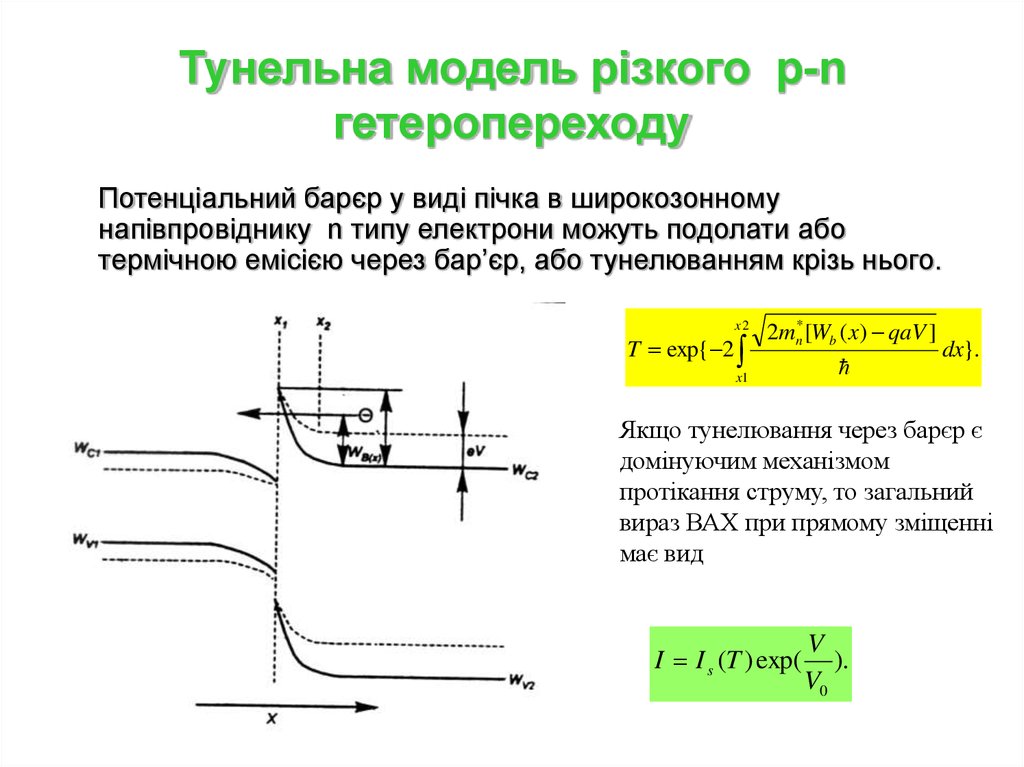





 Электроника
Электроника








